

论文分享
【国际论文】宽带隙半导体中的高级缺陷光谱学:回顾与最新成果
日期:2024-11-15阅读:926
近期,由意大利帕多瓦大学的研究团队在学术期刊Journal of Physics D: Applied Physics发布了一篇名为Advanced defect spectroscopy in wide-bandgap semiconductors: review and recent results(宽带隙半导体中的高级缺陷光谱学:回顾与最新成果)的综述文章。
摘要
半导体中深能级缺陷的研究在电子和光电子器件的发展中始终扮演着战略性角色。深能级对许多器件特性,包括效率、稳定性和可靠性,有着显著影响,因为它们可能驱动多种物理过程。尽管晶体生长技术取得了进展,宽带隙和超宽带隙半导体(如氮化镓和氧化镓)仍然受制于缺陷的形成,这些缺陷通常可充当载流子陷阱或生成-复合中心(G-R中心)。用于硅材料深能级分析的传统技术需要适应,用于识别和表征宽带隙材料中的缺陷。本文综述了半导体中深能级理论的相关研究,同时回顾并展示了两种广泛应用的常见深能级检测技术的应用、局限性及前景,特别关注于宽带隙半导体。这两种技术分别是电容深能级瞬态谱(DLTS)和深能级光谱学(DLOS)。最后,本文还回顾了氮化镓(GaN)和β-氧化镓(β-Ga2O3)中最常见的陷阱。
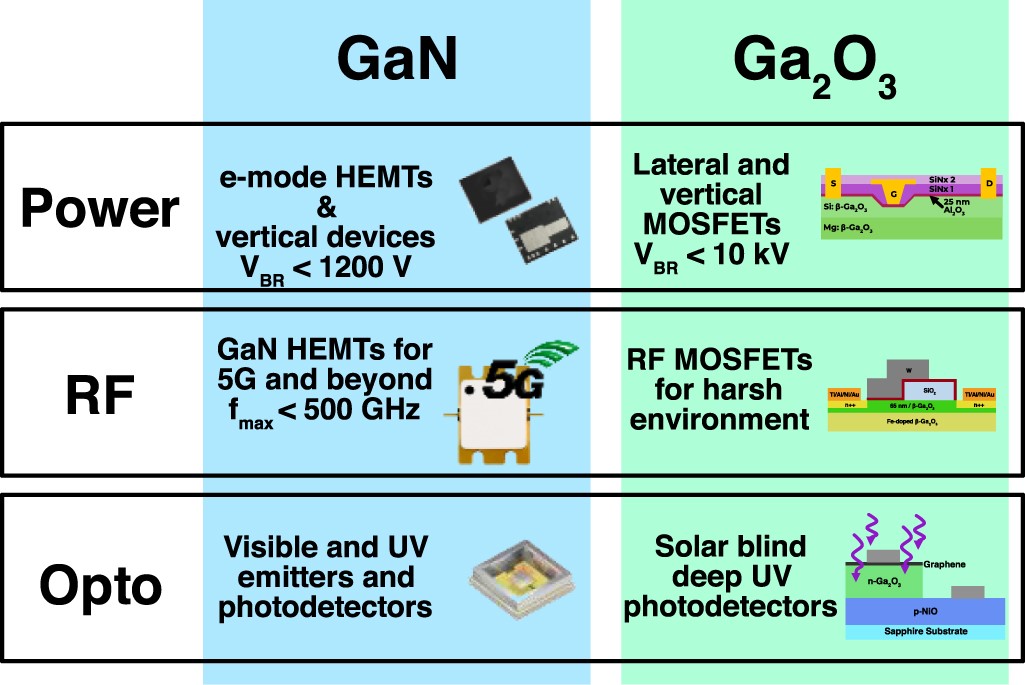
图 1. 宽带隙半导体 GaN 和 β-Ga2O3 的功率、射频和光电应用前景。

图 2. 载流子与陷阱态之间动态相互作用的 SRH 模型。该模型允许的四个过程由捕获和发射系数 cn, cp, en, ep 描述。
DOI:
doi.org/10.1088/1361-6463/ad5b6c