

【国际论文】通过后端溅射沉积AlN层对β-(AlₓGa₁₋ₓ)₂O₃/Ga₂O₃异质结场效应晶体管进行电热增强
日期:2025-02-13阅读:753
由美国海军研究实验室的研究团队在学术期刊 Journal of Applied Physics 发布了一篇名为 Electrothermal enhancement of β-(AlxGa1−x)2O3/Ga2O3 heterostructure field-effect transistors via back-end-of-line sputter-deposited AlN layer(通过后端溅射沉积 AlN 层对 β-(AlxGa1−x)2O3/Ga2O3 异质结场效应晶体管进行电热增强)的文章。
摘要
通过在后端通过室温反应溅射沉积 400 nm 厚的 AlN 覆盖层,增强了 β-(Al0.21Ga0.79)2O3/Ga2O3 异质结场效应晶体管 (HFET) 的电热器件性能。AlN 覆盖的 HFET 表现出 > 5 W/mm 的直流功率密度, 高于之前报道的基于原生衬底的横向 β-Ga2O3 晶体管。未覆盖 HFET 的击穿电压 (VB) 为 569 ± 250 V,最大 VB 为 947 V。对于 AlN 覆盖的 HFET,VB 增加到 1210 ± 351 V,最大 VB 为 1868 V。AlN 覆盖的 HFET 表现出 27% 的器件级热阻 (RTH) 降低,这是从栅极电极测量的。电气和热模拟的结合有助于阐明电热耦合对 AlN 覆盖 HFET 测量到的温度上升降低的贡献。尽管测量的 AlN 薄膜热导率 (13.3 ± 1.3 W/mK) 与块状 β-Ga2O3 相当,但由于仅热扩散,覆盖层仍使模拟的峰值通道温度上升降低了约 4%。电气模拟表明,电场扩散是另一种机制,通过通道中热生成的离域和重新分布,有助于模拟的峰值通道温度上升降低 18%。热建模用于评估通过优化溅射沉积工艺以实现更厚和更高热导率的 AlN 可以实现的热性能进一步改进。
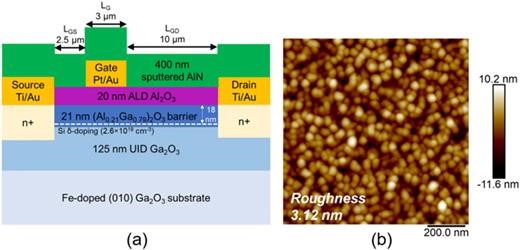
图 1. (a) 带有 400 nm 溅射 AlN 覆盖层的 β-(Al0.21Ga0.79)2O3/Ga2O3 HFET 器件横截面示意图。(b) 高频晶体管栅漏沟道区 400 nm AlN 盖层的原子力显微镜图像。测量到的均方根(rms)粗糙度为 3.12 nm。
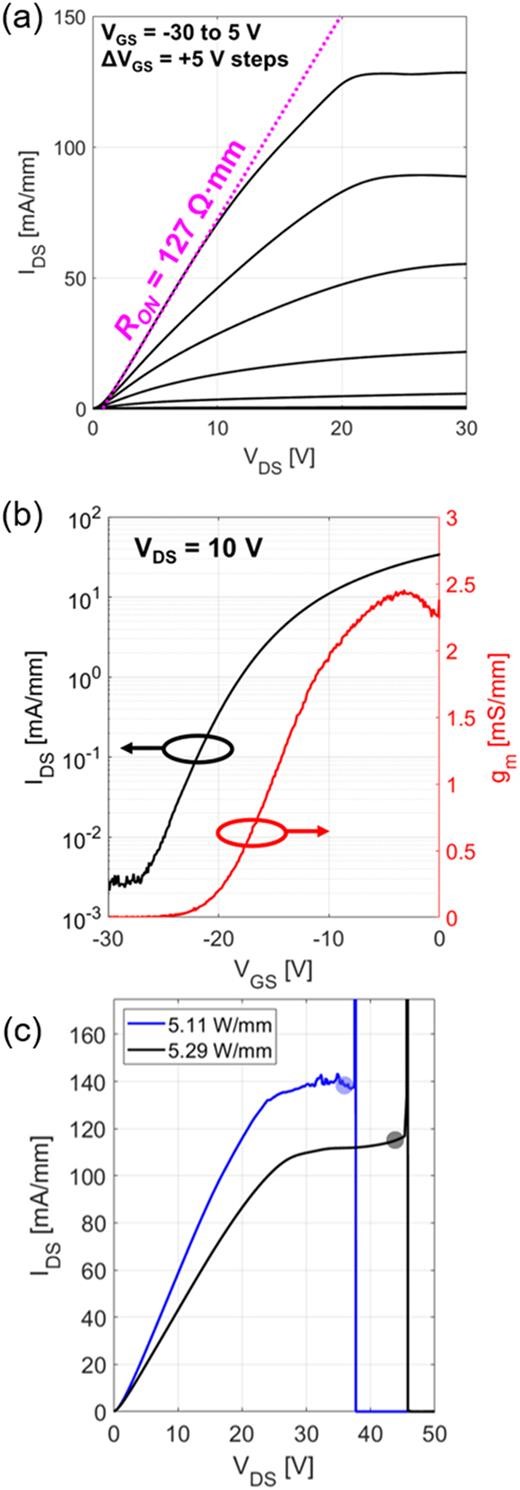
图 2. (a) 氮化铝封端 β-(Al0.21Ga0.79)2O3/Ga2O3 高频晶体管(LG = 3 μm, WG = 75 μm, LGD = LGS = 2.5 μm)的直流输出和 (b) 直流传输特性。(c) 在 VGS = 0 V 时为氮化铝封盖 HFET 测量的 IDS–VDS,显示达到的最大功率密度(见图例)。圆圈表示提取功率密度的基准点。
DOI:
doi.org/10.1063/5.0225896