

【外延论文】通过 AlN 缓冲层提高硅衬底上 MOCVD 生长的 β-Ga₂O₃ MOSFET 性能
日期:2025-02-27阅读:772
由台湾暨南国际大学的研究团队在学术期刊 ACS Applied Electronic Materials 发布了一篇名为 Performance Enhancement of MOCVD Grown β-Ga2O3 MOSFETs on Silicon Substrates via AlN Buffer Layer(通过 AlN 缓冲层提高硅衬底上 MOCVD 生长的 β-Ga2O3 MOSFET 性能)的文章。
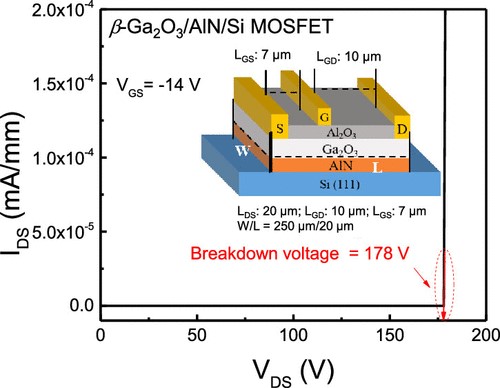
摘要
基于 β-Ga2O3 的 MOSFET 由于其宽禁带和高击穿电压,在高功率器件应用中具有巨大的潜力。然而,由于晶格和热膨胀失配,β-Ga2O3 在硅衬底上的直接集成面临挑战,这会降低器件性能。本工作探索了使用氮化铝 (AlN) 缓冲层来缓解这些问题,从而提供改进的结构质量和增强的电学性能。我们展示了使用金属有机化学气相沉积法生长 β-Ga2O3/AlN/Si 薄膜,其中引入 AlN 缓冲层显着促进了 (-201) β-Ga2O3 取向的形成,这在 β-Ga2O3/Si 薄膜中是缺失的,这已通过 XRD 分析得到证实。使用 SEM 显微照片和 XPS 深度剖析证明了 AlN 缓冲层的存在。β-Ga2O3/AlN/Si MOSFET 表现出 52 mA/mm 的最大漏极电流 IDS)、约 108 的出色漏极电流开关比和 178 V 的击穿电压 (Vbr),超过了 β-Ga2O3/Si MOSFET 的性能,后者表现出 45 mA/mm 的 IDS 和 106 V 的 Vbr。这些结果强调了 AlN 缓冲层在提高硅基 β-Ga2O3 晶体管的性能和可靠性方面的潜力,为下一代电力电子器件铺平了道路。
原文链接:
https://doi.org/10.1021/acsaelm.4c02006


