

【国际论文】在半绝缘(-201)β-Ga₂O₃ 衬底上实现的全注入横向 β-Ga₂O₃ MOSFET 器件
日期:2025-03-17阅读:715
由德国费迪南德-布劳恩研究所的研究团队合作在学术期刊 Applied Physics Letters 发布了一篇名为 All-implanted lateral β-Ga2O3 MOSFET devices realized on semi-insulating (-201) β-Ga2O3 substrates(在半绝缘(-201)β-Ga2O3 衬底上实现的全注入横向 β-Ga2O3 MOSFET 器件)的文章。
摘要
本研究成功制备了全离子注入 β-Ga2O3 金属氧化物半导体场效应晶体管(MOSFET)器件,基于半绝缘 (-201) β-Ga2O3 衬底。通过采用多能量 Si+ 离子注入及后续退火工艺,实现了高达 87% 的激活效率,从而在无金属有机化学气相沉积(MOCVD)外延生长的情况下,获得具有与外延层相当的电学性能的有源晶体管沟道和欧姆接触区域。所制备的 β-Ga2O3 MOSFET 展示出优异的电流调控能力,具有高达 109 的开关电流比,最大漏极电流密度达 180 mA/mm,以及 1.5 mΩ·cm2 的特定导通电阻。此外,在空气环境下进行的击穿电压测试表明,未采用场板设计、栅-漏间距为 2 μm 的 MOSFET 器件,其灾难性击穿电压达 332 V,对应的平均击穿场强约为 1.7 MV/cm。本研究结果强调了全离子注入技术在制备高性能 Ga2O3 电子器件方面的巨大潜力,该方法无需高质量外延生长,即可实现适用于下一代功率电子应用的 β-Ga2O3 MOSFET 器件。
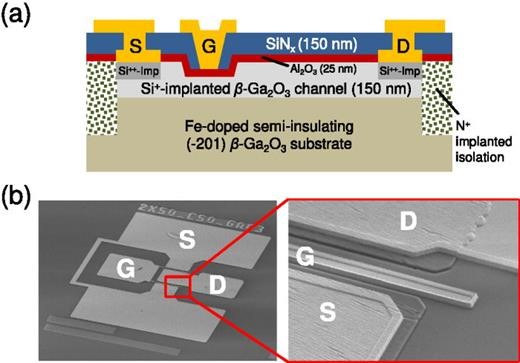
图 1. (a) 在半绝缘 (-201) β-Ga2O3 衬底上实现的全植入式 β-Ga2O3 MOSFET 的横截面示意图;(b) 制作的全植入式 β-Ga2O3 MOSFET 的顶视 SEM 图像,包括栅极区特写。
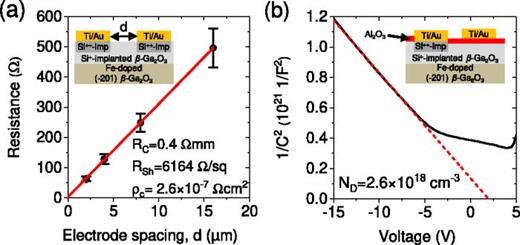
图 2. (a) TLM 曲线图,显示了硅注入半绝缘 (-201) β-Ga2O3 上的 TLM 结构的总电阻随电极间距变化的拟合曲线。(b) 在 100 kHz 频率下从 -15 到 5 V 的 C-V 扫频的 1/C2-V 图,得出 ND 为 2.6 × 1018 cm-3。插图显示了测量所用结构的示意图。
DOI:
doi.org/10.1063/5.0253992







