

【会员论文】厦门大学张洪良教授研究团队---Sn 掺杂 β-Ga₂O₃ 薄膜的电子结构与表面能带弯曲研究
日期:2025-03-31阅读:723
由厦门大学的研究团队在学术期刊 Physical Review B 发布了一篇名为 Electronic structure and surface band bending of Sn-doped β-Ga2O3 thin films studied by x-ray photoemission spectroscopy and ab initio calculations(Sn 掺杂 β-Ga2O3 薄膜的电子结构与表面能带弯曲研究)的文章。
项目支持
作者感谢中国国家重点研发计划(Grant No. 2022YFB3605501)和国家自然科学基金(Grant No. 22275154)提供的资金支持。J.W. 和 D.S. 感谢英国钻石光源公司对 EPSRC 博士培训中心分子建模与材料科学(EP/L015862/1)博士生奖学金的共同赞助。D.S. 感谢英国工程与自然科学研究委员会(EPSRC)(Grant No. EP/N01572X/1)的支持。该研究使用了英国国家超级计算服务 ARCHER 和 ARCHER2,通过研究团队作为英国高性能计算材料化学联盟的成员获得,该联盟由英国工程与自然科学研究委员会(EPSRC)资助(Grants No. EP/L000202、EP/R029431 和 EP/T022213)。研究团队感谢了英国材料与分子建模中心(托马斯和杨)提供的计算资源,该中心部分由英国工程与自然科学研究委员会(EPSRC)资助(EP/P020194/1 和 EP/T022213/1)。作者感谢伦敦大学学院的 Myriad、Kathleen 和 Thomas 高性能计算设施(Myriad@UCL、Kathleen@UCL、Thomas@UCL)以及相关支持服务在完成这项工作中的使用。P.M. 和 O.B. 的工作是在 GraFOx 的框架内完成的,GraFOx 是由莱布尼茨协会部分资助的莱布尼茨科学园区的一部分。团队感谢 Diamond Light Source Proposals No. SI31069 和 SI31681 的申请下,提供了 I09 光束线的使用机会。
背景
β-Ga2O3 由于其超宽禁带(~4.8 eV)和高击穿电场(8 MV/cm),被广泛应用于高功率电子器件、日盲深紫外光电探测器(DUV PD)以及透明导电氧化物(TCO)等领域。通过合适的 n 型掺杂(如 Si、Ge、Sn),可以调控载流子浓度并优化器件性能。然而,掺杂不仅影响载流子输运特性,还会引入额外的电子态,从而改变材料的电子结构和光学特性。因此,研究 n 型掺杂对 β-Ga2O3 电子结构的影响对于器件设计至关重要
主要内容
通过软 X 射线光电子能谱(soft PES, 1486.6 eV)和硬X射线光电子能谱(HAXPES, 5920 eV),探讨了 Sn 掺杂 β-Ga2O3 薄膜的体电子结构与表面电子结构。实验光谱与密度泛函理论(DFT)计算的价带与导带态密度进行了比较。结果表明,当考虑不同轨道在价带和导带中的光电离截面时,实验数据与计算结果高度一致。HAXPES 测量增强了 Ga 4s 轨道特征的电子态,从而推断出导带底部和价带底部均含有明显的 Ga 4s 成分。在高掺杂 Sn 的 Ga2O3 样品中,HAXPES 清晰地观察到了导带底部的载流子占据情况,从而可直接测量 Burstein-Moss 位移及带隙重正化随 Sn 掺杂的变化情况。此外,通过对比 Sn 掺杂 Ga2O3 与 Si 掺杂样品的价带光谱,发现 Sn 掺杂对电子结构的影响不同于 Si 掺杂。具体而言,在 Sn 掺杂 Ga2O3 中,观察到禁带内电子态,这被归因于 Sn2+ 相关的自补偿缺陷。同时,Sn 掺杂样品中观察到了更显著的带隙重整化,原因在于 Sn 5s 掺杂轨道与 Ga 4s 导带态发生了强烈混合。最后,通过对软 X 射线与硬 X 射线激发的价带及核心能级光谱的比较,进一步揭示了 Sn 掺杂 Ga2O3 薄膜表面区域存在向上能带弯曲。
关键发现
(1) 布尔斯坦-摩斯效应
Sn 掺杂 β-Ga2O3 形成高浓度自由电子,导致导带底被填充,光学带隙增大。例如,3% Sn 掺杂的薄膜,费米能级相对于导带底(CBM)上移 0.32 eV,表明 β-Ga2O3 进入了简并(degenerate)导电状态。然而,BMS 受掺杂诱导的带隙重整化影响,使得实际光学带隙的增幅小于理论预测。
(2) 禁带内电子态
高 Sn 掺杂会产生禁带内电子态(~3.5 eV),这种现象在 Si 掺杂 β-Ga2O3 中未观测到。这种禁带内电子态可能由 Sn2+ 相关的自补偿缺陷引起,与 Sb 掺杂 SnO2 的自补偿机制类似。由于 Sn 5s 轨道能级较低,其与 Ga 4s 轨道的强混合会进一步降低导带底能量,影响电子输运特性。
(3) 表面能带弯曲
采用 HAXPES 和 Soft PES 分析表面能带弯曲,发现 Sn 掺杂 β-Ga2O3 表面能带向上弯曲。3% Sn 掺杂的 β-Ga2O3 表面能带弯曲电势高达 0.4 eV,在表面形成电子耗尽层。这种特性与 In2O3、ZnO 等 n 型氧化物的向下弯曲(电子积累)相反,归因于 Ga2O3 的电中性能级较低,使表面态呈受主特性。
结论
综上所述,通过结合软 X 射线光电子能谱和硬 X 射线光电子能谱以及密度泛函理论,对掺 Sn 的 Ga2O3 薄膜的体相和表面电子结构进行了研究。在考虑不同轨道的光致电离截面的情况下,实验得到的价带光谱与轻掺杂 Ga2O3 的计算态密度之间具有很好的一致性。研究发现,相对于软 X 射线光电子能谱,硬 X 射线光电子能谱(HAXPES)在导带和价带底部的电子态有选择性地增强,这归因于这些态具有显著的 Ga 4s 特征。随着 Ga2O3 中 Sn 掺杂量的增加,通过 HAXPES 可以清晰地观察到较低导带的占据情况,从而能够直接确定带隙随 Sn 掺杂的变化。与掺硅的 Ga2O3 样品相比,掺 Sn 的 Ga2O3 薄膜表现出相对较大的带隙重整化,这是由于 Sn 5s 态与宿主 Ga 4s 衍生的导带强烈混合,这一点也得到了理论计算的进一步证实。此外,在掺 Sn 的 Ga2O3 中观察到了间隙态,这归因于与 Sn2+ 相关的自补偿缺陷态。对掺 Sn Ga2O3 电子结构的见解或许可以解释文献中所观察到的掺 Sn Ga2O3 薄膜具有更高的激活能和更低的电子迁移率。最后,通过软 X 射线和硬 X 射线激发的价带和核心能级光谱的比较,能够确定掺 Sn Ga2O3 中存在的向上表面能带弯曲。

图 1. (a) 单斜 β 相 Ga2O3 的晶体结构;Ga1 和 Ga2 分别位于 Td 和 Oh 配位。(b) Ga2O3(020) 反射附近的平面外 θ-2θ XRD 图样。(c) 锡和硅掺杂 Ga2O3 薄膜的室温霍尔迁移率与载流子浓度的函数关系。(d) 不同 x 的 (SnxGa1–x)2O3 的电阻率随温度的变化。
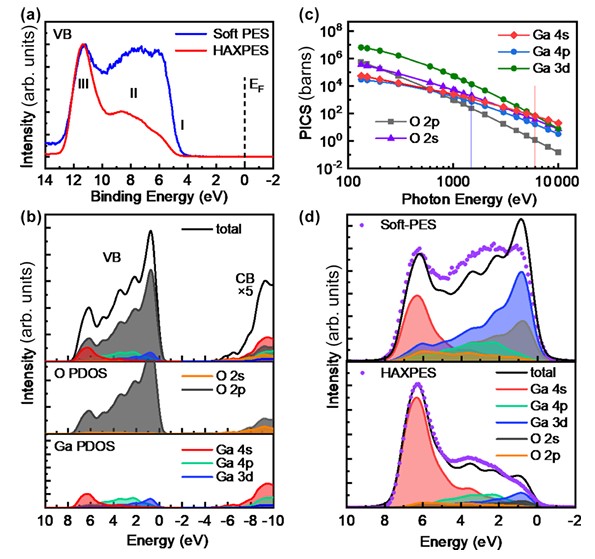
图 2. (a)掺 0.01%锡的 Ga2O3 样品的软 X 射线光电子能谱(PES)和高角分辨率 X 射线光电子能谱(HAXPES)测量的价带光谱。(b)Ga2O3 在价带和导带附近的总态密度(DOS)和部分态密度的 DFT 计算结果,考虑了仪器(0.6 eV 半高宽高斯函数)和寿命(0.2 eV 半高宽洛伦兹函数)展宽。(c)Ga 4s、Ga 4p、Ga 3d 和 O 2s、O 2p 的单电子光电子电离截面(PICS)随光子能量的变化,数据取自 Yeh 和 Lindau 以及 Scofeld。(d)0.01%锡掺杂的 Ga2O3 样品的软 X 射线光电子能谱(顶部)和高角分辨率 X 射线光电子能谱(底部)价带光电子发射谱,以及 Ga2O3 对应的 DFT 计算的总态密度和部分态密度,用 PICS 权重加权。测量的价带光电子发射谱在软 X 射线光电子能谱中向下刚性移动 4.95 eV,在高角分辨率 X 射线光电子能谱中向下刚性移动 5.05 eV,以使价带顶(VBM)与计算结果在 0 eV 结合能处对齐。
DOI:
doi.org/10.1103/PhysRevB.110.115120