

【国内论文】中山大学王钢教授、卢星教授、裴艳丽教授团队---在 β-Ga₂O₃中通过高温N离子注入实现高性能电流阻挡层
日期:2025-04-13阅读:768
由中山大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 High-temperature N ion implantation for performance-enhanced current-blocking layers in β-Ga2O3(在 β-Ga2O3 中通过高温 N 离子注入实现高性能电流阻挡层)的文章。
项目支持
该研究得到了国家重点研发计划(Grant No. 2024YFE0205300)和国家自然科学基金(Grant No. 62471504)的部分资助。作者感谢中山大学电子与信息技术实验教学中心和中国科学院苏州纳米技术与纳米仿生研究所纳米制造设备与纳米真空互联实验站(NANO-X)的技术支持。
背景
β-氧化镓(β-Ga2O3)因其极高的击穿场强和可获得大尺寸单晶衬底的优势,被认为是下一代电力电子器件的有力竞争者。垂直结构器件在高功率应用中更具优势,因其具有更好的电流处理能力和尺寸缩放潜力。电流阻挡层作为垂直器件中的关键结构,用于限制电流通路、阻止边缘漏电,从而提高器件的击穿电压和可靠性。离子注入是一种在半导体中选择性形成高阻或半绝缘电流阻挡层标准工艺,通常通过引入深能级缺陷或补偿性掺杂来实现。氮(N)常用于在 β-Ga2O3 中形成电流阻挡层的注入元素,作为深受主可以补偿材料中固有的 n 型杂质。常规的室温(RT)离子注入会产生晶格损伤(点缺陷、非晶化等),需要后续高温退火来恢复晶体质量并激活注入的杂质。然而,在 β-Ga2O3 中,仅凭后退火激活工艺可能导致注入杂质扩散、表面重构以及损伤不完全恢复或演变成更复杂的缺陷等问题,限制了 电流阻挡层的效果和稳定性。高温(HT)离子注入(即在注入过程中加热衬底)在其他半导体(如 SiC, GaN)中已被证明可以抑制非晶化、促进动态退火,有望获得更好的注入后晶体质量和电学性能。因此,有必要研究高温 N 离子注入在 β-Ga2O3 中形成电流阻挡层的具体效果。
主要内容
该研究揭示了高温氮(N)离子注入在制造 β-Ga2O3 电流阻挡层(CBL)方面的显著优势。研究团队对不同注入温度和注入后退火(PIA)条件下 N 掺杂 β-Ga2O3 的结构和电学特性进行了对比研究。研究结果表明,相较于室温注入(RTI),500°C的高温注入(HTI)能显著减少 β-Ga2O3 中的结构缺陷和晶格畸变。HTI 形成的 CBL 展现出比 RTI(无论是否经过 PIA)更低且更稳定的漏电流以及显著提高的击穿电压,从而表现出更优异的电流阻挡能力。此外,相较于采用 RTI+PIA 隔离的器件,采用 HTI 隔离的横向 MOSFET 的关态漏电流降低了三个数量级,同时保持了优异的开态性能。研究结果表明,HTI 的原位动态退火效应可有效减少注入引起的损伤,提高杂质的活化率,并显著改善 β-Ga2O3 中 N 掺杂 CBL 的整体性能。
总结
在 500 C 的高温条件下将 N 离子注入 β-Ga2O3 中,实现了高性能电流阻挡层。与使用 PIA 的 RTI 相比,HTI 工艺有效地减少了离子注入引起的损伤,保持了良好的表面形貌,并提高了杂质激活效率。用 HTI 制作的 CBL 漏电流更低、更稳定,击穿电压也显著提高。此外,基于 HTI CBL 的横向 MOSFET 的关态漏电流降低了三个数量级,并且具有良好的导通性能。研究结果显示了 HTI 工艺在制造 β-Ga2O3 功率器件方面的显著优势。
图文摘要
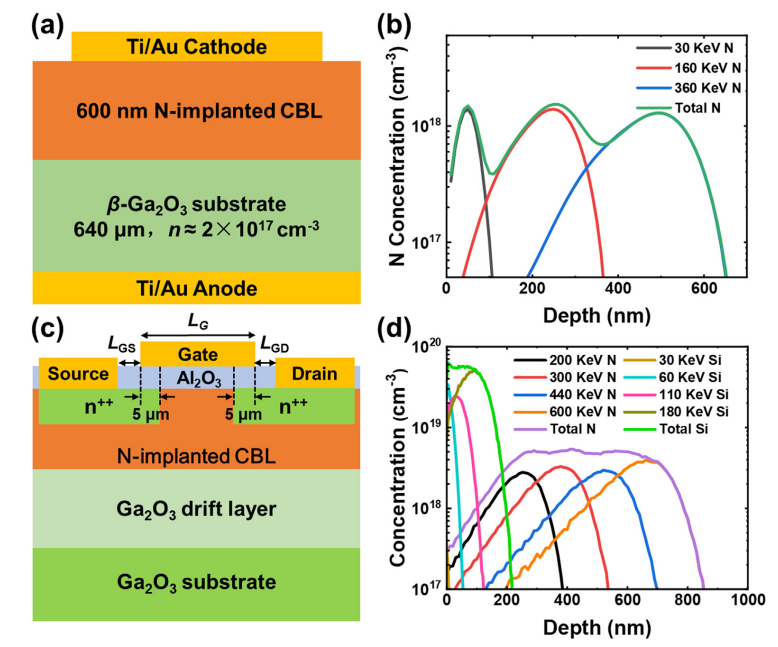
图 1. (a)CBL/n-Ga2O3 结构的横截面示意图和(b)相应的 N 离子注入的 SRIM 模拟深度分布。(c)采用 N 离子注入隔离的横向 MOSFET 的横截面示意图和(d)相应的 N 和 Si 离子注入的 SRIM 模拟深度分布。
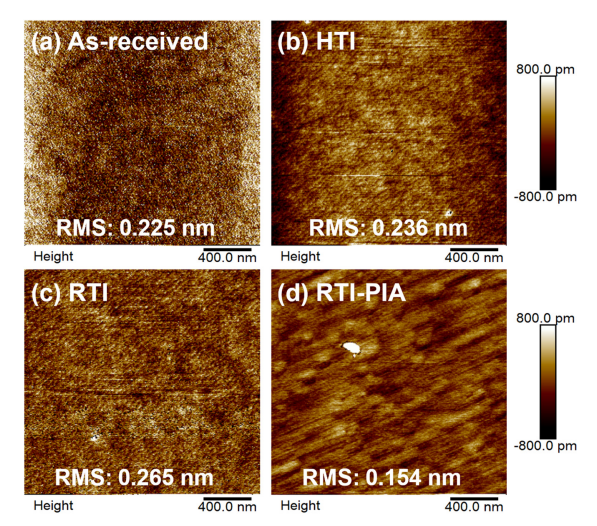
图 2. (a)原始样品、(b)高温退火样品、(c)室温退火样品以及(d)室温退火 - 等离子体浸没离子注入样品的 AFM 图像。
DOI:
doi.org/10.1063/5.0256968