

【会员论文】电子科技大学---1380 V β-Ga₂O₃ 沟槽MIS型超低漏电流肖特基势垒二极管
日期:2025-04-15阅读:760
由电子科技大学的研究团队在学术期刊 Japanese Journal of Applied Physics 发布了一篇名为 1380 V β-Ga2O3 trench MIS-type Schottky barrier diode with ultra-low leakage current(1380 V β-Ga2O3 沟槽 MIS 型超低漏电流肖特基势垒二极管)的文章。
背景
β-氧化镓(β-Ga2O3)具有 4.5 至 4.9 eV 的宽带隙、8 MV cm-1 的高临界击穿电场、1014 至 1019 cm-3 的可调控 n 型掺杂浓度、200 cm2 V-1·s-1 的适中电子迁移率以及相对较低的生产成本,因此在高压功率器件领域极具吸引力。最近,β-Ga2O3 被广泛用于制造高性能功率器件,如肖特基势垒二极管(SBD)、使用 p 型氧化镍的异质结 PN 二极管(HJD)、金属氧化物半导体场效应晶体管和调制掺杂场效应晶体管。对这些器件的研究表明,β-Ga2O3 是一种前景广阔的材料,这些研究工作促进了 β-Ga2O3 功率器件的开发和应用。
主要内容
该团队报道了一种具有双层场板终端结构和低成本 Al2O3/SiN 介质层的 β-Ga2O3 沟槽型肖特基势垒二极管(T-SBD)。由于沟槽型金属–绝缘体–半导体(MIS)结构所产生的屏蔽效应,相较于传统肖特基二极管(C-SBD),T-SBD 的击穿电压从 700 V 显著提升至 1380 V,含衬底的比导通电阻(Ron,sp)为 6.06 mΩ·cm2。
与 C-SBD 相比,T-SBD 的巴利加优值从 131 MW/cm2 提升至 314 MW/cm2。此外,T-SBD 的漏电流显著降低,从 C-SBD 的约 0.33 mA/cm2 降至约 38 μA/cm2,展示出优异的电学性能与器件可靠性。
创新点
·利用沟槽式MIS结构设计,有效抑制了肖特基结处电场,实现了超低漏电流(~38 μA/cm2)和高击穿电压(1380 V)的 β-Ga2O3 SBD 器件制备,展现其优异的高压运行能力。
·采用双层场板终端设计,使终端处电场集中进一步缓解,提高终端耐压。
总结
该团队制造出了一种具有双层场版终端和低成本 Al2O3/SiN 介电层的 β-Ga2O3 沟槽肖特基势垒二极管。与传统的平面SBD 相比,T-SBD 的击穿电压从 700V(C-SBD)提高到 1380V(T-SBD),而 Ron,sp 几乎没有增加。巴利加优值提高了 139.7%。此外,与传统的 SBD 相比,T-SBD 的漏电流降低了 88.5%。这项研究表明,沟槽式 β-Ga2O3 SBD 在高电压和低泄漏电流应用领域具有巨大潜力。
图文示例
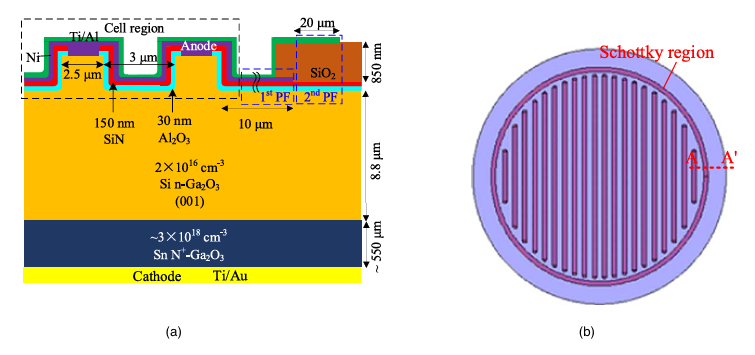
图 1:(a)图 1(a)中沿 AA' 制作的 T-SBD 的示意图;(b)T-SBD 的布局设计。红色图案代表鳍区(肖特基区),蓝色图案代表镍。外圈的镍只是用来定义有源区。
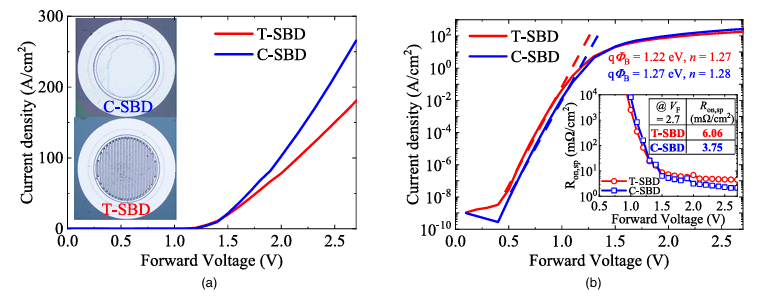
图 2. 测量到的 C-SBD 和 T-SBD 的 IV 曲线。(a) 线性轴。(b) 半对数轴。
DOI:
doi.org/10.35848/1347-4065/adc053