

【会员论文】西安交通大学---X 射线和中子辐照诱导的 β-Ga₂O₃ 肖特基势垒二极管电气性能退化研究
日期:2025-04-27阅读:707
由西安交通大学的研究团队在学术期刊 Electronics 发布了一篇名为 Investigation of Electrical Performance Degradation of β-Ga2O3 Schottky Barrier Diodes Induced by X-Ray and Neutron Irradiation(X 射线和中子辐照诱导的 β-Ga2O3 肖特基势垒二极管电气性能退化研究)的文章。
项目支持
主要内容
结果表明 X 射线辐照下,随着辐照通量的增加,器件的正向电流密度、漏电流与反向电流密度均有所升高,说明器件性能随辐照剂量不断退化;中子辐照后,器件正向电流密度减小,而漏电流与反向电流密度则升高。
通过低频噪声(LFN)与深能级瞬态谱(DLTS)技术,分析了辐照前后器件中缺陷浓度的变化。研究发现,X 射线辐照主要引入界面缺陷,而中子辐照则显著增加器件体内的缺陷浓度。此外,利用二维 TCAD 仿真进一步验证了实验结果,为 β-Ga2O3 器件辐照可靠性研究与设计优化提供了理论依据和实验数据支持。
总结
该研究采用实验与仿真相结合的方法,系统研究了 β-Ga2O3 SBD 在不同剂量 X 射线辐照下的电性能退化。结果表明,X 射线的总剂量效应(TID)主要在器件界面引入缺陷,造成性能下降;而中子辐照则引起位移损伤,导致器件体内缺陷浓度显著增加。
DLTS 表征显示,中子位移损伤所引起的缺陷能级并未发生变化,但其浓度明显提升。由于这些体缺陷带来的载流子去除效应,使得器件的正向电流密度降低,同时作为泄漏通道的缺陷导致反向电流密度上升、载流子迁移率降低、器件击穿电压下降。
二维 TCAD 仿真进一步揭示了 X 射线 TID 与中子位移损伤对器件性能的不同影响,并与实验结果高度一致,验证了模拟手段的准确性。研究结果揭示了 β-Ga2O3 器件在辐照环境下的性能退化机制,为其在高辐照场合的应用提供了可靠的理论依据,也为今后辐射加固设计提供了技术支撑。
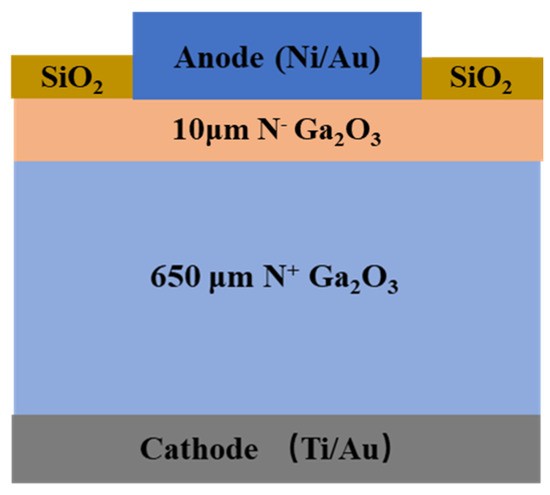
图 1. β-Ga2O3 SBD 器件结构的横截面示意图。

图 2. X 射线照射后器件电气特性的变化:(a)正向电流密度;(b)反向电流密度。
DOI:
doi.org/10.3390/electronics14071343