

【会员论文】厦大杨伟锋教授团队:通过原子氮处理增加Al₂O₃/Ga₂O₃界面的固定电荷,实现高性能Ga₂O₃沟槽肖特基势垒二极管
日期:2025-04-27阅读:782
由厦门大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Increase fixed charge at Al2O3 / Ga2O3 interface for high-performance Ga2O3 trench Schottky barrier diodes by atomic nitrogen treatment (通过原子氮处理增加 Al2O3 / Ga2O3 界面的固定电荷,实现高性能 Ga2O3 沟槽肖特基势垒二极管)的文章。
项目支持
该项研究得到国家自然科学基金(Grant No. 62171396)和深圳市科技计划(Grant No. JCYJ20240813145617023)的资助。
背景
β-氧化镓(β-Ga2O3)因其宽禁带(4.5-4.9 eV)和高理论击穿场强(~8 MV/cm)等优势,在功率电子器件领域备受关注,且具有低成本熔融生长大尺寸衬底的潜力。传统的平面肖特基势垒二极管(SBD)在反向偏压下,阳极边缘易出现电场拥挤,导致器件过早击穿和漏电流增大。沟槽型肖特基势垒二极管(TSBD)结构通过将肖特基接触嵌入沟槽中,能够有效缓解边缘电场拥挤,提高击穿电压。尽管 β-Ga2O3 TSBD 已取得显著进展(如实现 kV 级击穿电压),但沟槽界面处(尤其是在刻蚀过程中引入的)缺陷和氧空位(Vo)仍然是限制器件性能的关键挑战。通过界面工程(如缺陷钝化、调控界面电荷)来改善沟槽界面质量,对提升 Ga2O3 功率器件的性能至关重要。
主要内容
通过在 Al2O3/β-Ga2O3 界面进行原子氮处理,显著提升了垂直结构 β-Ga2O3 金属–绝缘体–半导体(MIS)沟槽型肖特基势垒二极管(TSBDs)的击穿电压。经处理的 TSBD 器件的击穿电压从 832 V 提升至 1200 V,同时保持低导通电压(0.9 V)与低比导通电阻(12.1 mΩ cm2)。根据 X 射线光电子能谱(XPS)分析,原子氮处理减少了 β-Ga2O3 表面的氧空位,并促进了 Al2O3/Ga2O3 界面 Ga–O–N 三元化合物的形成。这些 Ga–O–N 化合物可以钝化由感应耦合等离子体(ICP)刻蚀引起的 Ga2O3 沟槽表面缺陷,从而有效降低 Al2O3/Ga2O3 MIS TSBD的漏电流。与此同时,原子氮处理使采用 Al2O3 介质的 Ga2O3 MOS 电容器出现平带电压正向偏移,表明在 Al2O3/Ga2O3 界面固定电荷密度(Q₁)增加,这在反向偏置下可扩展耗尽区,增强接触势垒。上述结果表明,原子氮处理能够有效优化沟槽 MIS 结构的界面特性,是提升 Ga2O3 基肖特基势垒二极管性能的有效策略。
总结
该研究已经证明,对 Ga2O3 沟槽肖特基势垒二极管(TSBD)中的 Al2O3/Ga2O3 界面进行原子氮处理,显著提高了器件性能,将击穿电压从 832 V 提高到 1200 V,同时保持了低的开启电压(Von)和特定导通电阻(Ron,sp)。同时,XPS 光谱证实,该处理减少了氧空位,并促进了界面处 Ga-O-N 化合物的形成,后者钝化了缺陷并降低了漏电流。此外,C-V 测量表明,该处理提高了 Al2O3/Ga2O3 界面的固定电荷密度,从而扩大了耗尽区,并进一步增强了接触势垒。TCAD 模拟进一步证实,通过原子氮处理在 Al2O3/Ga2O3 界面引入固定负电荷,有效地优化了电场分布,从而增强了器件的击穿能力。这些发现表明,原子氮处理在推进基于 Ga2O3 的沟槽肖特基势垒二极管在高功率电子学中的应用方面是有效的,确立了这一方法作为提升氧化镓器件性能边界的一种有前景的策略。
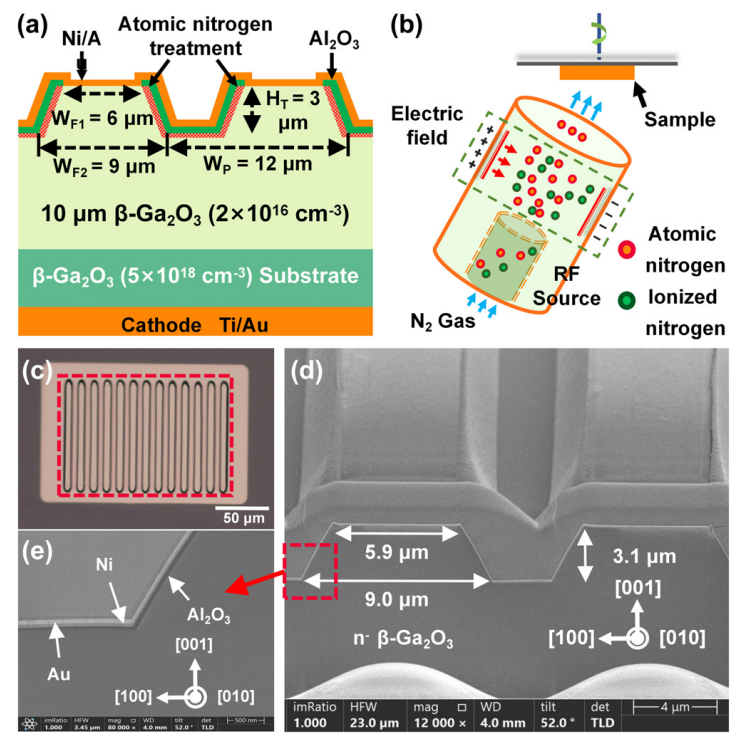
图 1. (a) 原子氮处理过的 Ga2O3 TSBD 横截面示意图。(b) 原子氮源界面处理过程示意图,其中高能电离氮被电场(即等离子体约束板)过滤,氮原子得以到达样品表面并与之相互作用。(c) 在光学显微镜下拍摄的 Ga2O3 TSBD 俯视图,红色虚线框表示用于计算电流密度的区域。(d) Ga2O3 TSBD 的扫描电子显微镜图像,清晰显示沟槽结构和蚀刻形成的倾斜梯形界面。(e) (d) 中特定区域的高倍扫描电子显微镜图像。

图 2. 原子氮处理过的 Ga2O3 TSBD 的制造工艺流程。
DOI:
doi.org/10.1063/5.0254888