

【会员论文】复旦大学---通过O₂等离子体和退火实现了超过 1.2GW/cm² β-Ga₂O₃ SBD,击穿电压为 1.93kV
日期:2025-05-22阅读:612
由复旦大学的研究团队在学术期刊 Semiconductor Science and Technology 发布了一篇名为 Over 1.2 GW/cm2 β-Ga2O3 SBD with Vbr of 1.93 kV realized by O2 plasma and annealing(通过 O2 等离子体和退火实现了超过 1.2GW/cm2 β-Ga2O3 SBD,Vbr 为 1.93kV)的文章。
项目支持
该项研究得到了上海市科学技术委员会资助 (Grant 23511102300 和 24DP1500105)。
背 景
β-氧化镓(β-Ga2O3)因其超宽带隙、高击穿场强、可接受的电子迁移率以及可低成本大规模生产的潜力,被认为是下一代功率半导体器件的有力竞争者。然而,在实际器件设计中,实现低开启电压(Von)、低导通电阻(Ron,sp)和高击穿电压(Vbr)三者的同时优化一直面临难以协调的物理瓶颈,这通常与界面质量受损或缺陷产生有关。
主要内容
在这项研究中,通过应用 O2 等离子体和退火处理(OPAT),β-Ga2O3 肖特基势垒二极管(SBD)的电性能得到了显著提升。与对照器件相比,OPAT 处理后的 β-Ga2O3 SBD 在开启电压(Von)、比导通电阻(Ron,sp)和击穿电压(Vbr)方面表现更优。此外,通过采用电子束蒸发的 Al2O3 作为场板氧化物,表面击穿电场从 2.19 MV/cm 提升至 4.09 MV/cm,这是通过 TCAD 模拟得出的结果。OPAT 场板 β-Ga2O3 SBD 在 1 A/cm2 的电流密度下实现了 0.52 V 的开启电压(Von)、3.10 mΩ·cm2 的比导通电阻(Ron,sp)和 1.93 kV 的击穿电压(Vbr)。其功率优值达到了 1.2 GW/cm2。X 射线光电子能谱测量表明,OPAT 处理降低了氧空位的浓度,从而降低了器件的肖特基势垒高度,进而提升了 β-Ga2O3 SBD 的性能。这些结果表明,β-Ga2O3 在低开启电压和高击穿电压的应用中具有巨大的潜力。
创新点
提出 OPAT 策略,将低功率 O2 等离子体(50 W,40 s)与空气退火联合使用,同步优化界面与体内缺陷。
实验首次实证 OPAT 能显著降低 Schottky 势垒高度(SBH),并减小氧空位比例(由 XPS 证实)。
结合电子束蒸发形成 FP 结构,通过 lift-off 工艺避免传统刻蚀带来的损伤,提高可靠性。
TCAD 模拟显示该方法可使表面最大电场由 2.19 MV/cm 提升至 4.09 MV/cm,有效分散电场分布,抑制击穿。
与已有文献对比,在不牺牲 Ron,sp 和 Von 的前提下,实现接近 2 kV 的超高 Vbr,刷新 β-Ga2O3 SBD性能记录。
结 论
研究团队在 OPT 和 OPAT 对 β-Ga2O3 SBD 性能的影响进行了研究。XPS 测量表明,OPAT 会显著降低 VO 的相对百分比。TCAD 模拟表明,OPAT FP 样品的表面电场几乎是对照样品的两倍。OPAT FP 器件的 Von 值为 0.52 V,Ron,sp 值为 3.10 mΩ·cm2,Vbr 值为 1.93 kV。在达到 1.2 GW/cm2 PFOM 的同时,它还保持了较低的 Von。这些结果表明,利用 EBE 制造的 OPAT 和 FP 结构在提高功率电子器件中 β-Ga2O3 SBD 的性能方面大有可为。
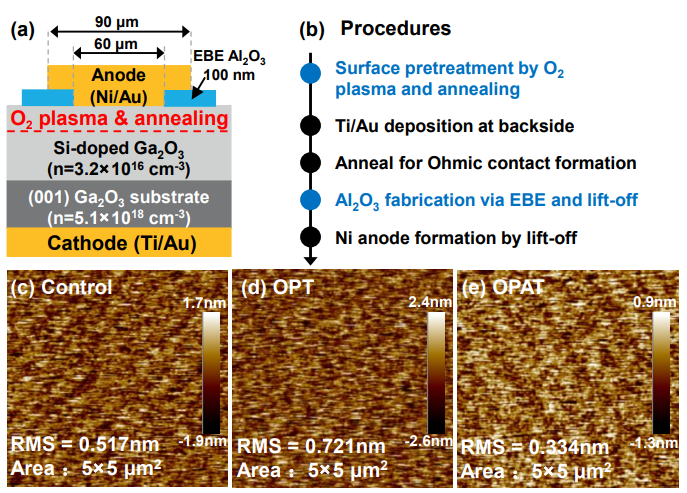
图 1:(a) OPAT FP β-Ga2O3 SBD 的示意图和 (b) 制作过程。用原子力显微镜测量的 (c) 对照样品、(d) OPT 样品和 (e) OPAT 样品的表面形貌。
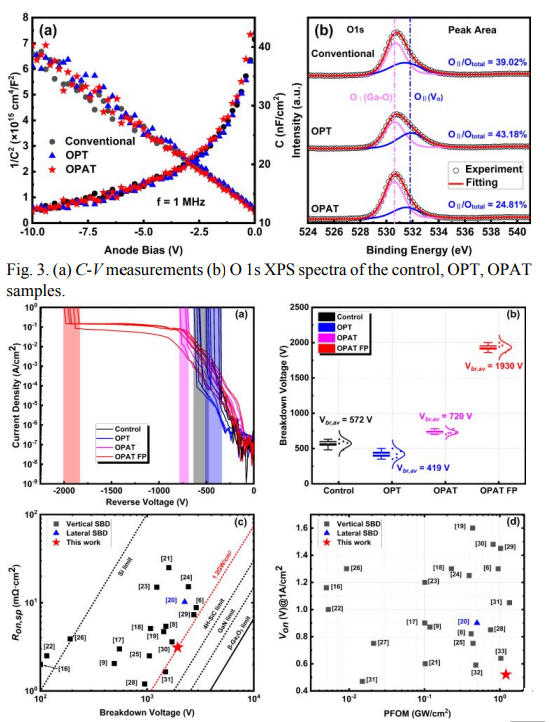
图 2:(a)反向特性(b)对照、OPT、OPAT 和 OPAT FP β-Ga2O3 SBD 的统计图。(c) Ron,sp vs Vbr (d) Von vs PFOM 的基准图,适用于最先进的 β-Ga2O3 SBD。
DOI:
doi.org/10.1088/1361-6641/adcd24







