

【知识探索】氮氧化镓材料:“镓体系”材料器件中的多面手
日期:2025-06-16阅读:1795
一、氮氧化镓材料基本性质:可调宽禁带与多功能特性
氮氧化镓(Gallium Oxynitride,GaOxNy)是一种介于晶态与非晶态之间的化合物。其物化性质可通过调控制备条件在氮化镓(GaN)与氧化镓(Ga2O3)之间连续调整,兼具宽禁带半导体特性与灵活的功能可设计性,因此在功率电子、紫外光电器件及光电催化等领域展现出独特优势[1-2]。
晶体结构多样性:GaON的晶体结构包括非晶态、β相(Ga2ON3)、γ相(Ga3O3N)及六方GaOxN1-x等,结构与性能高度依赖于合成工艺[1]。
能带工程潜力:禁带宽度(Eg)介于GaN(3.4 eV)与Ga2O3(4.5–4.9 eV)之间,可通过调节氧氮比实现带隙精确调控。
界面优化特性:GaON与GaN晶格匹配度高,可作为异质结中间层,抑制金属诱导间隙态(MIGS)和界面悬键态,提升器件界面质量[7]。
选择性氧化工艺:基于GaN较InAlN更易氧化的热力学特性,可在不损伤InAlN势垒层的前提下,通过氧化反应精准制备GaON功能层[8]。
二、氮氧化镓材料制备方法
等离子体注入氧化:将氧等离子体注入GaN晶格,经退火使氧原子替代氮原子,形成六方GaOxNy纳米层[2]。
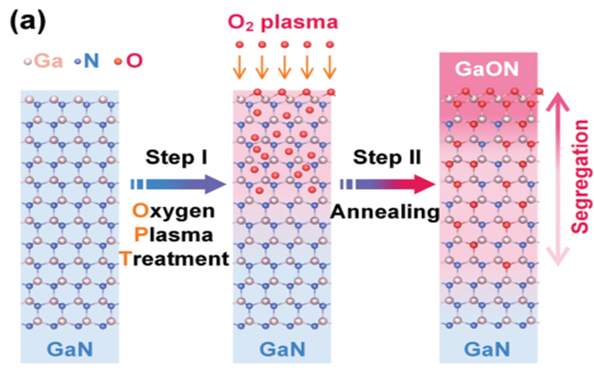
氧等离子体注入(OPT)+退火形成六方GaOxNy的制备方法
射频磁控溅射氧化:以Ga2O3为靶材,通过调控N2/O2等离子体比例实现组分控制,结合真空退火优化晶体结构,如下方相图所示[1]:
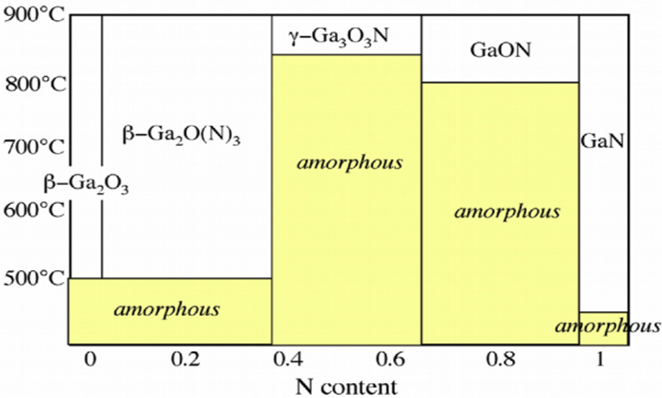
射频磁控溅射+真空退火形成六方GaOxNy的制备方法
高温退火:在含氧气氛中对GaN表面进行高温退火,直接生成GaON层,工艺简单且兼容现有器件工艺[9]。
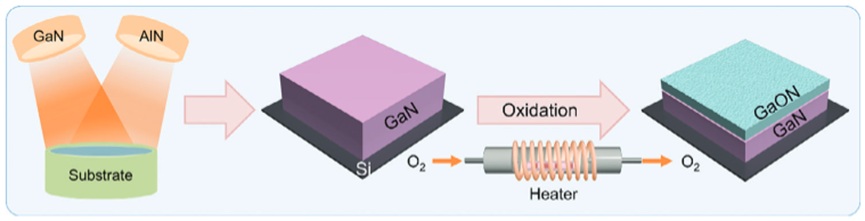
氧气氛围退火形成GaON的制备方法
三、核心应用:从电力/射频电子到紫外光电
电力电子器件领域:
在p-GaN肖特基二极管(SBD)的阴极金属层下方引入GaON纳米层,可提升反向击穿特性:利用GaON与GaN的价带带阶差(~ 0.5 eV)阻挡空穴反向注入,使漏电流降低两个数量级,同时保持低导通电阻(Ron)[2]。
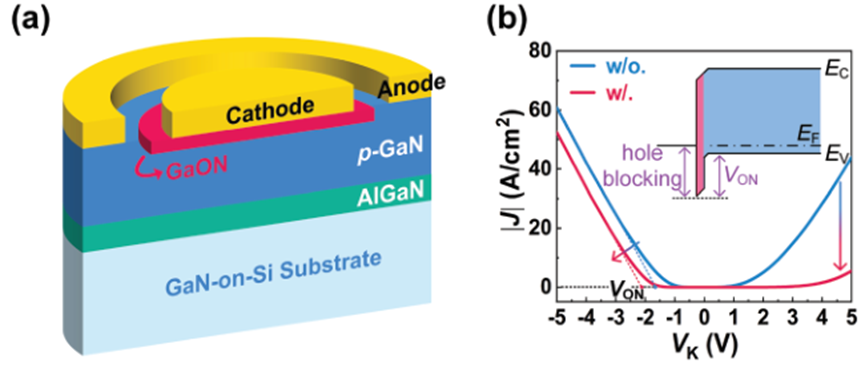
在p-GaN SBD的阴极下方引入GaON层的作用
射频电子器件领域:
在GaN高电子迁移率晶体管(HEMT)中,栅极金属与沟道二维电子气(2DEG)间的界面态(如金属诱导间隙态,MIGS)是制约高频性能的关键瓶颈。传统解决方案常通过复杂外延结构或昂贵衬底(如碳化硅)优化界面质量,但存在工艺成本高、可扩展性受限等问题。中国科学院半导体所张韵团队基于GaON材料的创新性工艺为这一难题提供了全新路径:
1. 选择性氧化工艺的独特优势:
通过等离子体氧化技术(OPT),在GaN/InAlN异质结的栅下区域精准氧化2 nm厚GaN帽层,生成GaON插入层。该工艺巧妙利用GaN较InAlN更易氧化的热力学特性,在不损伤InAlN势垒层的前提下,实现界面态的主动调控[8]。这一技术突破避免了传统刻蚀或外延工艺对极化电荷的破坏,确保了2DEG的高密度与高迁移特性。
2. 高频性能的显著提升:
引入GaON层后,栅极漏电流降低一个数量级,电子有效漂移速率提升至2.2×107 cm/s(传统器件约1.5×107 cm/s)。器件截止频率(fT)和最高振荡频率(fmax)分别达到240 GHz与530 GHz,与碳化硅衬底器件性能相当,首次在低成本蓝宝石衬底上实现Ka波段噪声系数低于0.98 dB、W波段线性增益8 dB的超高频性能[8]。这一成果突破了衬底材料对高频器件的限制,为大规模商业化提供了可能。
3. 工艺兼容性与微缩潜力:
相比需要复杂外延堆叠的AlN/GaN超晶格界面优化方案,GaON插入层工艺仅需局部氧化改性,与现有GaN HEMT产线高度兼容。此外,GaON层对界面态的钝化作用显著降低了短沟道效应,使器件在微缩至亚100 nm栅长时得到优异频率特性,为5G/6G通信和太赫兹技术提供了可扩展的技术路径。
意义总结:重新定义GaN HEMT的性能边界
GaON材料的引入不仅解决了传统界面优化技术中“性能-成本-工艺”难以兼得的矛盾,更通过以下创新点推动了GaN HEMT技术的跨越式发展:
1. 低成本衬底高性能化:在蓝宝石衬底上实现与碳化硅器件相当的射频指标,大幅降低商用化门槛。
2. 界面态主动调控:通过选择性氧化实现纳米级界面工程,避免外延工艺对极化电荷的破坏。
3. 高频-低噪-高功率均衡提升:突破传统技术中频率与噪声性能的此消彼长,为多功能集成器件奠定基础。

在高频GaN HEMT的栅极下方引入GaON层

器件的bench mark比较
光电器件领域:
1. 光电催化:在n-GaN表面沉积GaON层可钝化表面缺陷并提供更多催化活性位点,显著提升光电化学水分解效率[10]。
2. 紫外探测:在p-GaN探测器电极界面引入GaON层,利用其价带带阶差阻挡空穴复合,暗电流降低至10−12 A量级,器件灵敏度提升3倍[2]。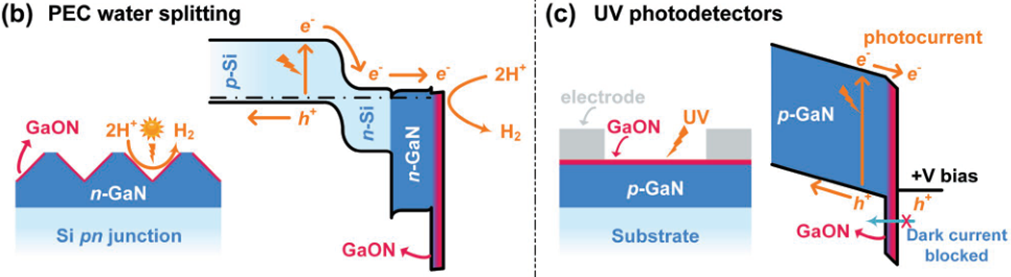
左:在光电催化水分解材料中引入GaON层的作用;右:在紫外光电探测器中引入GaON层的作用。
界面接触技术领域:
在GaN基器件中,金属-半导体欧姆接触的界面态(如金属诱导界面态和悬键态)会导致严重的费米能级钉扎效应,使接触电阻率(ρc)长期停滞在10−7Ω·cm2量级,成为器件微缩化与高频化的主要障碍[7]。
GaON插入层的创新性解决方案
中国科学院半导体所张韵团队通过表面退火工艺在Ti/n-GaN界面引入2-3 nm厚GaON层,实现以下突破:
1. 界面态钝化:GaON层有效钝化界面缺陷,缓解费米能级钉扎,使接触势垒高度从0.42 eV降至0.24 eV。
2. 载流子隧穿增强:GaON与n-GaN导带对齐(ΔEC≈ 0),有利于降低隧穿电阻。
3. 工艺兼容性:仅需在标准退火流程中引入氧掺杂步骤,无需复杂外延或图形化工艺,与现有工艺无缝衔接[7]。
核心意义:重新定义欧姆接触的设计范式
1. 微缩化关键支撑:超低ρc能使GaN器件在纳米级尺寸下仍保持低寄生电阻,突破高频器件的微缩极限。
2. 普适性创新:该技术可扩展至其他宽禁带半导体(如SiC、Ga2O3)的欧姆接触优化,为其他材料器件领域的接触电阻优化提供通用解决方案。

在Ti/n-GaN界面引入GaON层的作用
四、未来展望:材料创新驱动器件性能升级
对于氮氧化镓材料应用的深入研究,不仅解决了传统GaN器件在界面态和高频性能上的瓶颈,还为紫外光电、功率电子和太赫兹通信等领域的关键问题提供了全新解决方案。随着制备工艺的成熟和成本下降,这类材料有望助力新一代半导体技术的发展。
参考文献
[1] AKAZAWA H. Crystallization of gallium oxynitride thin films [J]. Journal of Solid State Chemistry, 2020, 282: 121066.
[2] CHEN J, ZHAO J, FENG S, et al. Formation and Applications in Electronic Devices of Lattice-Aligned Gallium Oxynitride Nanolayer on Gallium Nitride [J]. Advanced Materials, 2023, 35(12): 2208960.
[3] KING P D C, VEAL T D, KENDRICK C E, et al. InN/GaN valence band offset: High-resolution x-ray photoemission spectroscopy measurements [J]. Phys Rev B, 2008, 78(3): 033308.
[4] YUAN L, LI S, SONG G, et al. Solution-processed amorphous gallium oxide gate dielectric for low-voltage operation oxide thin film transistors [J]. Journal of Materials Science: Materials in Electronics, 2021, 32(7): 8347-53.
[5] SPENCER J A, MOCK A L, JACOBS A G, et al. A review of band structure and material properties of transparent conducting and semiconducting oxides: Ga2O3, Al2O3, In2O3, ZnO, SnO2, CdO, NiO, CuO, and Sc2O3 [J]. Appl Phys Rev, 2022, 9(1): 011315.
[6] ZVORISTE C. High-Pressure Synthesis, Crystal Structure and Physical Properties of Gallium Oxonitride [D]. Darmstadt; Technical University of Darmstadt, 2011.
[7] XIE S, HE J, WU X, et al. Achieving Ultralow Specific Contact Resistivity in Ti/n+-GaN Ohmic Contacts by Mitigating the FLP Effect with a Gallium Oxide Interlayer [J]. ACS Applied Electronic Materials, 2025, 7(7): 2709-19.
[8] HE J, CHENG Z, XIE S, et al. High-performance GaN HEMTs with GaON under-gate cap layer via barrier-friendly selective plasma oxidation [J]. Applied Physics Letters, 2025, 126(14): 143507.
[9] DAS D, SANCHEZ F, NALAM P G, et al. Effect of Thermal Oxidation on the Structure, Surface Texturing, and Microstructure Evolution in Nanocrystalline Ga─O─N Films [J]. Advanced Materials Interfaces, 2025, 12(5): 2400500.
[10] ZENG G, PHAM T A, VANKA S, et al. Development of a photoelectrochemically self-improving Si/GaN photocathode for efficient and durable H2 production [J]. Nature Materials, 2021, 20(8): 1130-5.


