

【会员论文】日本NCT:具有5.2 MV/cm改进电场的1844 V β-Ga₂O₃沟槽MOS肖特基二极管
日期:2025-06-20阅读:598
由日本 Novel Crystal Technology 的研究团队在本次 ISPSD 2025 学术会议上发表了一篇名为 1844 V β-Ga2O3 Trench-MOS Schottky Barrier Diodes with Improved Electric Field of 5.2 MV/cm(具有 5.2 MV/cm 改进电场的 1844 V β-Ga2O3 沟槽 MOS 肖特基二极管)的文章。
背 景
β-氧化镓(β-Ga2O3)作为一种极具前景的超宽禁带半导体,是开发下一代高压、高效功率器件的理想材料。垂直结构的功率二极管是功率系统中的基本元件。其中,沟槽 MOS 肖特基势垒二极管是一种先进的器件结构。它将肖特基二极管与沟槽 MOS 电容结构相结合,旨在利用沟槽 MOS 的场屏蔽效应来降低器件在反向偏压下的漏电流,并提高击穿电压。对于功率器件而言,一个核心目标是最大化器件所能承受的电场强度,使其尽可能接近材料的理论击穿场强极限。这需要精密的器件设计,特别是有效的终端技术和电场管理结构。实现安培级的大电流处理能力以及在更大尺寸晶圆上的制造,是推动 Ga2O3 器件从实验室研究走向商业化应用的关键。
主要内容
研究团队采用 4-inch 晶圆工艺开发了安培级 β-Ga2O3 沟槽金属氧化物半导体肖特基势垒二极管(MOSSBD)。该器件采用镁离子注入边缘终止结构,并通过缩小沟槽间距宽度来改善反向特性,如漏电流和击穿电压。根据脉冲 I-V 特性计算,制备的 MOSSBD 在最大电流为 2 A 时的典型特定导通电阻和导通电压分别为 4.2 mΩ·cm2 和 1.0 V。当台面宽度为 1.2 μm、沟槽宽度为 0.8 μm 时,最大击穿电压为 −1844 V,对应的电场强度和功率器件性能指标分别为 5.2 MV/cm 和 0.71 GW/cm2。这些结果是迄今为止报道的 β-Ga2O3 肖特基势垒二极管中最高的值。通过实现 5.2 MV/cm 的最大电场,克服了超越碳化硅功率器件性能的最困难挑战之一,极大地提高了 β-Ga2O3 功率器件在实际应用中的前景。
实验细节
•基于 4-inch 晶圆工艺制造的器件,显示出向规模化生产迈进的潜力。
•垂直沟槽 MOS 肖特基势垒二极管。该结构在 Ga2O3 漂移层中刻蚀出沟槽,沟槽的侧壁和底部由栅极氧化物和金属构成 MOS 结构,而台面顶部形成肖特基接触。
•采用镁(Mg)离子注入技术形成边缘终端保护结构。
•对沟槽的尺寸进行了优化,最佳性能的器件其台面宽度为 1.2 µm,沟槽宽度为 0.8 µm。
创新点
•首次使用 4 英寸晶圆工艺成功制造出安培级的 β-Ga2O3 沟槽 MOSSBDs,展示了该技术的可扩展性。
•在 β-Ga2O3 二极管中实现了创纪录的 1844 V 击穿电压和接近材料极限的 5.2 MV/cm 电场强度。
•有效地将 Mg 离子注入边缘终端和减小微米级沟槽间距两种关键设计策略相结合,协同提升了器件的击穿电压和内部电场强度。
•获得了 0.71 GW/cm2 的卓越功率优值,使 β-Ga2O3 二极管的性能处于功率半导体领域的前沿。
总 结
采用 4-inch 晶圆工艺开发了安培级 β-Ga2O3 沟槽 MOSSBD 器件。该器件采用 Mg 离子注入边缘终止结构,并通过缩小沟槽间距宽度来改善反向特性,如漏电流和反向电压(VBR)。根据脉冲 I-V 特性(最大电流为 2 A)计算得到的制备 MOSSBD 的典型 Ron,sp 和 VON 值分别为 4.2 mΩ·cm2 和 1.0 V。在台面宽度为 1.2 μm、沟槽宽度为 0.8 μm 时,获得的最大 VBR 为 −1844 V,对应的 Emax 和 PFOM 分别为 5.2 MV/cm 和 0.71 GW/cm2。这些值是迄今为止报道的基于 β-Ga2O3 的 SBD 中最高的。因此证实了离子注入边缘终止和减小沟槽间距宽度可改善 β-Ga2O3 MOSSBD 的反向特性。通过实现 5.2 MV/cm 的最大电场,克服了超越 SiC 功率器件性能的最困难挑战之一;目前仅剩的难题是降低 β-Ga2O3 MOSSBD 的寄生导通电阻。这一进展极大提升了 β-Ga2O3 功率器件实际应用的前景。研究人员相信,性能与 SiC 器件相当或超越其性能的 β-Ga2O3 功率器件将在不久的将来实现。
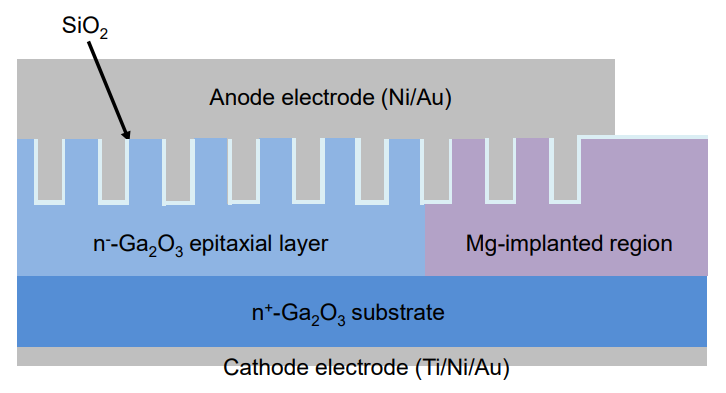
图1 沟槽型MOSSBD的示意性截面图。
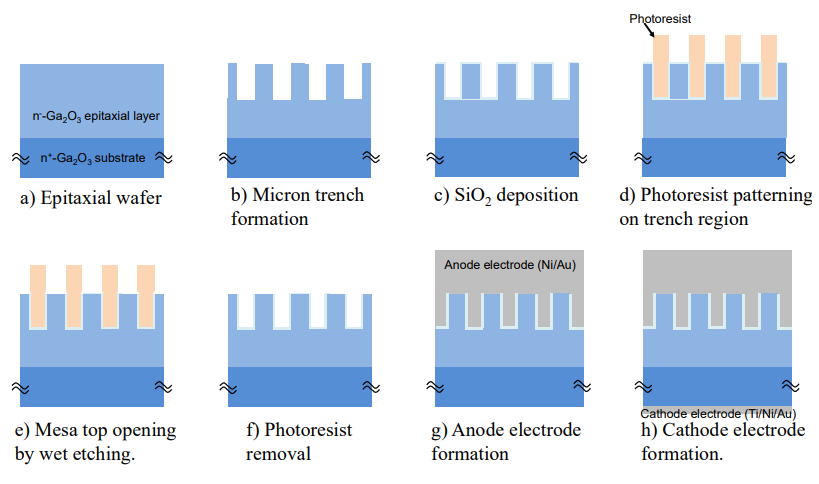
图2 沟槽型β-Ga2O3 MOSSBDs的制备过程。