

【国内论文】华南师范大学&南京大学&深圳大学团队:具有氦离子注入边缘终端的3.0 kV β-Ga₂O₃基垂直p-n异质结二极管
日期:2025-07-03阅读:560
由华南师范大学、南京大学与深圳大学团队在学术期刊 IEEE Transactions on Electron Devices 发布了一篇名为 3.0 kV β-Ga2O3-Based Vertical p-n Heterojunction Diodes With Helium- Implanted Edge Termination(具有氦离子注入边缘终端的 3.0 kV β-Ga2O3 基垂直 p-n 异质结二极管)的文章。
项目支持
本研究部分由中国国家重点研发计划(项目编号:2024YFE0205100)资助,部分由广东省基础与应用基础研究重大项目(项目编号:2023B0303000012)资助,部分由广东省杰出青年科学基金(项目编号:2022B1515020073)资助, 部分由深圳市科技计划项目资助(项目编号:KJZD20240903102738050),部分由深圳大学科学仪器开发项目资助(项目编号:2024YQ003)。作者谨此感谢东莞市中镓半导体科技有限公司在器件制备过程及工作讨论中提供的宝贵支持。
项目支持
β-氧化镓(β-Ga2O3)因其超宽禁带和高临界击穿场强,是制造下一代高压功率器件的理想材料。垂直结构的 p-n 二极管是功率电子系统中的基本构件。由于 β-Ga2O3 缺乏有效的 p 型掺杂,通常采用 p 型氧化镍(NiO)与 n 型 Ga2O3 构建异质结(p-n HJD)。对于高压器件,其性能极限往往受限于器件边缘的电场集中效应,这会导致器件在远低于材料理论极限的电压下发生过早击穿。边缘终端技术是解决这一问题的关键。离子注入是一种在半导体中精确形成高阻区或掺杂区的标准平面工艺。通过在器件边缘注入特定离子,可以形成一个高阻的“虚拟保护环”,有效缓解电场集中。之前已有研究使用氮(N)、镁(Mg)、铁(Fe)等离子进行注入,但这些元素可能会在 Ga2O3 中引入电学活性,影响器件的长期稳定性。而惰性气体离子,注入后主要通过产生晶格位移损伤来形成深能级陷阱,从而实现高电阻率,且其化学性质稳定,是一种极具吸引力的选择。
背 景
β-氧化镓(β-Ga2O3)因其超宽禁带和高临界击穿场强,是制造下一代高压功率器件的理想材料。垂直结构的 p-n 二极管是功率电子系统中的基本构件。由于 β-Ga2O3 缺乏有效的 p 型掺杂,通常采用 p 型氧化镍(NiO)与 n 型 Ga2O3 构建异质结(p-n HJD)。对于高压器件,其性能极限往往受限于器件边缘的电场集中效应,这会导致器件在远低于材料理论极限的电压下发生过早击穿。边缘终端技术是解决这一问题的关键。离子注入是一种在半导体中精确形成高阻区或掺杂区的标准平面工艺。通过在器件边缘注入特定离子,可以形成一个高阻的“虚拟保护环”,有效缓解电场集中。之前已有研究使用氮(N)、镁(Mg)、铁(Fe)等离子进行注入,但这些元素可能会在 Ga2O3 中引入电学活性,影响器件的长期稳定性。而惰性气体离子,注入后主要通过产生晶格位移损伤来形成深能级陷阱,从而实现高电阻率,且其化学性质稳定,是一种极具吸引力的选择。
主要内容
研究团队成功制备了垂直结构的 NiO/β-Ga2O3 p-n 异质结二极管(HJDs),其击穿电压(VBR)高达 3000 V,导通电阻(Ron, sp)仅为 3.12 mΩ·cm2,从而实现了巴利加优值(FOM)为 2.88 GW/cm2 的优异性能。具体而言,通过掺入轻质氦原子形成高效且低损伤的边缘终止(ET),抑制了 HJDs p-n 结处的强电场,从而将器件的 VBR 从 1330 V 提升至 3000 V。反向漏电流机制经过拟合与分析,揭示了氦掺杂器件中独特的击穿机制。模拟结果证实,氦离子注入的 ET 可有效抑制器件 p-n 结处的峰值电场。同时,氦离子注入后器件的 Ron, sp 值发生微小变化,而器件的低 Ron, sp 正向导通特性通过密度泛函理论(DFT)计算证实了异质结高效载流子传输。本研究可能为高功率、低损耗 β-Ga2O3 双极功率器件的设计与制备提供新思路。
创新点
● 首次将 He 离子注入技术成功应用于 β-Ga2O3 垂直功率二极管的边缘终端。
● 通过一种精确且与 CMOS 工艺高度兼容的平面注入技术,实现了器件击穿电压的大幅提升。
● 获得了高达 2.88 GW/cm2 的巴利加优值,展示了该终端技术在制造高性能 Ga2O3 功率器件方面的巨大潜力。
结 论
通过采用轻质氦原子进行植入作为高效且低损伤的电注入(ET)技术,有效抑制了器件 pn 结处的电场。研究团队制备了垂直 Ga2O3 HJD,其 VBR 高达 3000 V,Ron, sp 仅为 3.12 m·cm2,从而实现了 2.88 GW/cm2 的 FOM。这项研究为高功率、低损耗 β-Ga2O3 双极功率器件的设计与制造提供了宝贵的新思路。

图1. (a) 垂直 Ga2O3 HJD 的示意图,其中在块 β-Ga2O3 衬底上掺杂了氦离子,以及(b) 通过 SRIM 对 He 离子掺杂的模拟和建模。
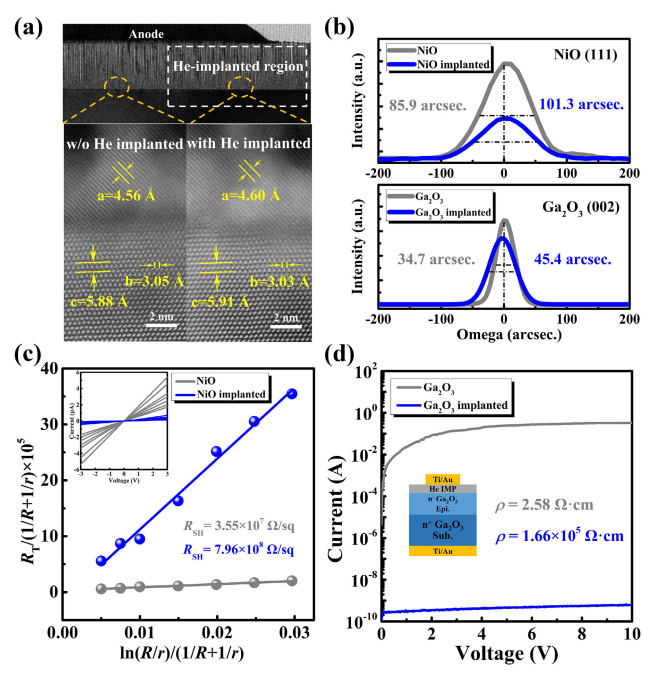
图2. (a) 氦离子注入区域与未注入区域的 HR-TEM 和 AC-TEM 截面图像,(b) 未注入和注入 NiO 及 β-Ga2O3 在 (111) 和 (002) 晶面上的 ω 扫描及半高宽值(FWHM), (c) NiO 和通过 CTLM 掺杂的 NiO 在不同间隙距离下的 I-V 特性及线性拟合图,以及 (d) 垂直 Ga2O3 和掺杂 Ga2O3 的电阻测量结果。
DOI:
doi.org/10.1109/TED.2025.3560277