

【国际论文】通过显微镜对β-Ga₂O₃进行微观尺度缺陷分析
日期:2025-07-08阅读:533
由美国国家标准与技术研究院的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Microscopic-scale defect analysis on β-Ga2O3 through microscopy(通过显微镜对 β-Ga2O3 进行微观尺度缺陷分析)的文章。
背 景
β 相氧化镓(β-Ga2O3)作为超宽禁带材料,其禁带宽度为 4.8 eV,相应的击穿电场约为 8 MV cm-1,巴利加优值约为 2870.7。由于可利用从熔体生长的大尺寸、高质量衬底,β-Ga2O3 在高功率应用中相比碳化硅和氮化镓技术具有潜在的成本优势。β-Ga2O3 的器件开发已开始迅速推进,但仍有若干材料问题需要解决。在碳化硅中,诸如微管、堆垛层错和加工损伤之类的致命缺陷对于商业器件而言至关重要,必须予以消除;而在氮化镓中,螺型位错和堆垛层错与器件的漏电流和可靠性有关。类似的问题也可能影响到 β-Ga2O3,通过边缘限定薄膜喂料生长法和垂直布里奇曼法生长的体衬底中已发现并分类了若干常见缺陷。在肖特基势垒二极管(SBD)中,纳米空洞缺陷经常被观察到,并且与漏电流相关,这可能是由于形成了螺型位错所致。在 β-Ga2O3 中还观察到了其他类型的位错,其中一些与肖特基势垒二极管(SBD)中的漏电流有关,不过通常很难确切识别出位错的具体类型。
主要内容
β-Ga2O3 作为超宽禁带半导体,因其独特的性能以及大尺寸高质量衬底的可得性,具有超越当前高功率器件性能和成本效益的潜力。然而,β-Ga2O3 功率电子器件仍相对不成熟,可靠高功率器件的商业化实现需要对限制性能的扩展缺陷有深入的了解。尽管在体衬底中已对若干缺陷进行了表征,但对于通过氢化物气相外延(HVPE)在(010)β-Ga2O3 上同质外延生长的缺陷关注较少,尽管其对于生产用于功率器件的高质量活性层至关重要。在这项工作中,利用光电子能谱、透射电子显微镜(TEM)以及互补的光谱和显微镜技术,对通过 HVPE 同质外延生长的(010)β-Ga2O3 的体电子特性和扩展结构缺陷进行了表征。观察到两种沿 [001] 晶轴排列的线性表面缺陷。一种缺陷由微米级颗粒和突出材料的尾部组成,另一种则是表面的凹槽。大颗粒是一种富镓相,可能在 HVPE 生长早期就已存在,会破坏表面,而沟槽缺陷则纯粹是结构性的。缺陷蚀刻和透射电子显微镜分析表明,线性缺陷与不同的位错结构有关,这可以解释在每个缺陷处测量到的不同局部电导率。结果表明,对于大面积功率器件而言,要获得高质量的外延生长,对体基板进行适当的表面处理仍然是必要的。
结 论
本研究识别并表征了 HVPE 生长的 (010) β-Ga2O3 外延层中沿 [001] 方向排列的两种主要线性缺陷:“彗星”缺陷和“线”缺陷。“彗星”缺陷由一个富镓颗粒和凸起的材料尾迹组成,而“线”缺陷是表面的凹槽。这两种缺陷分别与不同的亚表面位错结构(位错攀移和交滑移)相关联,并都会导致其所在区域的局部电导率降低。研究结果表明,“彗星”缺陷在 HVPE 生长的早期阶段就已形成,因此,为了获得更高质量的外延层,对衬底进行适当的表面处理和优化初始生长环境至关重要。

图1. 采用(b)He I 和(c)及(d)铝 Kα 激发对外延 β-Ga2O3 的二次电子截止能和价带边缘进行的 PES 测量。图 (b) 和 (c) 中的价带采用线性刻度,而图 (d) 和图 (b) 的插图采用半对数刻度。红色曲线为数据的线性拟合结果。
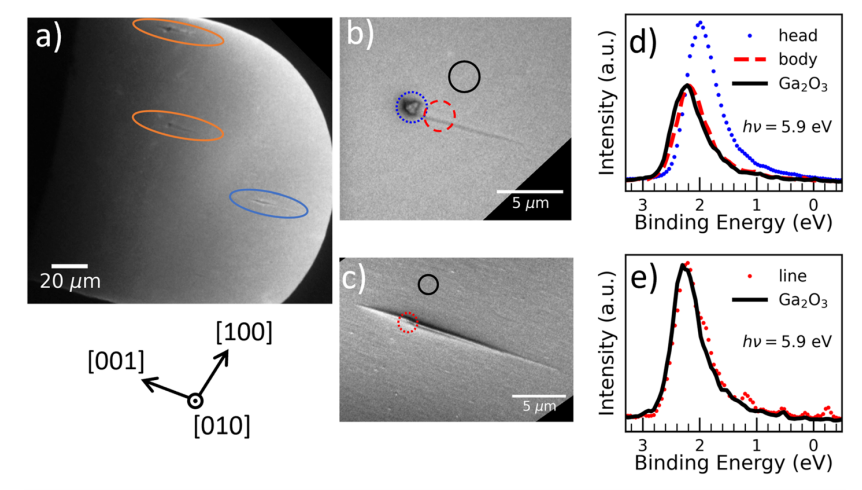
图2. PEEM观测结果:(a)彗星缺陷和线缺陷,分别用橙色和蓝色圈出,以及在更高倍放大下(b)彗星缺陷和(c)线缺陷的图像。来自(b)和(c)中实心和虚线圆圈标记区域的PEEM PES光谱,分别对应(d)彗星缺陷和(e)线缺陷。对于(d)和(e),使用 He I UPS 测量的功函数转换为近似结合能尺度。
DOI:
doi.org/10.1063/5.0272451