

【国际论文】>3kV NiO/Ga₂O₃ 异质结二极管,采用空间调制结端部延伸结构及亚1V导通电压
日期:2025-07-08阅读:562
由美国亚利桑那州立大学的研究团队在学术期刊 IEEE Journal of the Electron Devices Society 发布了一篇名为 >3kV NiO/Ga2O3 Heterojunction Diodes With Space-Modulated Junction Termination Extension and Sub-1V Turn-On(>3kV NiO/Ga2O3 异质结二极管,采用空间调制结端部延伸结构及亚1V导通电压)的文章。
背 景
过去十年间,β-Ga2O3 因其高临界电场(8 MV/cm)、易于 n 型掺杂以及大面积单晶衬底的可用性,已成为下一代电力电子器件的理想候选材料。高品质、低缺陷密度 β-Ga2O3 漂移层在体 β-Ga2O3 衬底上的生长,结合先进的无损蚀刻技术,正为高性能 Ga2O3 功率器件的开发铺平道路。特别是,双端垂直 β-Ga2O3 器件在过去几年中表现出显著的性能提升,其性能指标已超越 SiC 和 GaN 的单极性极限。大多数相关研究采用 p-NiO/Ga2O3 异质结,其展现出优异的击穿性能。然而,此类异质结的关键局限在于其较大的导通电压(VON)约为 2V。较高的 VON 会导致显著增大的导通损耗(~ION2 VF,其中VF=VON+ ION× Ron,sp),从而降低器件效率。因此,在保持低 VON 的同时实现高击穿电压,对于实现低损耗 β-Ga2O3 整流器至关重要。
主要内容
这项工作展示了高性能垂直镍氧化物/氧化镓异质结二极管(HJD),其采用了两步空间调制结终端扩展技术。与目前最先进的氧化镓 HJD 相比,实现了超过 3 kV 的击穿电压,同时具有 0.8 V 的低开启电压(VON),在 1 A−cm-2 的正向电流密度(IF)下估算得出。所测器件表现出出色的开启特性,在 1.5 V 的正向偏压下实现了 100 A−cm-2 的电流密度,同时具有 4.4 m Ω-cm2 的低差分特定导通电阻(Ron,sp)。通过使用宽度和间距不同的同心镍氧化物环来实现空间调制结终端扩展,其近似于逐渐减少的结终端扩展电荷。计算得出的单极优值(FOM)超过 2 GW-cm2,对于开启电压低于 1 V的器件而言,这属于最佳报告值之一。在击穿电压测试期间施加 3 kV 的反向偏压应力后,所制备的器件正向 I-V 特性几乎没有变化。
结 论
研究人员展示了采用空间调制结端部扩展(SM-JTE)技术的 p-NiO/Ga2O3 高结电容二极管(HJDs),实现了结端部电荷的逐步减少。同时,我们获得了优异的正向和反向性能,包括低正向电压(VON)0.8 V、反向电压(VBR)3 kV 以及低正向电阻(RON)4.4 mΩ·cm-2,从而实现了超过 2 GW·cm-2 的功率性能指标。本研究还报告了 NiO/Ga2O3 HJD 的有效 RON 创纪录低值为 14.5mΩ-cm-2。其在亚 1 V 开启电压下的高压反向阻断能力,彰显了 Ga2O3 HJD 在低损耗千伏级电力电子器件中的巨大潜力。
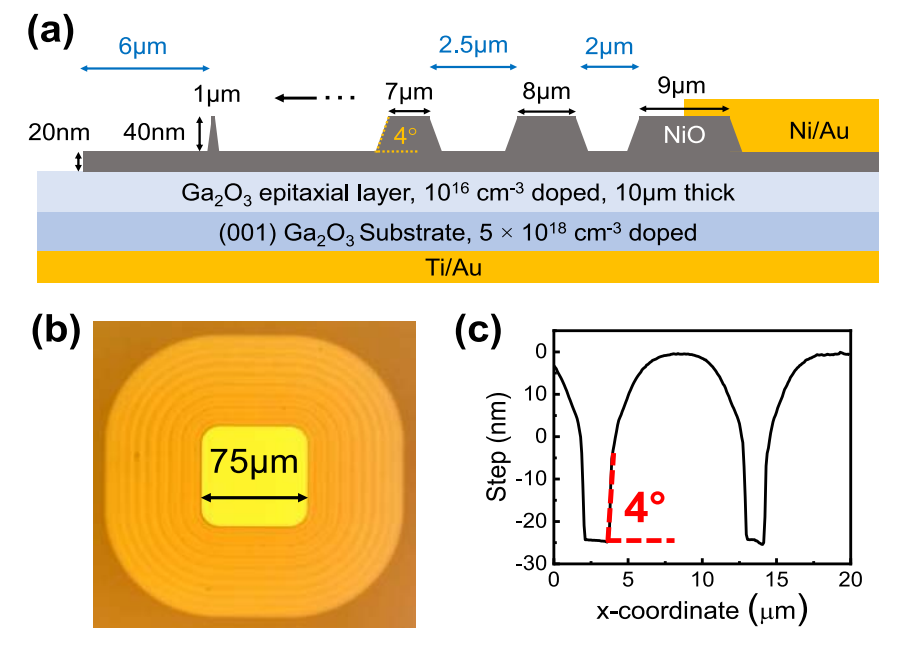
图1. (a) 制备的 p-NiO/Ga2O3 二极管的横截面示意图,采用SM-JTE终端结构。 (b) 制备的 75μm 活性区域器件的顶视光学图像。 (c) 通过 JTE 结构的 AFM 扫描,显示 NiO JTE 环的倾斜角度约为 4°。
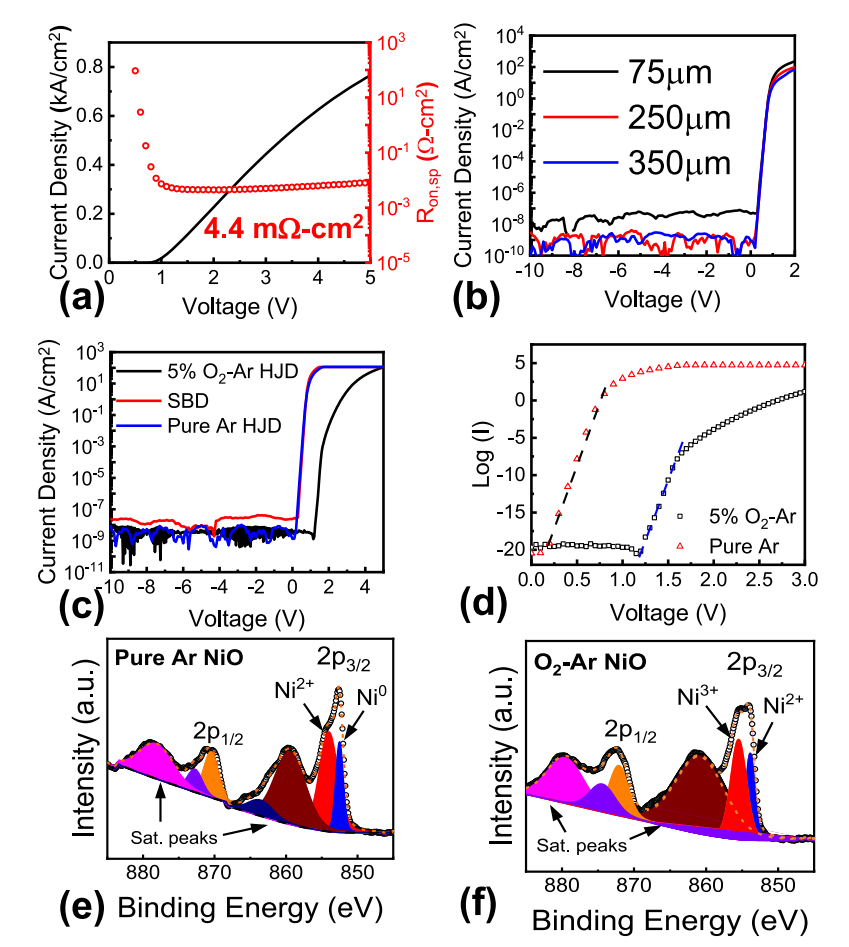
图2. (a) 75 μm 面积器件的正向 I-V 特性(线性坐标)及差分比导通电阻。 (b) 具有 3 种不同有效面积器件的正向 I-V 特性(半对数坐标)。(c) 半对数坐标系下 SBD、纯氩气溅射 NiO/Ga2O3 二极管及 5% 氧气-氩气溅射 NiO/Ga2O3 二极管的正向 I-V 特性曲线。 (d) 纯氩气及 5% 氧气-氩气溅射 NiO/Ga2O3 二极管的半对数 I-V 曲线中理想因子提取。Ni 2p 核心能级扫描结果,对应于(e)纯氩气氛围和(f)氧气-氩气氛围下溅射的 NiO。
DOI:
doi.org/10.1109/JEDS.2025.3562028