

【国际论文】高击穿电压垂直Ga₂O₃/4H-SiC肖特基整流器中氧空位及反向漏电抑制的研究
日期:2025-07-11阅读:602
由韩国光云大学的研究团队在本次 ISPSD 2025 学术会议上发表了一篇名为 Investigation of Oxygen Vacancies and Reverse Leakage Suppression in High-Breakdown Vertical Ga2O3/4H-SiC Schottky Rectifiers(高击穿电压垂直 Ga2O3/4H-SiC 肖特基整流器中氧空位及反向漏电抑制的研究)的文章。
背 景
β相氧化镓(β-Ga2O3)是制造下一代高压功率器件的理想材料,但其固有的低热导率是其走向实际应用的主要难题,会导致严重的自热效应。将 Ga2O3 薄膜与高热导率的碳化硅(4H-SiC)衬底集成,是解决 Ga2O3 器件散热问题的有效途径。垂直结构的肖特基整流器是功率电子系统中的基本元件。在 Ga2O3 材料中,本征缺陷,特别是氧空位,对器件性能有显著影响。氧空位不仅可能作为浅施主增加背景载流子浓度,还可能形成深能级陷阱,介导漏电过程,从而增加器件的反向漏电流,降低其阻断能力和可靠性。因此,深入研究和有效抑制 Ga2O3/4H-SiC 异质结构器件中的氧空位及其负面影响,对于实现高性能、高可靠性的功率器件至关重要。
主要内容
本研究探讨了氧空位(VO)对 Ga2O3/SiC 肖特基势垒二极管(SBD)反向漏电流特性及击穿电压(BV)的影响。通过深能级瞬态光谱(DLTS)及反向漏电流分析证实,氧空位是关键限制因素,显著降低了 Ga2O3 基功率器件的阻断能力并增大了漏电流。为缓解这些不利影响,实施了高温氧退火(900℃),有效抑制了氧空位的形成。结果,在高电压条件下,主导的漏电流机制从肖特基发射(SE)转变为变程跃迁(VRH),从而实现了制备击穿电压超过 3000 V 的高性能 Ga2O3/SiC SBDs。本研究不仅为缺陷工程策略提供了宝贵见解,还为优化超宽带隙(UWBG)功率器件奠定了坚实基础,为下一代高效率功率开关应用铺平了道路。
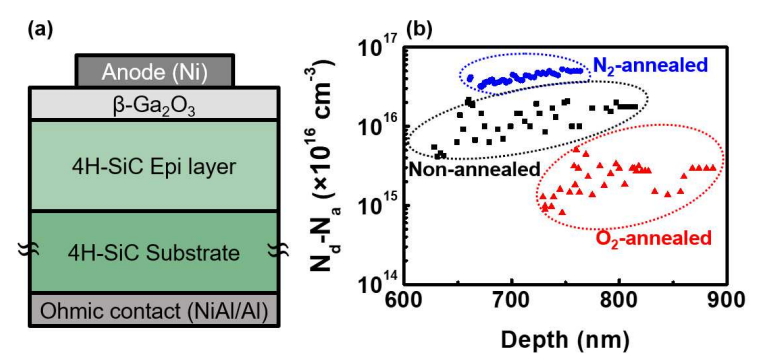
图1. (a) Ga2O3/SiC 结型二极管的示意性横截面图。 (b) 通过电容-电压法计算的载流子浓度与耗尽层宽度关系曲线,适用于未退火、N2 退火和 O2 退火样品。
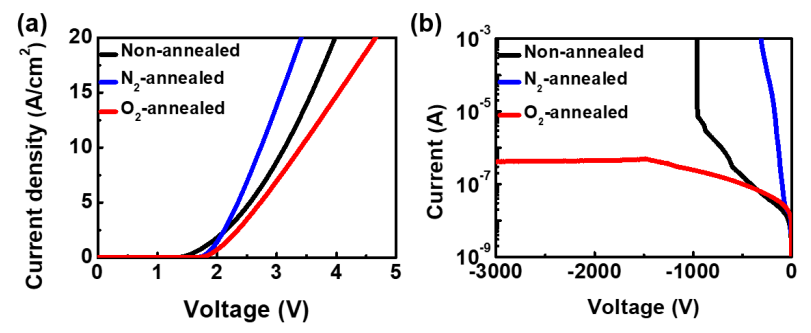
图2. (a) 未退火、N2 退火和 O2 退火的 Ga2O3/SiC 结型二极管(SBD)的正向电压-电流特性曲线(线性刻度)。(b) 三种类型 SBD 的反向击穿电压(BV)。