

【国际论文】通过真空退火实现β-Ga₂O₃ multi-fin沟槽肖特基势垒二极管的电荷回收
日期:2025-07-11阅读:547
由美国俄亥俄州立大学的研究团队在学术期刊 APL Electronic Devices 发布了一篇名为 Charge recovery by vacuum annealing in β-Ga2O3 multi-fin trench Schottky barrier diodes(通过真空退火实现 β-Ga2O3 multi-fin 沟槽肖特基势垒二极管的电荷回收)的文章,该篇文章被期刊评为编辑推荐(Editor’s Pick)。
背景
β-Ga2O3 作为超宽带隙半导体材料,其带隙为 4.8 eV,理论击穿电场强度为 8 MV/cm。这使得 Ga2O3 与 Si、SiC 和 GaN 相比具有更高的巴利加优值(BFOM),使其在高功率电子学领域具有吸引力。熔融生长的大尺寸衬底的可用性使 β-Ga2O3 技术具有高度可扩展性和可靠性,并在与 SiC 和 GaN 的竞争中占据优势。目前,β-Ga2O3 面临的挑战是缺乏高效的 P 型掺杂技术。因此,若采用传统平面垂直器件架构,实现接近理论极限的器件较为困难。在此背景下,沟槽架构具有显著优势,因其能提供工程灵活性和设计空间,从而实现接近理论极限的器件。正因如此,沟槽肖特基势垒二极管(SBD)因其更强的耐高电场能力而被广泛研究。然而,这同时也带来另一个难题:沟槽 SBD 通常采用感应耦合等离子体反应离子刻蚀(ICP-RIE)工艺制备,该工艺通常采用氯基化学试剂,会在刻蚀结构中引发电荷补偿。我们在先前研究中观察到这种电荷补偿及其导致的导通电阻增大效应。此外,研究人员发现与 (100) 晶面相比,(010) 晶面特别容易受到 BCl3/Cl2 基干法刻蚀的损伤。
主要内容
在本研究中,研究人员展示了在(001) β-Ga2O3 垂直结构中经过反应离子刻蚀后的电荷恢复现象。该电荷恢复是通过在超高真空条件下对刻蚀后的结构进行退火处理实现的。采用相同的技术,进一步展示了沿 [100] 和 [010] 方向排列的多指槽沟肖特基势垒二极管,其导通电阻与之相当。沟槽肖特基势垒二极管展现出高达 1.85 kV 的击穿电压,以及超过 3.2 MV/cm 的穿透击穿电场。
结论
通过退火处理在 ICP-RIE 刻蚀的 β-Ga2O3 垂直结构中实现了电荷回收,并制备了具有 1.85 kV 硬击穿电压和对应的 3.2 MV/cm 击穿电场的 kV 级 multi-fin β-Ga2O3 沟槽 SBD。通过在超高真空环境下对刻蚀的 fin 结构进行退火处理,在 [100] 和 [010] 取向的 fin 中均实现了相当的正向导通性能。该方法可进一步应用于制备大面积 multi-fin 器件,并可用于开发不受取向依赖性导通电阻变化影响的 β-Ga2O3 沟槽型 MOSFET。
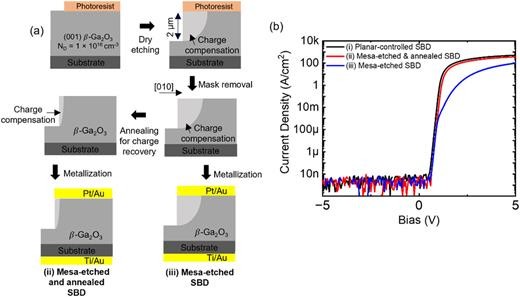
图1. (a) 用于电荷回收实验的台面蚀刻 SBD 器件制备流程示意图。 (b) 平面控制型 SBD、台面蚀刻 SBD 以及台面蚀刻并退火处理的 SBD 的电流-电压(J-V)特性曲线对比。
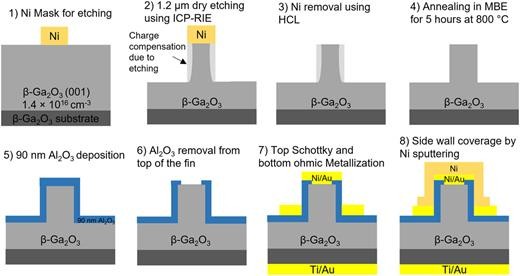
图2. 采用反应离子刻蚀(RIE)和超高真空退火的多沟槽 SBD 工艺流程。
DOI:
doi.org/10.1063/5.0270286