

【国内论文】中山大学卢星教授团队:基于4H-SiC衬底外延生长的ε-Ga₂O₃薄膜的高次谐波体声波谐振器及梳状滤波器
日期:2025-08-28阅读:545
由中山大学卢星教授的研究团队在学术期刊 IEEE Transactions on Ultrasonics, Ferroelectrics, and Frequency Control 发布了一篇名为 High-overtone Bulk Acoustic Resonators and Comb Filters using Epitaxial ε-Ga2O3 Films on 4H-SiC(基于 4H-SiC 衬底外延生长的 ε-Ga2O3 薄膜的高次谐波体声波谐振器及梳状滤波器)的文章。
项目支持
本研究部分由国家重点研发计划(项目编号:2024YFE0205300)和国家自然科学基金(项目编号:62471504)资助。
背 景
高次谐波体声波谐振器(HBAR)是一种能够在极高频下工作并具有高品质因数的射频器件,在现代无线通信、频率控制和传感等领域具有重要应用价值。HBAR 的性能在很大程度上取决于其材料体系,它通常由一个压电薄膜换能器和一个高质量、低声学损耗的衬底构成。在氧化镓的多种晶相中,亚稳态的 ε-Ga2O3 理论上具有很强的压电特性,是制造声学器件的潜力材料,但其压电性尚未得到充分的实验验证。碳化硅(4H-SiC)是一种声学品质极高的衬底材料,其声学损耗非常低,能够让声波在其内部以最小的衰减进行谐振。因此,将新型压电材料 ε-Ga2O3 与高质量声学衬底 4H-SiC 相结合,有望开发出性能优异的新一代高频声学器件。
主要内容
本研究展示了一种新型高倍频体声波谐振器(HBAR),仅采用顶部电极,并利用生长在导电 4H-SiC 衬底上的外延 ɛ-Ga2O3 压电薄膜制成。该器件展现出宽广的频率响应范围,覆盖 1 GHz 至 8 GHz,相邻模式之间的自由光谱范围(FSR)为 18.6 MHz。关键性能指标包括在 70 K 时 f·Q 积超过 1.2×1014 Hz,在 300 K 时超过 1.5×1013 Hz,以及出色的温度稳定性,表现为频率温度系数(TCF)为 −15.46 ppm/°C。提取了 ε-Ga2O3 的声学参数,包括密度为 5001.7 kg/m3、弹性模量 CD33 为 2.82×1011 N/m2、纵向声波速度为 7596 m/s 以及固有电声耦合系数 k2t 为 7.9%。对理论 f·Q 极限和声学阻抗不匹配的评估表明,进一步提升性能具有巨大潜力。此外,通过横向耦合两个 ɛ-Ga2O3 HBAR,成功演示了梳状滤波器,在超过 5 GHz 的带宽内实现了超过 275 个等间距通带。这些结果凸显了基于 ɛ-Ga2O3 的 HBAR 在先进射频应用中的巨大潜力。凭借其优异的压电和电子特性,ɛ-Ga2O3 可实现声学器件与片上电子设备的单片集成,为紧凑型、高性能射频系统铺平了道路。
结 论
作为新一代宽禁带半导体,ɛ-Ga2O3 凭借其优异的功率电子学和压电性能,以及与现代微电子制造工艺的兼容性,展现出卓越的单片集成潜力。在本研究中,研究团队提出了并制备了基于导电 SiC 衬底上的外延 ɛ-Ga2O3 薄膜的新型 HBARs。提取了 ɛ-Ga2O3 的关键声学参数。理论 f·Q 极限和声学阻抗匹配分析表明仍有进一步优化的空间。此外,通过两个 ɛ-Ga2O3 HBAR 的侧向耦合实现了梳状滤波器,在 5 GHz 频带内获得超过 275 个通带。这些结果表明,异质外延 ɛ-Ga2O3 压电薄膜在高性能射频声学器件领域具有巨大潜力。此外,与 ɛ-Ga2O3 基电子器件(如MOSFET和HEMT)的单片集成潜力,为开发紧凑型高性能射频系统开辟了新途径。
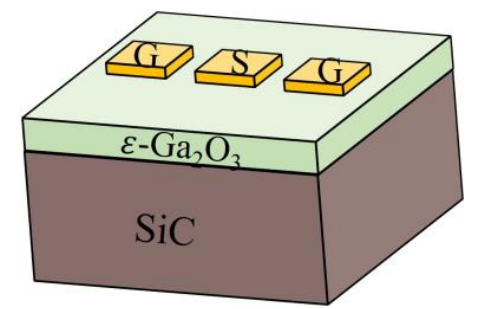
图1. 仅具有顶部电极的HBAR示意图,采用外延 ɛ-Ga2O3-on-SiC 结构制备。

图2. (a) 对应样品的 2θ/ω 扫描图。 (b) ɛ-Ga2O3 (004) 面的摇摆曲线和 (c) ɛ-Ga2O3 (203) 面的摇摆曲线。
DOI:
doi.org/10.1109/TUFFC.2025.3594846