

【国际论文】通过溅射超高κ值BaTiO₃介质场调控实现近乎理想的垂直β-Ga₂O₃肖特基二极管反向漏电流
日期:2025-09-01阅读:510
由美国空军研究实验室的研究团队在学术期刊 APL Electronic Devices 发布了一篇名为 Near-ideal vertical β-Ga2O3 Schottky diode reverse leakage current via sputtered ultra-high-κ BaTiO3 dielectric field-management(通过溅射超高 κ 值 BaTiO3 介质场调控实现近乎理想的垂直 β-Ga2O3 肖特基二极管反向漏电流)的文章。
背 景
垂直 β-Ga2O3 二极管因其 4.8 eV 的宽带隙和预期 8 MV/cm 的临界场强,在功率应用领域具有可扩展性和效率优势。巴利加优值(BFOM)预测单极功率器件有望超越硅、碳化硅和氮化镓功率器件的性能。在高品质熔融生长衬底上实现同质外延生长,相较其他技术还可能带来潜在成本优势。近期器件研究加速推进,旨在实现性能指标所揭示的潜在效率优势。肖特基势垒二极管(SBD)因其优于 p-n 二极管的反向恢复时间,在功率开关应用中备受关注。β-Ga2O3 SBD 已在多种衬底上通过多种生长方法实现,包括卤化物气相外延(HVPE)和金属有机化学气相沉积(MOCVD)。未采用场效应管理的 SBD 因阳极边缘场效应拥挤而受限,导致局部漏电流增大并引发早期击穿。然而,由于 β-Ga2O3 缺乏浅层 p 型掺杂剂,传统基于 pn 同质结的功率器件场效应管理策略对其不可行。作为替代方案,采用 p-Si 与 p-NiO 构建的 p-n 异质结,当作为 p-n 二极管或结端部延伸结构时,已被证实能有效降低漏电流并提升击穿电压。但为避免受窄带隙材料的场效应限制,同时规避 p 型材料的开关损耗,采用单极性边缘终止结构具有显著优势。
主要内容
本文报道了采用射频溅射沉积的超高介电常数 BaTiO3 薄膜,用于垂直 β-Ga2O3 肖特基势垒二极管的场管理。通过比较不同氧化层厚度场沉积器件的反向漏电流与理论一维反向漏电流(包含带图像力降低效应的热电子发射及隧道电流),验证了该技术可行性。实验发现:当 BaTiO3 场氧化层较薄时,漏电流与理论值近乎吻合;随着 BaTiO3 厚度增加,因阳极边缘场强聚集效应增强,漏电流与模型预测值出现轻微偏差。通过 Silvaco Victory Device TCAD 模型验证了 BaTiO3 层厚度增加对阳极边缘场强增强的影响。此外,在 150℃ 器件工作温度下,实测反向特性与理论漏电流存在显著偏差,推测源于 BaTiO3 与 β-Ga2O3 间 80meV 带隙偏移导致的热激发电子发射。最终验证了在 BaTiO3 层间引入 Al2O3 可有效抑制热诱导漏电流。通过抑制热电子发射,在 150℃ 条件下测得漏电流与理论值的契合度显著提升。这些结果证实了高介电常数介质场管理层在垂直 β-Ga2O3 器件中的有效性,鉴于 β-Ga2O3 缺乏浅层 p 型掺杂剂,该特性至关重要。这为实现 β-Ga2O3 功率器件的潜力开辟了新路径。
总 结
通过采用超高介电常数溅射 BaTiO3 作为场板氧化物,在垂直 β-Ga2O3 肖特基势垒二极管中实现了近乎理想的反向漏电流特性。通过确定高场下图像力降低效应下的理论总热电子发射量与隧道电流,计算出的理论一维反向漏电流与实测反向漏电流特性高度吻合。采用 40 nm 薄 BaTiO3 场管理层时,实验结果与理论近乎完美吻合。但当 BaTiO3 层增厚至 110 nm 和 320 nm 时,测量得到的 J-F 特性曲线与模型预测的漏电流出现轻微偏差,Silvaco Victory Device TCAD 模拟显示,由于器件阳极边缘区域的场强拥挤效应所致。此外,展示了平均表面场强达 4.1 MV/cm 的 MOSCAP 器件。实验表明,在 150℃ 条件下,由于 BaTiO3 与 Ga2O3 之间微小能带偏移导致的热激发电子发射效应,器件行为与泄漏模型存在显著偏差。本研究同时验证了通过引入宽带隙介质中间层可有效缓解该现象。这为垂直 Ga2O3 器件的介质场管理开辟了新路径,对于在缺乏传统浅 p 型掺杂剂场管理技术的情况下实现 β-Ga2O3 的理论性能至关重要。
图文示例
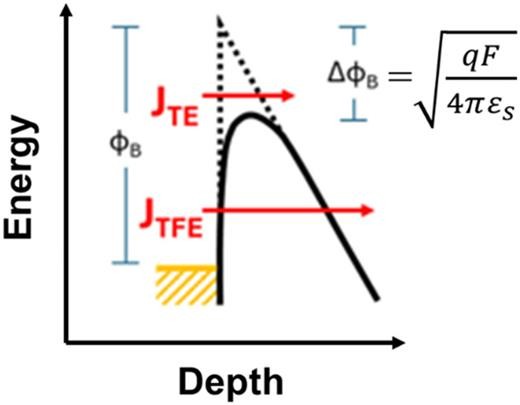
图1. 高电场下SBD的能带图,显示了电流分量JTE和JTFE。在低电场下,由于势垒足够宽导致隧道概率约为0,漏电流主要由热电子发射(JTE)主导。随着电场增强,隧道概率变得不可忽略,总漏电流变为JTE + JTFE。

图2. (a) 器件横截面示意图,展示样品 1–3 中同步制造的 SBD、FPSBD 和 MOSCAP 结构,其中 BaTiO3 厚度分别为 40、110 和 320 nm。(b) 右 y 轴显示 1/C2 随电压变化曲线,呈现从 −1 V 到 0 V 的线性行为(该区域提取了掺杂浓度),并给出各样品的C–V曲线。(c) 每种样品在 200 至 400 nm 耗尽层深度范围内提取的 ND–NA 与深度关系曲线。(d) 每种样品的正向 J–V 曲线,其势垒高度在log(JA)曲线的线性区域内从 0.6 至 1 V 间提取。

图3. (a) 样品 1 的反向 J-F 曲线与电场关系图(BaTiO3 厚度为 40 nm),显示与 SBD 相比 FPSBD 显著改善,且 FPSBD 与一维模型预测的反向漏电流基本吻合。(b) 样品 2 的反向 J-F 曲线与电场关系图(BaTiO3 厚度 110 nm),显示 FPSBD 较 SBD 显著提升,且因阳极边缘峰值电场导致FPSBD与一维模型电流存在轻微偏差。(c) 样品 3(BaTiO3 厚度 320 nm)的反向 J-F 曲线与电场关系图,显示 FPSBD 较 SBD 显著提升,但因阳极边缘存在峰值电场,FPSBD 与一维模型电流存在轻微偏差。(d) 各样品 MOSCAP 的反向 J-F 测量结果,表明 320 nm BaTiO3 层因半导体区域电场减弱,使表面电场获得显著改善。
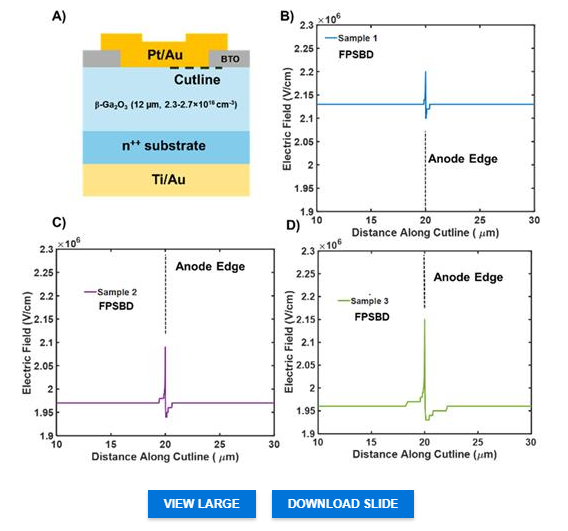
图4. (a) FPSBD 器件横截面示意图,标注了收集电场与距离关系的切割线位置。(b) 样品 1 沿指示切割线的电场与距离关系,显示器件阳极边缘附近存在微小电场峰值。(c) 样品 2 的电场随距离变化曲线,显示阳极边缘附近电场峰值显著增强。(d) 样品 3 的电场随距离变化曲线,显示阳极边缘附近电场峰值增幅最大,该现象导致偏离一维反向漏电模型。
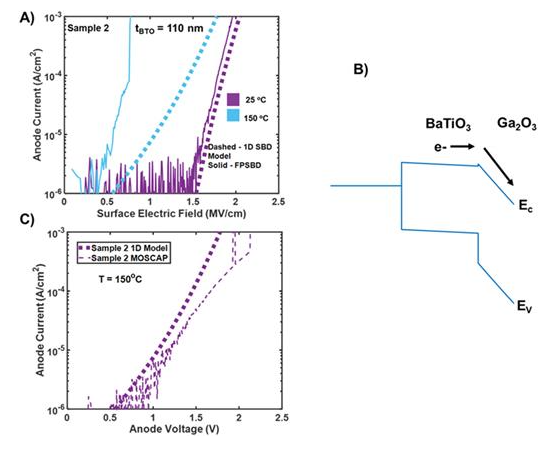
图5. (a) 样品 2 在 25℃ 和 150℃ 下 FPSBD 的反向 J-F 曲线(实线)及其对应的一维模型泄漏电流(虚线),显示150℃时与模型泄漏电流存在显著偏差。(b) 能带图揭示 150℃ 漏电流增大的机理,归因于热激发电子跨越 BaTiO3 与 β-Ga2O3 间 80 meV 能垒的发射过程。(c) 样品 2 在 150℃ 下 MOSCAP 的反向 J-F 曲线,对应的 SBD 漏电流模型显示 BaTiO3 层存在显著漏电流。
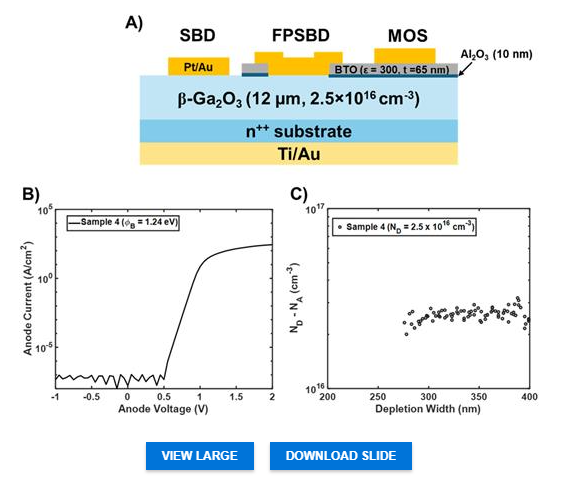
图6. (a) 包含 10 nm ALD Al2O3 介质层的样品器件截面示意图,该介质层嵌入场管理介质堆栈中。(b) 样品 4 的正向 J-V 特性曲线,其氧化铝介质层的势垒高度在对数坐标系的线性区域内测得为 1.24 eV(0.6 ~ 1 V 区间)。(c) 样品 4 的掺杂浓度与深度关系曲线,基于 1/C2 曲线中耗尽层深度为 200 ~ 400 nm 线性区域数据提取,浓度值为2.5 × 1016 cm−3。

图7. (a) 样品 4 在 25℃(黑色)和 150℃(蓝色)下 Al2O3 介质层的反向 J-F 曲线,对应的 1-D 模型反向漏电流(虚线)显示 150℃ 时吻合度提升。(b) 垂直介质结构能带图,显示氧化铝层增强的势垒阻挡热激发电子发射,从而抑制漏电流增长。(c) 样品 4 中 MOSCAP 器件在 25℃(黑色)与 150℃(灰色)下的反向 J-F 曲线测量,表明 150℃ 时漏电流无显著增加。(d) 沿指示剖面线测得的电场分布曲线,显示器件阳极边缘处电场峰值增大,该现象既是漏电流的成因,也解释了室温下偏离一维漏电流模型的现象。
DOI:
doi.org/10.1063/5.0283825