

【国内论文】福州大学李悌涛、张海忠团队联合上海光机所齐红基研究员:β相氧化镓在MOCVD同质外延生长的原位氮掺杂:理论与实验研究
日期:2025-09-04阅读:504
由福州大学李悌涛、张海忠团队联合上海光机所齐红基研究员的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 In situ nitrogen doping of β-Ga2O3 during MOCVD homoepitaxy: A theoretical and experimental study(β-Ga2O3 在 MOCVD 同质外延生长过程中的原位氮掺杂:理论与实验研究)的文章。
项目支持
本研究得到国家自然科学基金(Grant No. 62204270)、福建省重大科技专项(Grant No. 2022HZ027006)、 福建省自然科学基金普通项目(Grant No. 2024J01251)、福建省科技计划项目(Grant No. 2022I0006)以及泉州市重大科技专项(Grant No. 2022GZ7)资助。作者特别感谢杭州富加镓业科技有限公司在 Ga2O3 外延薄膜生长方面提供的协助。
背景
对于β-氧化镓(β-Ga2O3)功率器件,精确控制外延层中的受主掺杂浓度至关重要,这直接影响着电流阻挡层、p型外延层和漂移层等关键结构的性能。在金属有机化学气相沉积(MOCVD)生长 β-Ga2O3 的过程中,一氧化二氮(N2O)是一种常用的氧源,能有效抑制预反应。然而,N2O 分解产生的氮(N)会作为一种非故意的受主杂质进入到 Ga2O3 薄膜中,与材料中固有的施主杂质(如Si, H)产生显著的自补偿效应,从而根本性地改变薄膜的电学特性。氮被认为可能是 β-Ga2O3 很好的一种 p 型掺杂剂,因为它与氧的离子半径相近,不易破坏晶格,且能形成轨道耦合促进离域化,有利于提升空穴迁移率。尽管氮掺杂如此重要,但对于 MOCVD 生长过程中这种原位氮掺杂的物理机制和精确控制策略,目前还缺乏系统性的研究。
主要内容
精确控制外延层受主掺杂浓度对制备关键β-Ga2O3 基功率电子器件至关重要,包括电流阻断层、p 型外延层及漂移层。β-Ga2O3 金属有机化学气相沉积生长过程中,N2O(常见氧前驱体)引入的非故意掺杂氮(N)补偿掺杂剂显著影响其电学特性。本研究表明,外延层中的氮浓度主要由生长温度和表面吸附效果共同决定。随着外延温度升高,外延层中的氮掺杂浓度降低。当外延温度超过 1000℃ 时,氮在 β-Ga2O3 表面的吸附效率同时受外延参数和衬底取向的影响。通过调整外延参数(特别是提高反应室压力)可增强 β-Ga2O3 外延层的氮浓度。相较于 (001) 晶面外延层,(100) 晶面表现出更强的氮吸附能力;但 (001) 晶面外延层通过参数调节能实现更精确的氮浓度调控。第一性原理计算表明,吸附效果差异可能源于各晶面特有的吸附能差异,以及表面反应中氮(N)与氧(O)原子间的竞争性相互作用。本研究为推进 β-Ga2O3 同质外延层在电力电子领域的工程应用提供了基础性认识。
总结
通过金属有机化学气相沉积法结合第一性原理计算,阐述了在 (100) 面和 (001) 面上生长的 β-Ga2O3 同质外延层中取向依赖的氮掺杂行为。关键发现表明,在 1000℃ 以上,氮掺杂效率主要受外延温度、表面吸附动力学和晶体取向共同调控。基于建模指导,研究人员建立了考虑外延环境效应的氮氧竞争吸附框架。观测到的平面依赖性掺杂异质性源于化学势与吸附能各向异性的相互作用:氮在 (100) 面具有更强的吸附稳定性,使高温下掺入量更高;而 (001) 面较弱的吸附特性则增强了对腔室压力等参数的敏感性。本研究提供了:(1) 基于晶体取向的掺杂调控机制;(2) 竞争吸附的实验-理论模型;(3) 用于各向异性半导体精密掺杂的压力调制策略。
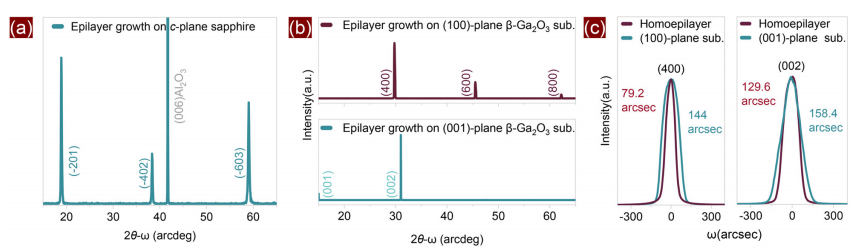
图1. (a) β-Ga2O3 异质外延层的 XRD 2θ-ω 扫描图。(b) β-Ga2O3 同质外延层的 XRD 2θ-ω 扫描图。(c) β-Ga2O3 (100)面和(001)面的同质外延层与衬底的 XRC 图。

图2. (a) (100) 面与 (d) (001) 面同质外延层的原子力显微镜图像,扫描区域为 5×5 μm2。其表面均方根粗糙度分别为 0.283 nm 和 4.82 nm。插图展示了表面轮廓曲线。(b) (100) 面与 (e) (001) 面形态同质外延层在 (710) 和 (-204) 反射面附近的 RSM 结果,采用非对称几何结构测量。(c) (100) 面与 (f) (001) 面同质外延层的高分辨率透射电子显微镜图像。(c) (200) 面与(110)面的层间距分别为 d(200) = 5.93 Å 和 d(110) = 2.91 Å。(f) (001) 晶面同质外延层的高分辨率透射电子显微镜图像。(001)和(1-10)晶面间距分别为d(001) = 5.81 Å与d(1-10) = 2.91 Å。

图3. (a) 以生长温度为单一变量时多层结构样品的示意图。(b) 多层结构样品的 SIMS 结果。(c) 以腔室压力为单一变量的样品表面电阻测试结果。插图展示表面电阻测量方法示意图,其中样品满足van der Pauw测量要求。外延样品电极采用磁控溅射制备的 Ti/Au(30/100 nm)结构。(d1)–(d5) 分别是腔体压力在 75、100、125、150 和 175 mbar 压力下,于 1000℃ 生长(001)晶面同质外延层的原子力显微镜图像(5×5 μm2)。

图4. (a) (c) N 在β-Ga2O3 (100)、(010) 和 (001) 晶面上的吸附模型。 (d)–(f) 氧在β-Ga2O3 (100)、(010) 和 (001) 晶面上的吸附模型。
DOI:
doi.org/10.1063/5.0288080









