

【国际论文】具有 2 kV和 600 GHz工作性能的新型氮化铝/β-氧化镓高电子迁移率晶体管
日期:2025-09-04阅读:514
由美国得克萨斯理工大学的研究团队在学术期刊 Microsystem Technologies 发布了一篇名为 A novel AlN/β-Ga2O3 high electron mobility transistor with 2 kV and 600 GHz operation(具有 2 kV 和 600 GHz 工作性能的新型氮化铝/β-氧化镓高电子迁移率晶体管)的文章。
主要内容
本研究利用 AlN 和 Ga2O3 的材料特性开发出一种高性能 AlN/Ga2O3 异质结构半导体器件,以满足当今大功率和射频/微波电子应用的需求。AlN 是一种高度极化的超宽带隙半导体,其带隙为 6.2 eV,具有优异的热导率。相反,带隙为 4.9 eV 的 β-Ga2O3 被公认为是一种稳定的超宽带隙半导体,特别适合电力电子应用。然而,它面临着热导率低、难以实现 p 型掺杂以及体缺陷密度高等限制。然而,通过在 β-Ga2O3 上生长 AlN 薄外延层,可以结合 AlN 的潜在优势和 β-Ga2O3 的挑战,以实现高性能电力电子器件。 AlN/β-Ga2O3 异质界面处较高的二维电子气密度(1.395 × 1014 cm−2 )以及高达 2 kV 的直流和射频特性,展现了该器件的高电压和高功率处理能力,而 600 GHz 的截止频率使其非常适合射频/微波应用。与以往仅报告孤立性能指标的研究不同,本研究对势垒厚度调节(10-100 nm)进行了全面分析,并将其与直流、射频和二维电子气特性关联起来。这为 AlN/β-Ga2O3 HEMT 设计的优化策略提供了更深入的见解,是对现有知识体系的全新贡献。
总 结
在 AlN/β-Ga2O3 异质界面处自洽求解一维薛定谔方程和泊松方程,得到本征能量,表明异质界面处形成了 2DEG。所提出的 AlN/β-Ga2O3 HEMT 在异质界面处可产生 1.395 × 1014 cm-2 的高 2DEG 密度和 4 MV/cm 的高电场。从直流特性得出结论,随着 AlN 厚度从 10 变为 100 nm,阈值电压分别从 ~ 0 V 负增加到 − 55 V;峰值跨导分别从 260 变为 90 S。然而,亚阈值斜率从 1250 增加到 2500 mV/dec,这表明可能存在强短沟道效应、陷阱辅助传导或界面质量问题。 AlN 厚度为 100 nm 的异质结构器件在 2 kV 电源电压、3 V栅极电压下传导近乎恒定的 16 A 电流,展现出其在超高压和大功率电子器件中的潜在应用。通过频率分析,由所提出的 AlN 厚度为 100 nm 的 AlN/β-Ga2O3 HEMT 获得了 600 GHz的截止频率(ft) ,最大振荡频率(fmax)超过1 THz,展现出其在射频/微波应用方面的潜在能力。

图1 AlN/β-Ga2O3 HEMT的3D结构
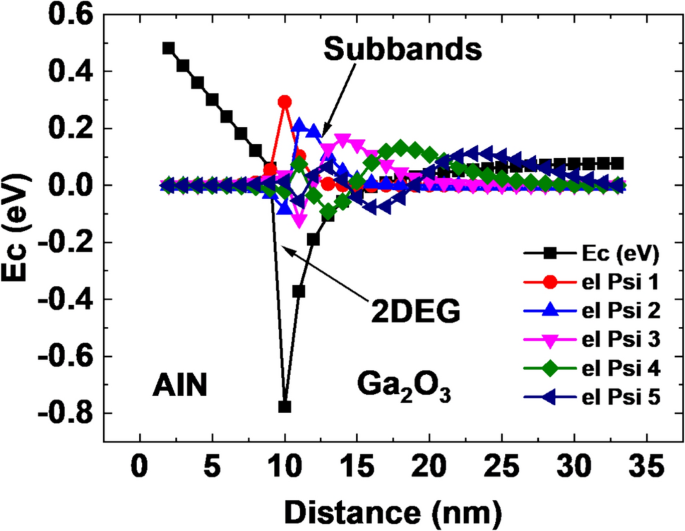
图2 AlN/β-Ga2O3 异质界面 2DEG 的形成及本征能量(子带)
DOI:
doi.org/10.1007/s00542-025-05927-9