

【国内论文】中国科学技术大学龙世兵教授团队:协同抑制体区与边缘漏电流的低导通电压β-Ga₂O₃肖特基二极管
日期:2025-09-19阅读:448
由中国科学技术大学龙世兵教授的研究团队在学术期刊 IEEE Electron Device Letters 发布了一篇名为 Low Von β-Ga2O3 Schottky Diodes With Synergistic Suppression of Bulk and Perimeter Leakage(协同抑制体区与边缘漏电流的低导通电压 β-Ga2O3 肖特基二极管)的文章。
项目支持
本工作得到以下项目资助:国家重点研发计划(项目编号:2024YFE0205200)、江苏省重大科技专项(项目编号:BG2024030)、国家自然科学基金(项目编号:U23A20358、62234007、62474170 和 61925110)、湖南省长沙市揭榜挂帅重点项目(项目编号:kq2301006)。作者还感谢中国科学技术大学微纳研究与制造中心(USTC)的支持。
背 景
功率半导体器件正在向高效率、低能耗和小型化方向演进,这推动了宽禁带材料的快速发展。β-Ga2O3 作为新一代高功率电子器件的候选材料,因其具有更宽的带隙(4.5–4.9 eV),相较于 SiC 和 GaN 拥有更高的 Baliga 优值,能够在单极型功率器件中实现更低的功耗。同时,其低成本熔融生长技术与高质量外延方法为器件的大规模商业化提供了可能。近年来,基于 β-Ga2O3 的功率二极管得到了迅速发展,其中高效肖特基势垒二极管(SBD)的核心挑战在于如何兼顾低导通损耗和低关断损耗。前者可通过减薄外延层和衬底、引入 TiO2 中间层或采用低功函数金属电极来降低导通电压 (Von);而后者则受限于边缘电场集中引起的边缘漏电流以及低势垒阳极带来的体区漏电流,两者都会显著恶化器件性能。针对这些问题,已有研究提出了场板、结终止延伸、高电阻终止及台面结构等边缘电场管理措施,以及基于高势垒金属或 RESURF 技术的体区漏电调控方案,但高势垒与低 Von 的需求存在内在矛盾。为此,受到 RESURF 概念的启发,研究者提出采用双势垒设计,通过高、低肖特基势垒的协同作用,在反向偏置下由高势垒区域屏蔽低势垒区域以抑制体区漏电,而在正向偏置下则由低势垒区域优先导通,从而实现导通与关断特性的平衡。在此思路下,本工作提出并验证了沟槽肖特基势垒控制的肖特基二极管(TSBSD),利用 PtOx 与 W 分别形成高、低势垒区域,并结合复合台面与结终止延伸(MJTE)结构,有效抑制了边缘与体区漏电,器件实现了低导通电压(0.71 V)与高击穿电压(1466 V)的优异性能。
主要内容
本工作首次提出了低导通电压(Von)且阻断性能显著增强的 β-Ga2O3 沟槽肖特基二极管。在沟槽区域,由 PtOx 与 β-Ga2O3 形成的高肖特基势垒可以钳制并屏蔽具有低势垒的钨(W)接触区域,从而有效抑制反向体区漏电。此外,采用复合台面与结延伸(Composite Mesa and Junction Termination Extension, MJTE)结构缓解由于边缘电场聚集导致的边缘漏电。通过对漏电流与半径的对数关系进行拟合与分析,可以确定主导漏电的位置。结果显示,通过对体区和边缘漏电的协同抑制,漏电流降低了三个数量级以上。同时,击穿电压从 458 V 提高至 1466 V,而低导通电压仍维持在 0.71 V。此外,采用 MJTE 的 TSBSD 在大多数占空比下由于低 Von 和低漏电流,保持了最低的功率损耗。本工作为提升 β-Ga2O3 肖特基二极管的工作效率提供了新的途径。
结 论
本文通过协同抑制边缘漏电和体区漏电,在实现低导通电压 (Von) 与 高击穿电压 (Vbr) 之间达到了良好的平衡。通过拟合器件漏电流与尺寸的关系,有效识别了漏电发生的位置,这一方法对研究具有重要价值。首次提出的 TSBS(双肖特基势垒)结构,利用两种不同的肖特基势垒来降低体区漏电,同时保持低 Von。最终,器件的击穿电压提升了 3.2 倍,功率品质因数(PFOM)提高了 7 倍,漏电功率下降了 50%,为推动高效功率器件的发展提供了清晰路径。
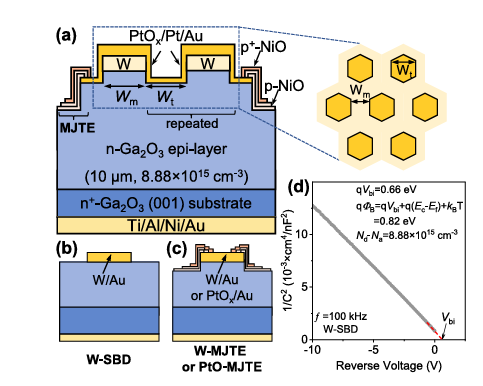
图1. (a) β-Ga2O3 TSBSD-MJTE 的示意图及其阳极布局。(b) W-SBD 的器件结构,(c) W-MJTE 或 PtO-MJTE 的器件结构。(d) 通过 1/C2–V 提取的 Nd–Na 和 qΦB。
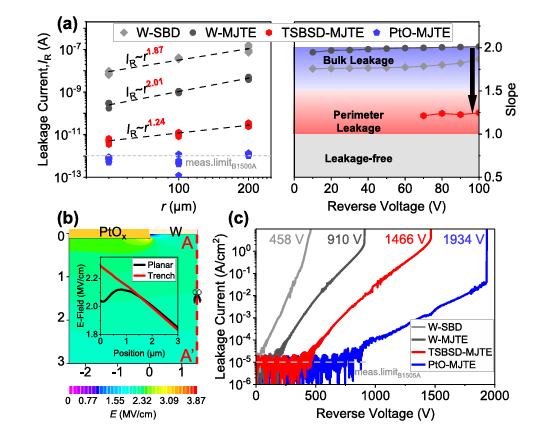
图2. (a) 不同 SBD 在 –100 V 下的反向电流 IR 随半径 r 的依赖关系(左),以及 0 V 至 –100 V 下 log(IR)/log(r) 斜率的变化(右)。(b) –1500 V 下 TSBS 结构的 RESURF 效应。(c) 不同结构器件的击穿特性比较。
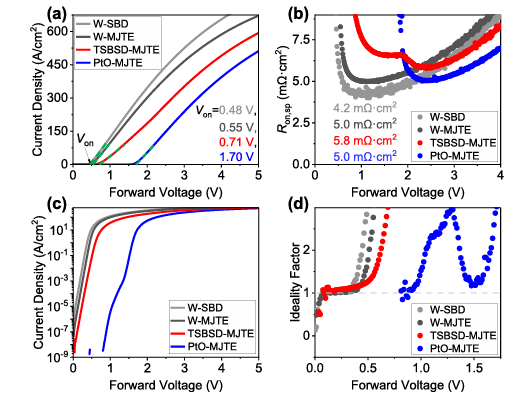
图3. (a) 四种二极管的线性正向 J–V 特性,以及提取的 (b) 比导通电阻 Ron,sp。(c) 半对数正向 J–V 特性,(d) 提取的理想因子 n。
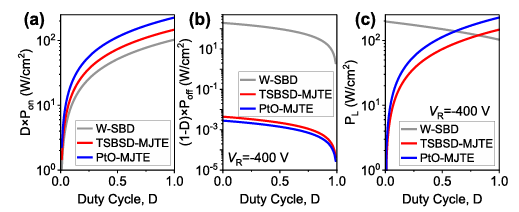
图4. W-SBD、TSBSD-MJTE 和 PtO-MJTE 器件的功率损耗随占空比的比较。(a) 导通损耗贡献,(b) 关断损耗贡献,(c) 总功率损耗。
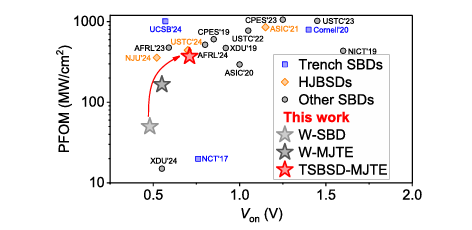
图5. β-Ga2O3 二极管的最新研究成果基准对比图。
DOI:
doi.org/10.1109/LED.2025.3584109