

【会员论文】突破性进展!西电郝跃院士、张进成教授、宁静教授团队:通过可调控的相稳定化优化实现单相ε-Ga₂O₃外延生长
日期:2025-11-06阅读:593
由西安电子科技大学郝跃院士、张进成教授、宁静教授领导的研究团队在学术期刊 Journal of Alloys and Compounds 发布了一篇名为 Tunable phase stabilization optimization for achieving single-phase ε-Ga2O3 epitaxy(通过可调控的相稳定化优化实现单相 ε-Ga₂O₃ 外延生长)的文章。
项目支持
本研究得到以下基金资助:国家自然科学基金面上项目(项目号 62274134);中央高校基本科研业务费专项(项目号 YJSJ24020);国家重点研发计划(项目号 2021YFA0716400 和 2023YFB3609900);国家杰出青年科学基金(项目号 61925404);西安市重点研发项目(项目号 2023JH-ZCGJ-0013);航天七七一所创新基金(项目号 771CX2023007);西安电子科技大学交叉学科培育项目(项目号 21103240003)。
背 景
本研究聚焦于 ε-Ga2O3 这一具有自发极化和高晶格对称性的超宽禁带半导体材料。由于 Ga2O3 在光电器件、高功率电子器件及射频谐振器等领域的潜在应用,其多晶型结构(α、β、γ、δ、ε、κ)受到了广泛关注。其中,ε-Ga2O3 因其优异的电子迁移率和击穿电压表现而备受重视。然而,现有制备技术难以获得高质量的 ε-Ga2O3 薄膜,尤其在c-蓝宝石衬底上常出现α–ε混合相,限制了器件性能提升。
为此,本研究采用雾化化学气相沉积(mist-CVD)方法,通过调控生长温度与氧分压两项关键参数,提出一种可调的相稳定化优化策略,以实现由α–ε混合相向单相 ε-Ga2O3 的可控转变。该方法通过界面调控实现热力学与动力学的双重控制,促进ε相稳定化并抑制次生相生成,从而获得具有优异晶体质量和平整表面的单相 ε-Ga2O3 薄膜,为 Ga2O3 外延生长中的相稳定机制提供了新的认识。
主要内容
具有自发极化特性和高晶格对称性的 ε 相氧化镓(ε-Ga2O3),是极具潜力的超宽禁带电子器件和压电器件候选材料。然而,由于竞争性成核途径和多晶取向竞争,获得纯相的 ε-Ga2O3 仍面临巨大挑战,常导致混相生成及结构缺陷。本研究提出了一种针对雾化化学气相沉积(mist-CVD)工艺的可调控相稳定优化策略,通过同时调控生长温度和氧分压,实现对生长热力学与动力学过程的精细调节。该方法可有效抑制无序相取向,并促进 α–ε 混相向高纯度单一 ε 相的可控转变。所得 ε-Ga2O3/c-蓝宝石薄膜表现出 0.073° 的半高宽(FWHM)和0.75 nm的均方根粗糙度(RMS),表明其具有高晶体质量与优异的表面平整性。高分辨透射电子显微镜(HRTEM)揭示了由多晶向外延转变的过渡层,并证实了 ε (002) 面的外延取向一致性。更重要的是,将该方法应用于表面声波(SAW)器件中,实现了 1.69 GHz 的中心频率与 0.328 % 的有效机电耦合系数(keff2),验证了所制备薄膜的功能可行性。本研究建立了一种可重复、界面敏感的 ε-Ga2O3 外延生长途径,强调了界面工程与相调控策略在推动超宽禁带氧化物半导体实际应用中的关键作用。
创新点
• 通过界面调控,在c-蓝宝石上利用雾化化学气相沉积(mist-CVD)成功生长纯相 ε-Ga2O3 薄膜。
• 通过优化生长温度和氧分压,实现了 ε 相的选择性形成。
• 多晶取向竞争通过界面匹配指导 ε/α 相的转变。
• 实现了创纪录的半高宽(FWHM)0.073°、均方根粗糙度(RMS)0.75 nm,并在表面声波(SAW)器件中获得 1.69 GHz 性能。
• 相稳定性优化为超宽禁带氧化物材料开辟了新的应用潜力。
结 论
本研究在 ε-Ga2O3 薄膜生长早期发现了一个明显的多晶取向竞争层,其演化受生长温度和 O2 分压的显著影响。通过系统调控这些参数,开发了一种基于薄膜/衬底界面的相稳定性优化方法,可同时调控相形成的热力学与动力学因素。具体而言,c-蓝宝石与 Ga2O3 之间的界面引入了晶格失配和界面能量景观,最初导致混相成核。然而,当生长温度升至 620 °C 时,界面应变能的释放和晶格匹配的改善促使 α–ε 混相向单一 ε 相转变。同时,更高的 O2 分压减缓了生长速率,使多晶过渡层更薄,并促进晶粒沿垂直方向排列。这些界面主导的效应共同抑制了 Ga 原子的随机迁移,减少相无序,实现 ε-Ga2O3 的选择性稳定化。
最终获得的 ε-Ga2O3 薄膜的全宽半高 (FWHM) 显著降低至 0.073°,优于 MOCVD 的基准值 0.09°,表面均方根粗糙度仅为 0.75 nm。这些改进表明该方法能够同时提升相纯度与表面形貌。此外,利用 ε-Ga2O3 薄膜作为压电层成功制备了表面声波 (SAW) 器件,实现了 1.69 GHz 的谐振频率和 0.328% 的有效电机耦合系数 (keff2)。这些结果验证了基于界面工程的相稳定优化策略在高质量 ε-Ga2O3 外延生长中的可行性,并展示了其在下一代超宽禁带电子器件和压电器件中的应用潜力。
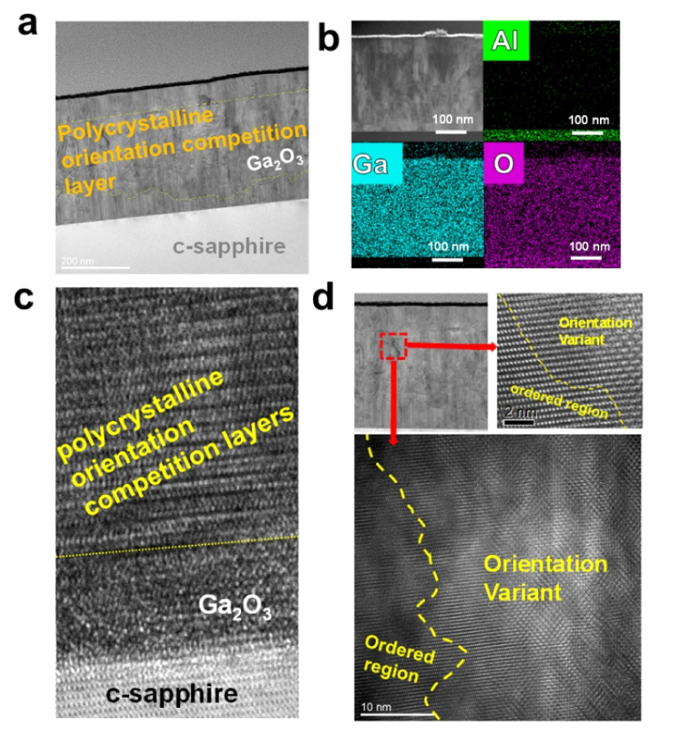
图 1. 不同相 Ga2O3 薄膜的微观结构。(a) FIB 制备的样品截面的 HAADF STEM 成像。(b) c-蓝宝石/Ga2O3 界面的 STEM–EDX 元素分布图。(c) c-蓝宝石/Ga2O3 界面的高分辨透射电子显微镜(HRTEM)图像。(d) Ga2O3 相转换区的 HAADF 图像(红色虚线框);下方图像对应转换相的 HRTEM 放大图。

图 2. 不同温度下生长的 Ga2O3 薄膜的结构与形貌表征。(a) Ga2O3 薄膜在 560℃、620℃ 和 640℃ 下的 XRD 图谱。(b) 不同生长温度下 Ga2O3 薄膜 XRD 的 FWHM 曲线图。(c) 560℃–640℃ 下 Ga2O3 薄膜 RMS 表面粗糙度的 Y 误差图。(d) 620℃ 下 Ga2O3 薄膜的 SEM 表面形貌图。(e)–(g) 分别为 560℃、620℃ 和 640℃ 条件下,Ga2O3 薄膜在 c-蓝宝石衬底上的 AFM 表面形貌图。

图 3. O2 分压对 Ga2O3 薄膜结构性质及厚度的影响。(a) 在 600 sccm O2 分压下生长的外延薄膜 XRD 图谱。(b)、(c) 和 (d) 分别为 ε-Ga2O3 (002)、(004) 和 (006) 峰的放大 XRD 光谱。(e) ε (002) 的 XRD 摇摆曲线。(f) O2 分压、薄膜厚度与 ε-Ga2O3 薄膜生长速率的关系。
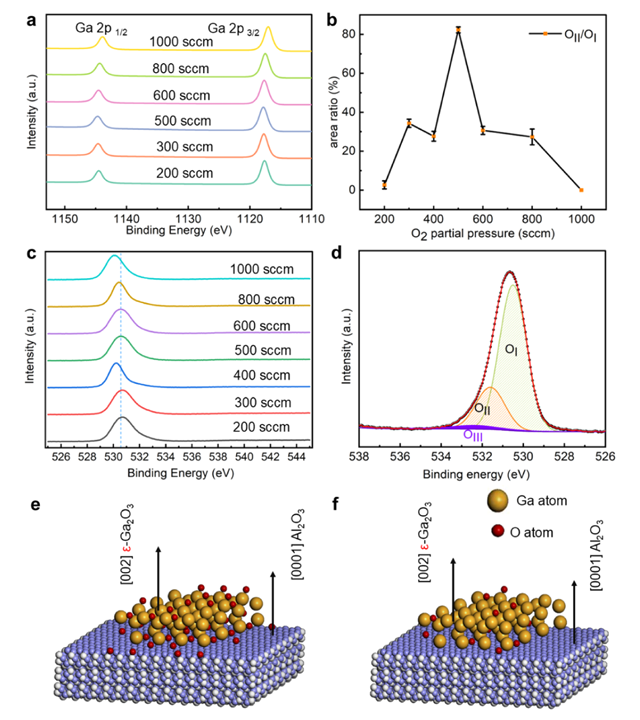
图 4. O₂ 分压与 ε-Ga2O3 薄膜化学成分的相关性。 (a) 200–1000 sccm O2 分压下 ε-Ga2O3 薄膜的 Ga2p XPS 光谱。(b) 在 200–1000 sccm O2 分压下生长的 Ga2O3 薄膜的 OII/OI 比值 Y 误差图。(c) 200–1000 sccm O2 分压下 ε-Ga2O3 薄膜的 O1s XPS 光谱。(d) 不同外延条件下、具有不同氧空位数量的 O1s 模型。(注:模型非按比例绘制,仅用于定性说明界面结构)。
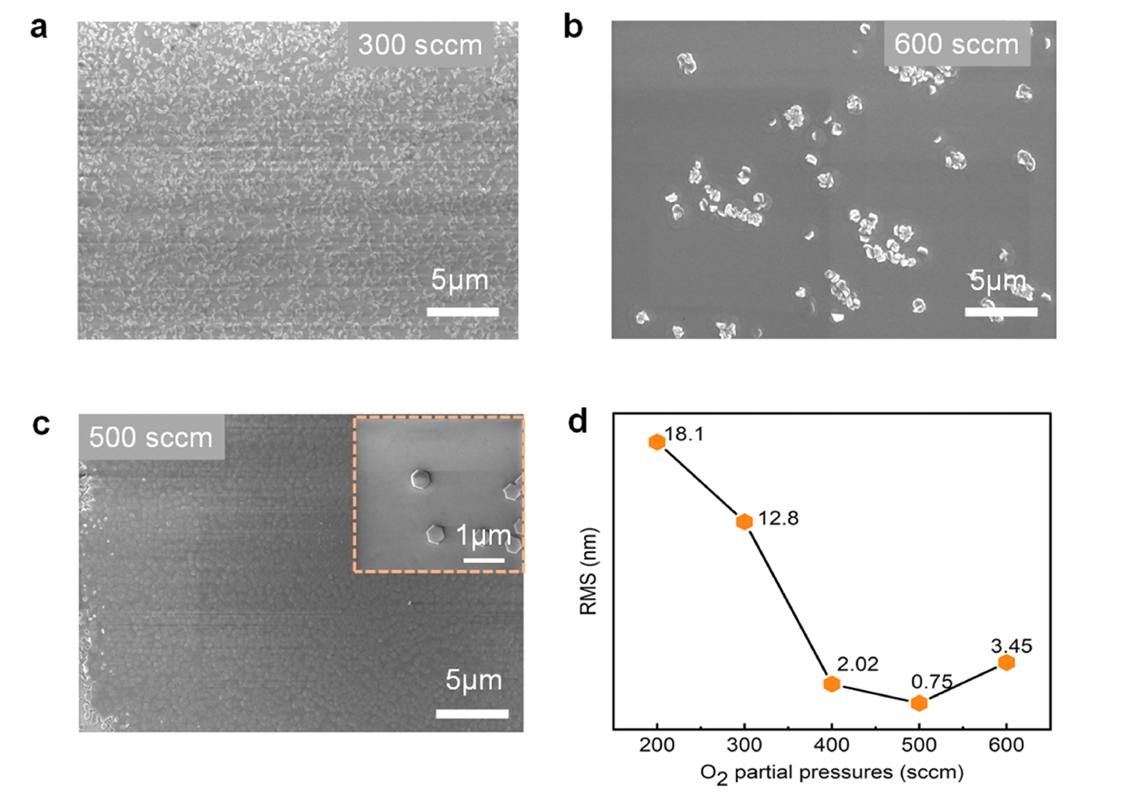
图 5. O2 分压对 ε-Ga2O3 薄膜形貌及质量的影响。不同 O2 分压下生长的 ε-Ga2O3 薄膜的 SEM 表面形貌: (a) 300 sccm,(b) 500 sccm,(c) 600 sccm。 (d) RMS 表面粗糙度随 O2 分压的变化关系。
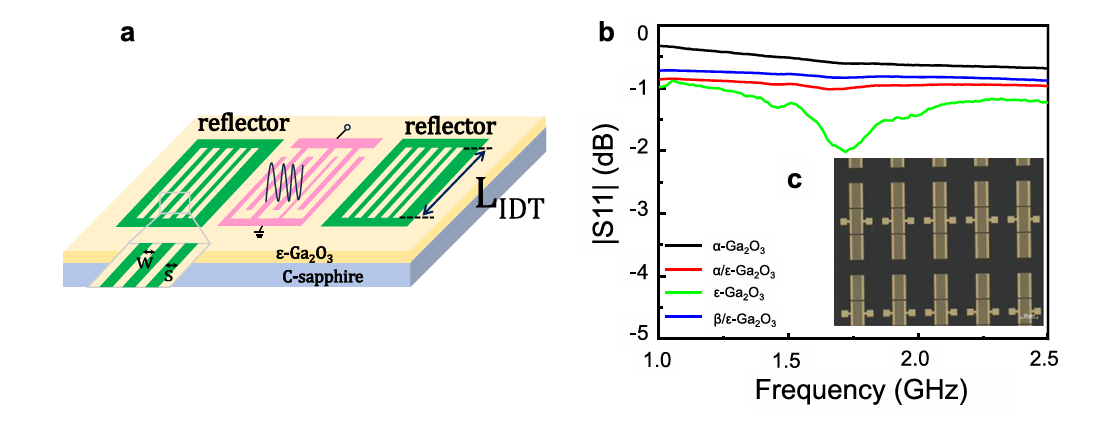
图 6. ε-Ga2O3 表面声波 (SAW) 谐振器的设计、性能及形貌。(a) ε-Ga2O3 SAW 谐振器示意图。(b) 在不同样品上制备的 SAW 谐振器的 S11 参数。(c) ε-Ga2O3 SAW 谐振器的 SEM 表面形貌。
DOI:
doi.org/10.1016/j.jallcom.2025.184847