

【国内论文】中国科学技术大学龙世兵教授团队:2.8 kV β-Ga₂O₃肖特基整流器的改进型复合JTE技术增强了对界面电荷的容忍度
日期:2025-12-08阅读:405
由中国科学技术大学龙世兵教授的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 An improved composite JTE technique with increased tolerance to interface charges for 2.8 kV β-Ga2O3 Schottky rectifier(2.8 kV β-Ga2O3 肖特基整流器的改进型复合 JTE 技术增强了对界面电荷的容忍度)的文章。
背 景
β-氧化镓(β-Ga2O3)因其超宽禁带(~4.8 eV)和高临界击穿场强,是下一代高压功率二极管的理想候选材料。为了发挥其高压潜力,必须采用有效的边缘终端技术(Edge Termination)来缓解阳极边缘的电场拥挤,防止过早击穿。结终端扩展(JTE)是一种常用的终端技术。特别是采用 p 型氧化镍(p-NiO)形成的异质结 JTE,已被证明能有效提高击穿电压。然而,p-NiO/n-Ga2O3 异质结界面处不可避免地存在界面电荷。这些界面电荷会严重扭曲电场分布,导致击穿电压下降,并使器件性能对工艺波动非常敏感,降低了可靠性。
主要内容
本文提出了一种高效的高介电常数 BaTiO3 介质辅助结端部延伸(BTO-JTE)技术,适用于垂直 β-Ga2O3 肖特基势垒二极管(SBD),旨在降低击穿电压(BV)对界面电荷的敏感性。与单区结点延伸技术(SZ-JTE)相比,BTO-JTE 技术能形成更均匀的电场分布,显著降低肖特基结或结点延伸区域边缘的峰值电场强度。由此实现最高 BV 值 3kV 与低静态导通电阻 (Ron,sp) 6.2mΩ·cm2,最高功率优值 (PFOM) 达 1.45GW/cm2。值得注意的是,相较于 SZ-JTE 肖特基二极管,BTO-JTE 肖特基二极管在整个晶圆上展现出显著更优的击穿电压均匀性,平均击穿电压达 2.81 kV 。结合平均 Ron,sp 值 6.9 mΩ·cm2,最终获得平均 PFOM 值 1.14 GW/cm2,该数值仍位居垂直 β-Ga2O3 结型二极管已报道最佳值之列。实验与仿真结果验证了高介电常数 BaTiO3 介质可有效抑制界面电荷对 BTO-JTE 效率的负面影响。本研究提出了一种在界面电荷存在下提升 JTE 结构电场管理效率的有效策略,为实现坚固的千伏级 β-Ga2O3 功率器件奠定了基础。
研究亮点
● 创新性地将 p-NiO 异质结与 High-k BaTiO3 介质相结合,构建了 BTO-JTE 结构。这种组合利用了 NiO 的电场调控能力和 BTO 的电荷调控能力。
● 首次系统证明了这种复合结构能够有效屏蔽或容忍高密度的界面负电荷,解决了传统 NiO-JTE 器件在实际制造中因界面质量波动导致良率低、性能不稳定的痛点 。
● 在不显著增加导通电阻的前提下,实现了优异的功率优值。
总 结
研究团队成功制备了高性能 β-Ga2O3 肖特基二极管,其高介电常数 BaTiO3 介质增强了JTE的效率,展现出对正负界面电荷的宽容度。实验与模拟结果均证实了其对界面电荷的击穿电压敏感性显著降低。采用 BTO-JTE 技术的 β-Ga2O3 肖特基二极管保持 2.81 kV 平均击穿电压的同时,显著提升了界面电荷容差。这些改进使 BTO-JTE 展现出更强的抗界面电荷干扰能力。本研究表明,BTO-JTE 技术是实现高压 β-Ga2O3 器件极具前景的边缘封装方案。
项目支持
本研究得到中国国家重点研发计划(2024YFE0205200)、国家自然科学基金(U23A20358、62474170、62234007、61925110)以及江苏省科技重大专项(BG2024030)的支持。部分工作在中国科学技术大学微纳研究与制造中心。
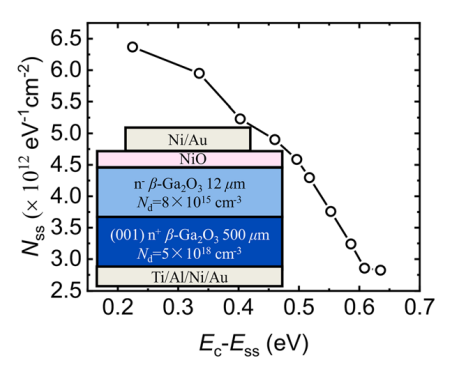
图1. 基于 NiO/β-Ga2O3 异质结二极管实验测量数据获得的界面态密度分布曲线,该曲线以界面态能量相对于导带的值(Ec–Ess)为横坐标。
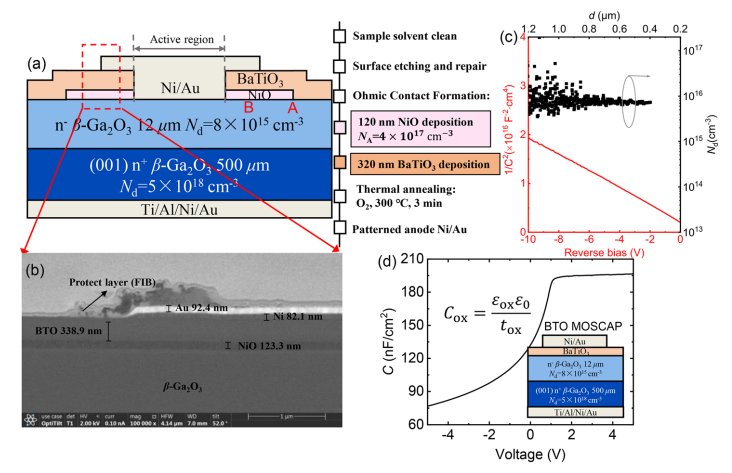
图2. (a) 垂直 β-Ga2O3 与 BTO-JTE 的示意截面图及制备细节。(b) 制备器件的截面扫描电子显微镜图像。(c) 从 1/C2-V 特性曲线提取的钕分布曲线。(d) BTO MOSCAP 的 C-V 特性曲线。

图3. β-Ga2O3 SBD 的正向 I-V 特性曲线:(a)线性坐标,(b)半对数坐标,(c)制备的 β-Ga2O3 SBD 的反向击穿 I-V 特性曲线。
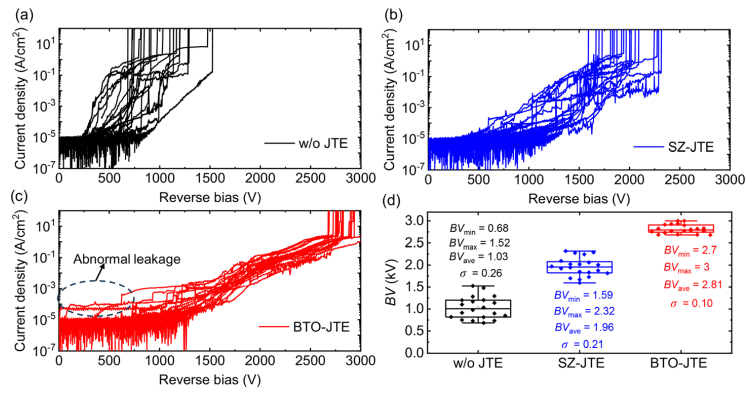
图4. 不同类型β-Ga2O3 SBD 样品中 20 个器件在不同位置的反向击穿 I-V 特性曲线:(a)普通二极管,(b) SZ-JTE二极管,(c) BTO-JTE二极管。图 (d) 为制备的 β-Ga2O3 SBD 的击穿电压统计分布。
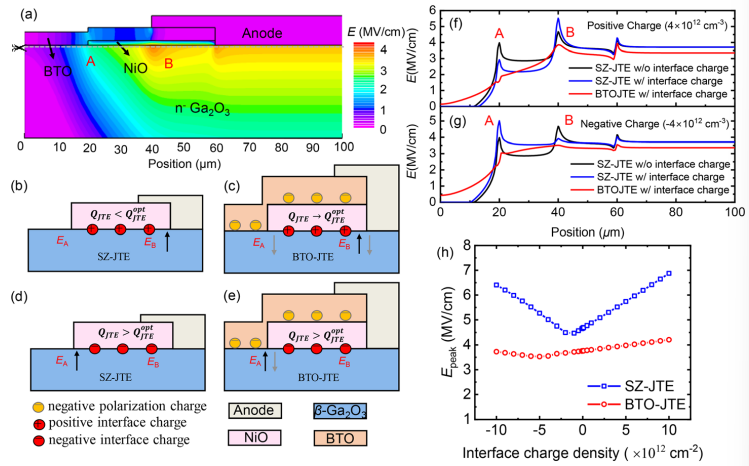
图5. (a) 采用 BTO-JTE 的 β-Ga2O3 反向偏压为 3 kV 时的二维电场等值线模拟图。(b)–(e) 界面电荷与 BTO 对电场影响的工作原理示意图。(f) β-Ga2O3 表面沿水平截面线提取的正电荷分布,(g) 负电荷分布。(h) SZ-JTE 与 BTO-JTE 器件中模拟峰值电场与界面电荷密度的关系曲线。
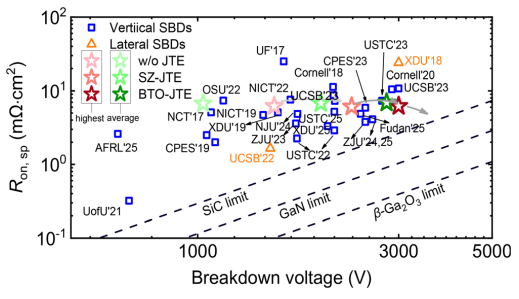
图6. 已报道的先进β-Ga2O3 SBD 的 Ron,sp 与 BV 基准曲线图。
DOI:
doi.org/10.1063/5.0295356