

【国内论文】中国科大龙世兵教授团队:MOCVD法在(010)氧化镓衬底上生长的高质量β-(AlₓGa₁₋ₓ)₂O₃异质外延薄膜及其晶体管演示
日期:2025-12-19阅读:457
由中国科学技术大学龙世兵教授、徐光伟教授团队的研究团队在学术期刊 Semiconductor Science and Technology 发布了一篇名为 High-quality β-(AlₓGa₁₋ₓ)2O3 heteroepitaxy grown on (010) Ga2O3 via MOCVD and transistor demonstration(基于金属有机化学气相沉积法在(010) Ga2O3 衬底上生长的高质量β-(AlₓGa₁₋ₓ)2O3异质外延薄膜及其晶体管演示)的文章。
背 景
β-Ga2O3 作为新兴超宽禁带半导体,具有 4.8 eV 带隙、8 MV/cm 击穿场强、极高的 Baliga 优值,被认为是下一代高功率、低损耗电子器件的重要材料。引入 Al2O3 可形成 (AlxGa1-x)2O3 合金,使带隙可提升至 8.8 eV,理论击穿场强可达到 16 MV/cm,进一步增强器件耐压性能。目前研究多集中在 β-(AlxGa1-x)2O3/β-Ga2O3 外延和 2DEG 结构上,但基于整体掺杂的 (AlxGa1-x)2O3 外延薄膜的高耐压功率器件仍较少。为此,该工作利用 MOCVD 在 (010) β-Ga2O3 上实现高质量 β-(AlxGa1-x)2O3 外延,并首次展示了基于该外延薄膜的 MOSFET,其耐压超过 3000 V,验证了 (AlxGa1-x)2O3 在高压功率器件领域的重要潜力。
主要内容
本研究通过金属有机化学气相沉积(MOCVD)在 (010) β-Ga2O3 衬底上实现了单相 β-(AlxGa1-x)2O3 的异质外延生长,所获得的铝组分最高可达 22.6%,并通过 X 射线衍射(XRD)确认未出现相分离现象。随着铝组分的增加,外延层的表面形貌先变得更粗糙,随后又逐渐变得平滑,表明铝组分的提高会引发外延生长模式的变化。基于 β-(Al0.09Ga0.91)2O3 外延薄膜制备的 MOSFET 器件实现了超过 3000 V 的超高击穿电压及 2.3 MV/cm 的高平均击穿场强。该研究凸显了 β-(AlxGa1-x)2O3 异质外延技术的潜力,并展示了其在高压功率器件应用中的良好适配性。
创新点
● 通过 MOCVD 在 (010) β-Ga2O3 上实现 最高 22.6% Al 含量、无相分离的单相 β-(AlxGa1-x)2O3 外延薄膜。
●揭示 Al 含量提升导致外延表面从二维岛状生长向方向性规整形貌转变的生长模式演化规律。
●通过截面 EDS 证实 Al 在外延层厚度方向上均匀分布,与 XRD 成分一致,验证材料生长质量。
●首次利用整体掺杂的 β-(Al0.09Ga0.91)2O3 外延膜制备 MOSFET,展示了合金材料本征耐压优势。
●器件在无场板结构下实现 超过 3000 V 的击穿电压和 2.3 MV/cm 的平均击穿场强,显著优于已报道的无场板 Ga2O3 器件。
总 结
本工作报道了在 (010) β-Ga2O3 上通过 MOCVD 实现 β-(AlxGa1-x)2O3 的异质外延生长,铝组分可达 22.6%。基于 (Al0.09Ga0.91)2O3 异质外延薄膜制备了无场板 MOSFET 器件。在栅漏距离 Lgd = 4 μm 的器件中,实现了 900 V 的高击穿电压,对应的平均击穿场为 2.3 MV/cm。当 Lgd = 40 μm 时,器件击穿电压超过 3000 V。该结果表明, (AlxGa1-x)2O3 异质外延显著提升了氧化镓功率晶体管的击穿电压,凸显了 (AlxGa1-x)2O3 材料在高压功率器件应用中的潜力。
项目支持
本工作得到了中国国家自然科学基金的资助(项目编号 U23A20358、62404214、62234007、61925110 和 62474170),以及中国博士后科学基金(项目编号 2024M753114)的支持。同时,本工作还得到了中国科学技术大学(USTC)“双一流”建设科研基金(项目编号 WK2100000055)的资助。本研究部分工作在中国科学技术大学微纳米尺度研究与制造中心完成。
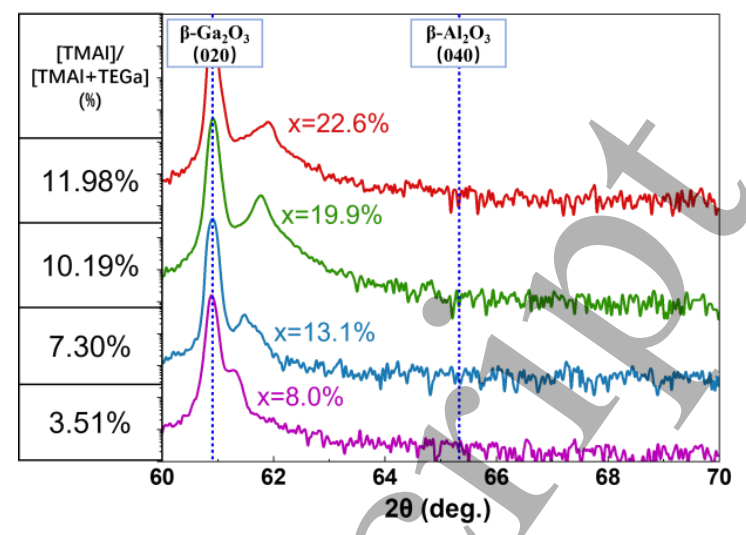
图1. 采用不同 [TMAl]/[TEGa + TMAl] 摩尔流量比(3.51%–11.98%)生长的 (010) β-(AlₓGa₁₋ₓ)₂O₃ 外延膜的 XRD ω-2θ 扫描图。

图2. Al 组分从 8.0% 到 22.6% 的 β-(AlₓGa₁₋ₓ)₂O₃ 薄膜的表面 SEM 图像。

图3. Al 组分从 8.0% 到 22.6% 的 β-(AlₓGa₁₋ₓ)₂O₃ 薄膜的表面 AFM 图像。
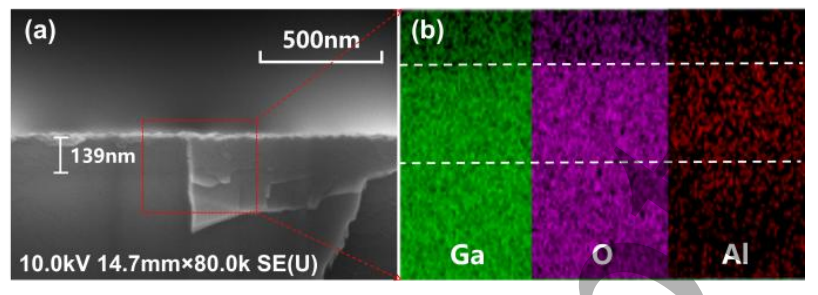
图4. (a) β-(Al₀․₁₉Ga₀․₈₁)₂O₃/β-Ga₂O₃ 异质结构的截面 SEM 图像。 (b) β-(Al₀․₁₉Ga₀․₈₁)₂O₃ 薄膜的截面 EDS 元素分布图。

图5. 未采用场板结构的 β-(AlₓGa₁₋ₓ)₂O₃ MOSFET 的截面示意图。

图6. 在 LGD = 4 μm 和 40 μm 条件下,Ga₂O₃ 与 (Al₀․₀₉Ga₀․₉₁)₂O₃ MOSFET 的转移与输出特性。(a)、(b)为 Ga₂O₃,LGD = 4 μm;(c)、(d)为 (Al₀․₀₉Ga₀․₉₁)₂O₃,LGD = 4 μm;(e)、(f)为 Ga₂O₃,LGD = 40 μm;(g)、(h)为 (Al₀․₀₉Ga₀․₉₁)₂O₃,LGD = 40 μm。
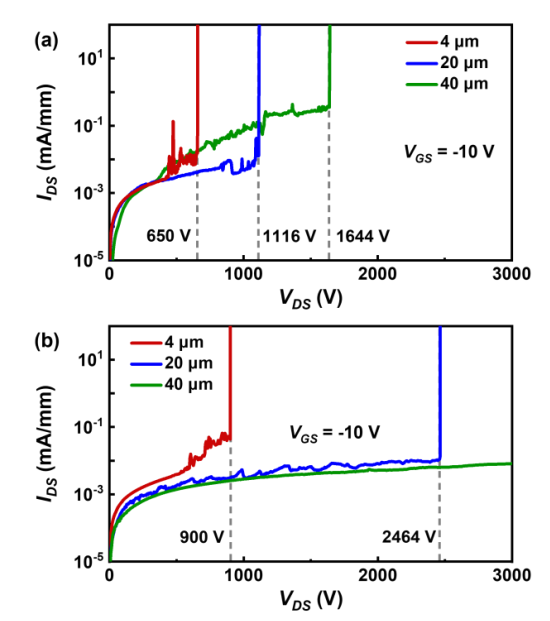
图7. 在 LGD = 4、20、40 μm 条件下,基于 (a) Ga₂O₃ 和 (b) (Al₀․₀₉Ga₀․₉₁)₂O₃ 外延薄膜制备的 MOSFET 的三端关断态击穿特性。
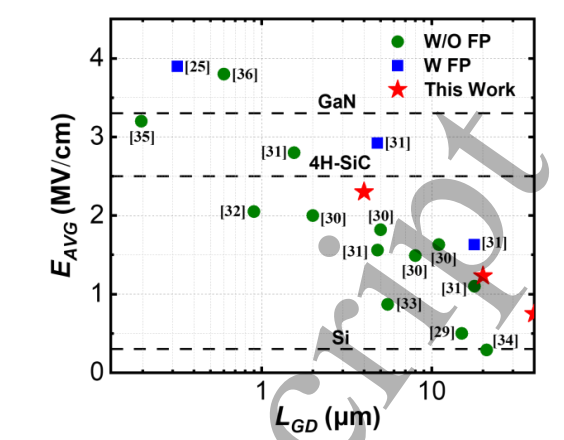
图8. 本工作器件的平均击穿场强 EAVG 与 LGD 的关系图,并与近期发表的 β-Ga₂O₃ 晶体管结果进行对比。
DOI:
doi.org/10.1088/1361-6641/ae26c3