

【会员论文】电子科技大学罗小蓉教授团队:具有扩展p-NiO栅极场板的超低导通电阻高压β-Ga₂O₃ MOSFET
日期:2025-12-23阅读:418
由电子科技大学罗小蓉教授、魏杰研究员、魏雨夕博士后的研究团队在学术期刊 IEEE Transactions on Electron Devices 发布了一篇名为 Ultralow On-Resistance High-Voltage β-Ga2O3 MOSFET With an Extended p-NiO Gate Field Plate(具有延伸p-NiO栅场板的超低阻高压 β-Ga2O3 MOSFET)的文章,谭佳蕾博士为论文第一作者。
背 景
β-Ga2O3 具有 4.5–4.9 eV 的超宽禁带、8 MV/cm 的高临界击穿电场以及高巴利加优值(BFOM),在下一代功率器件中展现出巨大潜力。过去十年间,β-Ga2O3 MOSFET 因在功率应用中的显著优势备受关注。研究人员通过高 k 介质、FinFET 结构、超结技术及 RESURF 技术等手段,持续提升其功率优值(PFOM=BV2/Ron,sp)。此外,为降低静态功耗并增强电力转换应用中的电路安全性,需实现低负阈值电压。凹槽栅、异质结栅与电流阻断层(CBL)是有效提升器件阈值电压的技术手段。然而,以上技术难以同时优化器件比导通电阻与击穿电压——为降低比导通电阻需提升漂移区浓度,进而引发提前击穿。本研究通过 Sentaurus TCAD 仿真,提出并研究了一种具有延伸 p-NiO 栅场板的超低阻高压 β-Ga2O3 MOSFET(PFP MOSFET)。与利用辅助耗尽效应而增加掺杂浓度,降低导通电阻的常规 RESURF 器件不同,本器件通过引入电荷积累层以进一步降低导通电阻,从而实现更优的击穿电压—导通电阻折中关系。
主要内容
本文提出并研究了一种具有延伸 p-NiO 栅场板(PFP)的新型 β-Ga2O3 MOSFET。其结构特征为:器件具有与栅极短接、并覆盖在漂移区上方的 p-NiO 栅场板,p-NiO 与 β-Ga2O3 漂移区由 Al2O3 介质层隔离,因此 p-NiO / Al2O3 / β-Ga2O3 漂移区可视为等效MIS(金属氧化物半导体)结构。导通状态下,等效 MIS 结构使位于 p-NiO下方的 Ga2O3 漂移区表面具有高密度电子积累层,提供额外的超低阻导电路径,从而显著降低比导通电阻。阻断状态下,延伸 p-NiO 栅场板调制电场分布,辅助耗尽漂移区,有效提升击穿电压。此外,PFP MOSFET 允许器件具有更高的掺杂浓度以进一步降低比导通电阻,而不会使击穿电压明显退化。与无延伸 p-NiO 栅场板的器件相比,该器件比导通电阻降低了 45%,击穿电压提升 407%,实现高达 1.63 GW/cm2 的高功率优值。本研究为未来电力转换应用中实现高性能 β-Ga2O3 MOSFET 提供了新思路。
结 论
本文提出并研究了一种具有超低比导通电阻和高击穿电压的 β-Ga2O3 MOSFET。该器件具有延伸p-NiO栅极场板(PFP)结构。该结构在导通状态时引入电子积累层以实现超低比导通电阻,并在阻断状态时调制电场分布、提升击穿电压。通过优化关键参数,PFP MOSFET 实现 6.4 mΩ·cm2 的比导通电阻与 3230V 的高击穿电压,从而实现高达 1.63 GW/cm2 的功率优值。相较于无延伸 p-NiO 栅场板的 PG MOSFET,PFP MOSFET 的比导通电阻与击穿电压分别优化了 45% 和 407%,从而实现更优的击穿电压—导通电阻折中关系,展现出卓越的性能指标。
项目支持
本研究部分由国家自然科学基金(62374028,62404030),由中国博士后科学基金会博士后研究基金(GZC20240199,GZC20240200),以及中央指导地方自主探索项目(2023ZYD0160)的资助。
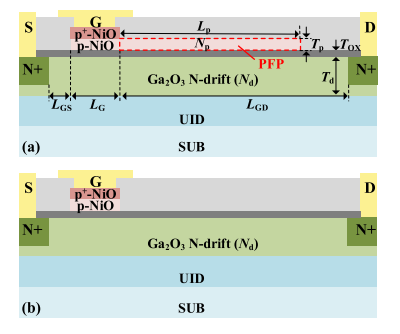
图1. (a) PFP MOSFET 与 (b) PG MOSFET 的器件结构示意图。

图2. PFP MOSFET 关键制造工艺流程。(a)源漏欧姆接触形成。(b)通过原子层沉积形成 Al2O3 绝缘层。(c)采用射频磁控溅射沉积双层 NiO。(d)形成栅极金属层。
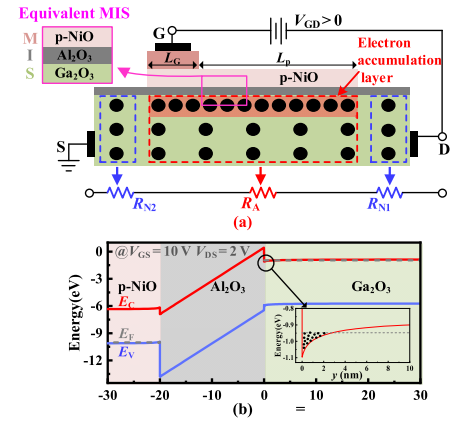
图3. (a) PFP MOSFET导通状态下的工作机制及(b) NiO/Al2O3/Ga2O3 能带分布。

图4. (a) PFP MOSFET 在 VGS = 10 V 和 VDS = 2 V 条件下电子密度分布。(b) x方向与y方向的电子密度分布曲线。(c) PFP MOSFET 在 VGS = 10 V、VDS = 2 V时y方向电流密度分布图。
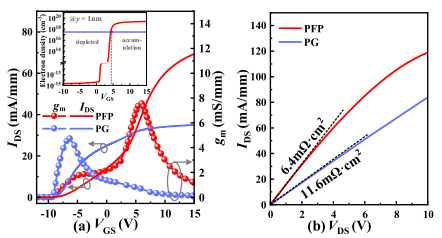
图5. (a) PFP 与 PG MOSFET在VDS=4 V 时的转移特性。插图显示两器件在y=1 nm处电子密度随VGS变化的关系。(b) 不同器件在VGS=10 V时的输出特性。
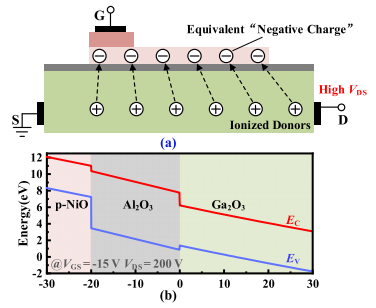
图6. (a) PFP MOSFET器件阻断状态下工作机制及 (b) NiO/Al2O3/Ga2O3 能带分布。
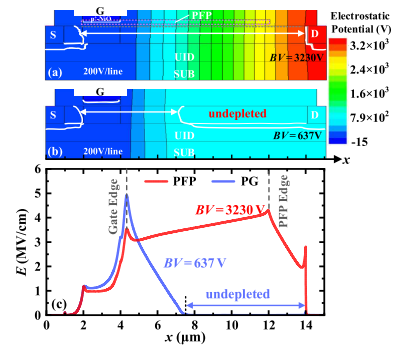
图7. (a) PFP MOSFET 与 (b) PG MOSFET 击穿时的电势与耗尽区等值线分布。(c) PFP 与 PG MOSFET 击穿时漂移表面电场分布。
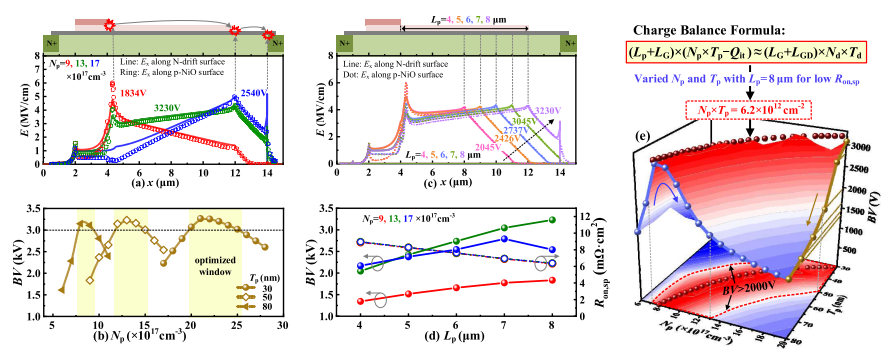
图8. (a) 不同NiO浓度下漂移区表面与p-NiO表面的电场分布。(b) NiO浓度与厚度对PFP MOSFET的BV的影响。(c) 不同NiO长度对漂移区表面与p-NiO表面的电场分布的影响。(d) NiO长度与浓度对PFP MOSFET的BV与Ron,sp的影响。(e) 当 Lp=8 µm时,NiO浓度与厚度对BV的影响。
DOI:
doi.org/10.1109/TED.2025.3633223