

【国内论文】中山大学:氟等离子体处理实现 β-Ga₂O₃ MOSFET 的缺陷介导阈值电压调谐
日期:2026-01-04阅读:334
由中山大学的研究团队在学术期刊 Nanomaterials 发布了一篇名为 Defect-Mediated Threshold Voltage Tuning in β-Ga2O3 MOSFETs via Fluorine Plasma Treatment(氟等离子体处理实现 β-Ga2O3 MOSFET 的缺陷介导阈值电压调谐)的文章。
背 景
β-Ga2O3 因其超宽带隙(4.9 eV)和极高的临界击穿场强(8 MV/cm),是下一代高功率电子器件的有力竞争者。β-Ga2O3 器件通常为耗尽型(D-mode),难以实现增强型(E-mode)操作,且 Vth 难以调控。异质外延通常会导致较高的缺陷密度,引起较大的关态漏电流并降低击穿电压。虽然氟(F)处理已被用于 GaN 等材料,但在 β-Ga2O3,F 究竟是作为施主还是受主/钝化剂,此前的研究结论不一。
在本研究中,采用氟等离子体表面处理技术,对生长于 2 英寸蓝宝石衬底上的等离子体辅助分子束外延(PA-MBE)β-Ga2O3 薄膜进行处理,并验证该技术对横向 MOSFET 阈值电压调节与击穿增强的同步影响。氟处理有效减少了近表面施主态,通过调节等离子体持续时间,实现了 1×10-9 mA/mm 的超低 Ioff值及可控的正向 Vth 偏移(最高达 +12.4 V)。XPS 分析揭示了氟元素的掺入及氟-镓键合结构的形成,而 TCAD 模拟表明:抑制近表面电荷与扩宽耗尽区共同促成了实验观测到的击穿电压提升。这些成果阐明了氟元素在改性 PA-MBE β-Ga2O3 表面缺陷态中的作用机制,为工程化调控 Ga2O3 基功率器件的阈值电压与漏电流提供了有效途径。
主要内容
研究团队展示了基于等离子体辅助分子束外延(PA-MBE)生长 β-Ga2O3 薄膜的高性能 MOSFET 器件。通过 X 射线衍射和原子力显微镜证实了 β-Ga2O3 外延层的高晶体质量。采用优化的 CF4 等离子体处理将氟(F)引入近表面区域,有效抑制了施主态。所得器件展现出 1×10-9 mA/mm 的超低关断电流及 105 的稳定导通/关断比。通过调节等离子体作用时间,实现了高达 +12.4 V 的可控正向阈值电压偏移。X 射线光电子能谱表明,掺入的氟原子形成氟-镓键并补偿了氧相关施主缺陷。Sentaurus TCAD 模拟揭示近表面电荷减少及耗尽区拓宽,为实验中击穿电压从 453 V 提升至 859 V 提供了物理机制解释。这些成果阐明了氟元素在调节 PA-MBE β-Ga2O3 表面缺陷态中的作用,并为 Ga2O3 功率器件的阈值电压调控与漏电流抑制提供了有效途径。
研究亮点
● 本文提出了一种优化的 CF4/O2 等离子体处理工艺,不仅实现了对 β-Ga2O3 MOSFET 阈值电压的大幅正向调控,同时还显著降低了漏电流并提升了击穿电压。
● 针对 F 在 β-Ga2O3 中的争议,本研究通过 XPS 深度分析,明确指出在 PA-MBE 生长的薄膜中,F 主要起到钝化施主型缺陷的作用,形成 Ga–F 键,从而表现出类似受主的耗尽效应,而非作为施主提供电子。
● 尽管使用的是蓝宝石衬底,通过这种表面缺陷钝化技术,实现了与同质外延器件相当甚至更优的低漏电性能,为低成本高性能 Ga2O3 功率器件的商业化提供了可行路径。
总 结
通过氟等离子体处理成功实现了具有超低关断电流和增强亚阈值特性的 β-Ga2O3MOSFET。优化器件实现了低至 1×10-9 mA/mm 的关态电流 Ioff,并获得 12.4 V 的正向 Vth 偏移。此外,击穿电压从 453 V 显著提升至 859 V。XPS 分析证实,氟元素掺入通过形成 Ga–F 键及减少氧空位相关态,有效抑制了近表面施主型缺陷。互补的 TCAD 模拟定性再现了由此产生的电荷密度降低和电场重新分布,与实验观测到的正向 Vth 偏移及增强的 Vbr 相一致。这些发现不仅为 β-Ga2O3 中氟元素掺杂机制提供了基础性认识,更为提升 Ga2O3 基功率电子器件的性能与可靠性开辟了可行路径。
项目支持
本研究得到国家自然科学基金(编号:U22A2073, 62474197)、广东省基础与应用基础研究基金(编号:2024A1515011536)和广州市基础与应用基础研究基金(编号:2025A04J7142)的资助。
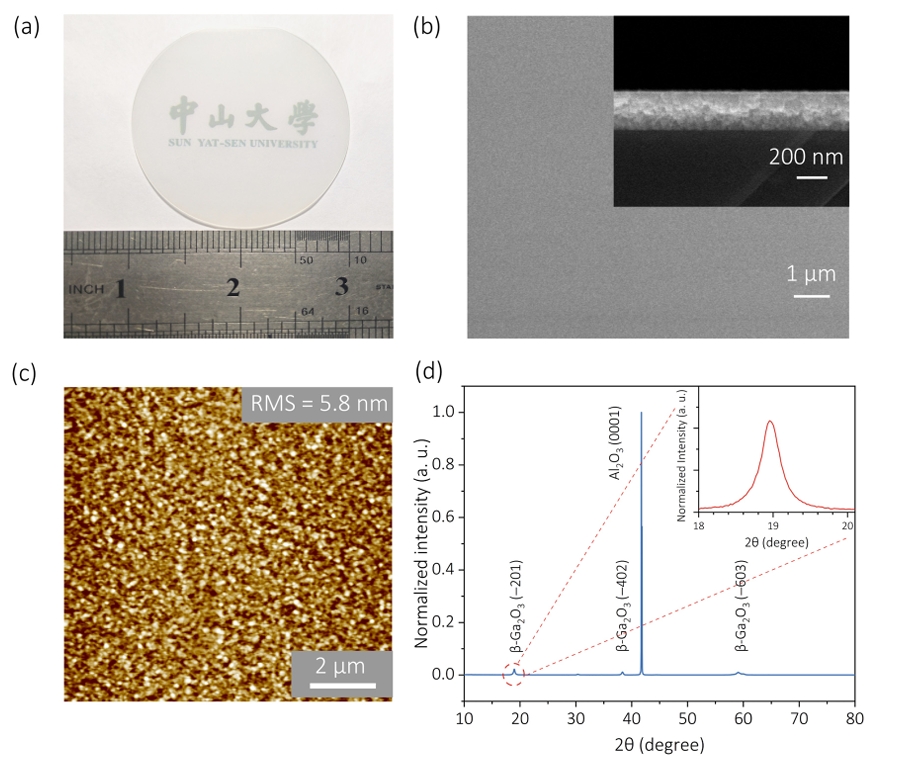
图1. 通过等离子体辅助分子束外延(PA-MBE)在 2 英寸蓝宝石衬底上生长的 β-Ga2O3 薄膜的光学图像与晶体特性。(a) 新生长 2 英寸 β-Ga2O3 薄膜晶圆的光学图像。(b) 异质外延法获得的单晶 β-Ga2O3 薄膜扫描电子显微镜(SEM)图像。插图:截面 SEM 图像显示薄膜厚度约为 300 nm。(c) 薄膜表面原子力显微镜(AFM)图像,均方根粗糙度为 5.8 nm。(d) 蓝宝石衬底上 β-Ga2O3 薄膜的 X 射线衍射(XRD)图谱。位于 18.9°、38.4° 和 59.0° 的三组特征峰分别对应 β-Ga2O3 晶体的(-201)、(-402)和(-603)晶面。插图:(−201)峰的放大图,其半高全宽(FWHM)为 0.31°,证实了 β-Ga2O3 薄膜的高结晶度。
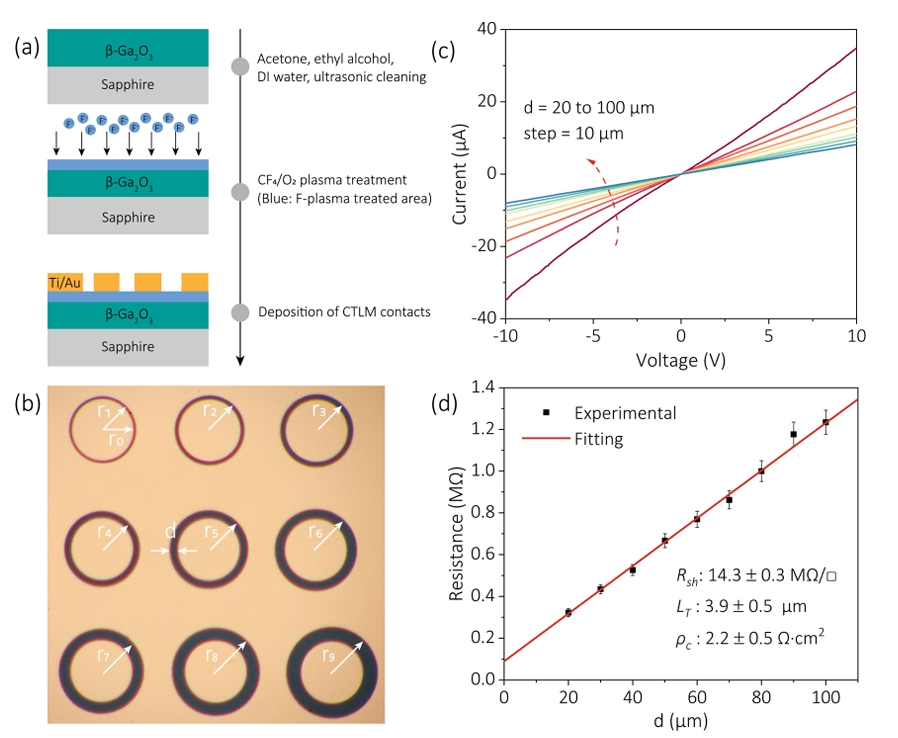
图2. 制备的 β-Ga2O3 圆形传输线模型(CTLM)的制造工艺、光学显微照片及 I-V 特性曲线。(a) β-Ga2O3 CTLM 的截面示意图与制造流程。(b) 制备的 CTLM 结构光学显微照片,其固定内圈半径(r0)为 200 μm。外圈半径(ri,i=1~9)以 10 μm 为增量从 220 μm 至 300 μm 递增,其中 d 定义为 ri -r0。(c) 经 3 分钟表面处理的 β-Ga2O3 CTLM 器件的 I-V 曲线。(d) 从 I-V 数据中提取的片电阻与接触电阻。

图3. β-Ga2O3 MOSFET 的制备工艺、光学显微照片及 I-V 特性曲线。(a) 示意性截面图展示 β-Ga2O3 MOSFET 结构及制备流程。(b) 典型 β-Ga2O3 MOSFET 的光学显微照片。圆形源极半径为 200 μm,环形栅极的内半径与外半径分别为 210 μm 和 220 μm,由此形成 10 μm 的栅源距离(LGS)与栅极长度(LG)。漏源间距(LDS)设计为 40 μm。(c) 未处理器件(F0)在 VDS= 10 V 下的典型转移特性。(d) F0 在不同 VGS 电压下的输出特性。(e) 经 3 分钟氟处理器件(F3)在 VDS=10V 时的传输特性曲线。(f) F3 在不同 VGS 条件下测得的输出特性曲线。

图4. (a) 不同F等离子体处理时长后 β-Ga2O3 MOSFET 的传输特性。传输曲线显示阈值电压正向偏移 +12.4 V。(b) 不同处理时长器件的击穿特性。击穿电压从 453 V(F0)增至 859 V(F7)。
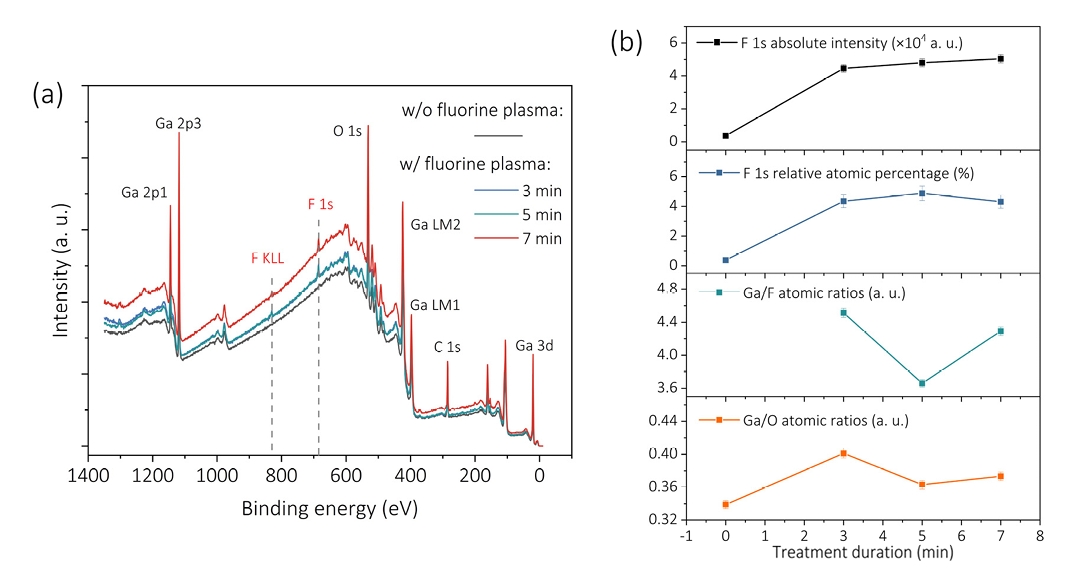
图5. (a) 未处理和氟化 β-Ga2O3 表面的 X 射线光电子能谱 (XPS) 概览谱图,显示氟等离子体处理后 F 1s 和 F KLL 峰的出现。(b) 经氟等离子体处理样品中 F 1s 峰绝对强度随时间演变曲线,以及 F 1s 相对原子百分比、Ga/F 与 Ga/O 原子比的变化趋势。

图6. (a) 未处理样品的 F 1s 能谱 (b) 经 3 分钟处理样品的 F 1s 能谱,显示两个峰位:F–Ga 键(685.2 eV)与 F–OH 基相互作用(687.0 eV)。(c,d) 未处理样品与 3 分钟处理样品的 O 1s 谱图,经分解为 OI(O–Ga 键,530.6 eV)与 OII(表面–OH 基团,532.3 eV)。(e,f) 未处理样品与 3 分钟处理样品的 Ga 3d 谱,经分解为 Ga1+(19.5 eV)和 Ga3+(20.4 eV)。

图7. (a) 未处理样品及经 3、5、7 分钟氟等离子体处理样品的 Ga 2p 能谱概览。Ga 2p 能谱的组分分析:(b) 未处理样品,(c) 经 3 分钟处理样品,(d) 经 5 分钟处理样品。
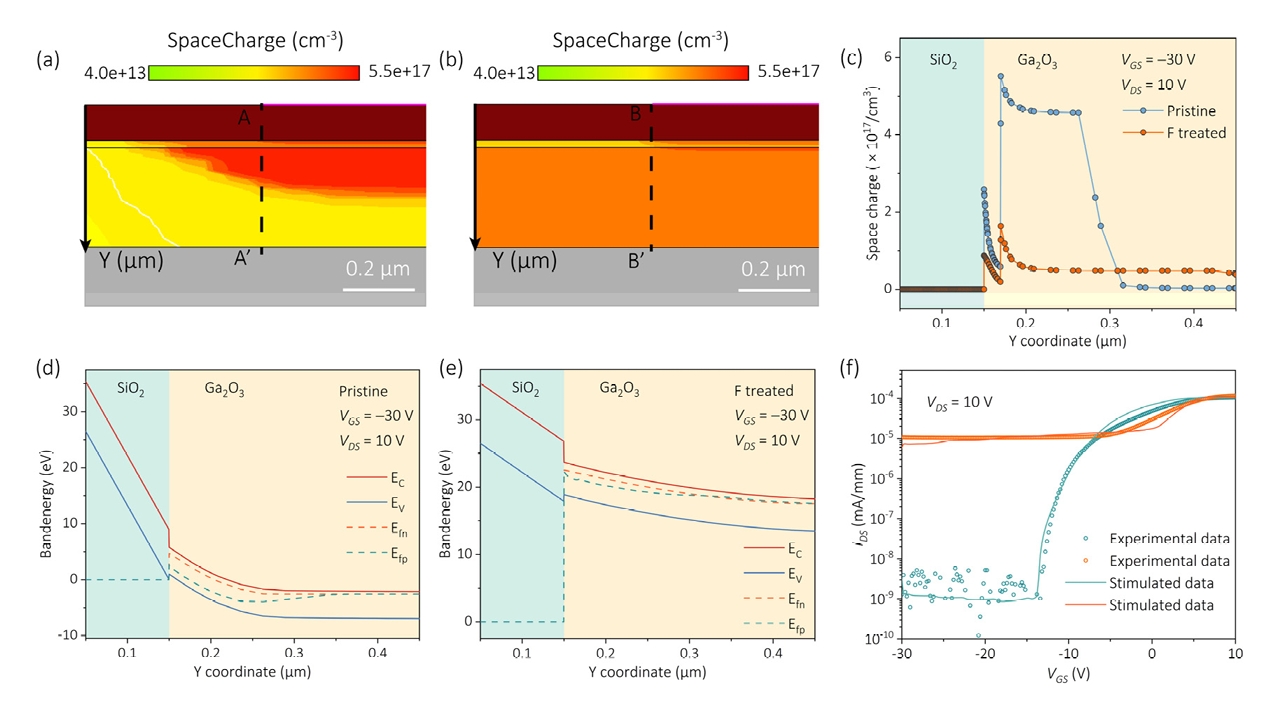
图8. β-Ga2O3 MOSFET 的 TCAD 模拟分析。(a,b)原始器件与 F 等离子体处理器件在 VGS = −30 V 和 VDS = 10 V 时的空间电荷分布。(c) 沿 AA' 与 BB' 剖面线测得的空间电荷分布剖面图。(d,e) 沿 AA' 与 BB' 剖面线提取的能带图。(f) 传输特性:TCAD 模拟曲线(实线)与实验数据(空心圆点)对比;绿色:氟等离子体处理器件;橙色:原始器件。
DOI:
doi.org/10.3390/nano15241896