

【国际论文】德国IKZ及新创公司NextGO Epi周大顺博士联合美国佛罗里达大学:Al成分对NiO/(AlₓGa₁₋ₓ)₂O₃异质结中带隙对齐现象的影响
日期:2026-01-08阅读:364
由德国IKZ研究所及新创公司NextGO Epi(周大顺博士)联合美国佛罗里达大学的研究团队在学术期刊 Journal of Vacuum Science & Technology A 发布了一篇名为Al composition dependence of band alignment in NiO / (AlxGa1−x)2O3 heterojunctions(Al成分对 NiO/(AlxGa1−x)2O3 异质结中带隙对齐现象的影响)的文章。
背 景
随着电力电子系统向高电压、高效率、高功率密度方向发展,传统的硅(Si)材料已接近物理极限。以氧化镓(Ga2O3)为代表的超宽禁带半导体,由于其极高的禁带宽度(约 4.8 eV)和理论击穿场强,被认为是继 SiC 和 GaN 之后的下一代功率半导体核心材料。通过引入铝(Al)形成三元合金 (AlxGa1−x)2O3(简称 AGO),可以进一步将禁带宽度从 4.8 eV 扩展到接近 8.8 eV(Al2O3)。AGO 被广泛用于调节器件的击穿电压,或在异质结场效应晶体管(HFETs)中通过能带阶跃形成二维电子气(2DEG)。氧化镓及其合金目前面临最大的技术难题是缺乏有效的 p 型掺杂,这限制了双极型功率器件(如 PN 二极管)的发展。p 型 NiO 具有约 3.6–4.0 eV 的带隙,是目前与 n 型 Ga2O3 或 AGO 结合形成异质结最理想的 p 型候选材料。异质结界面的价带偏移(VBO)和导带偏移(CBO)直接决定了空穴和电子的阻挡能力。准确了解随 Al 组分变化的能带结构,对于优化功率整流器的反向漏电流和高压稳定性至关重要,是器件理性设计的物理基础。
主要内容
本研究探讨了 p-NiO/n-(AlxGa1−x)2O3 异质结的电子能带对齐特性,该结构是下一代电力电子器件的潜在候选材料。通过金属有机物气相外延技术,在蓝宝石衬底上生长出铝含量各异的优质 β-(AlxGa1−x)2O3 薄膜(x=0.1、0.2、0.3),随后采用磁控溅射法沉积 p 型 NiO。采用 Kraut 法结合 X 射线光电子能谱技术,实验测定了能带偏移量。研究发现界面处呈现 II 型交错能带排列。测得价带偏移量 (VBO) 显着为负值,范围从 x=0 时的 −1.63 eV 至 x=0.3 时的 −1.29 eV。相反,导带偏移量 (CBO) 较小且随铝含量增加而减小,在最高铝含量时甚至呈现负值。巨大的负价带偏移为空穴创造了显着势垒,导致空穴在 NiO 层内强烈禁闭。这对垂直功率整流器尤为有利,可实现低反向漏电流与高击穿电压,从而突破传统肖特基整流器的重大局限。相反,微弱或负的导带偏移导致电子禁闭能力减弱,可能增加栅极漏电流,对横向场效应晶体管构成挑战。通过调控铝含量实现能带对齐的可调性,为理性器件设计开辟了新路径。本研究为开发高压 NiO/(AlxGa1−x)2O3 功率器件提供了关键实验数据,使其成为现有碳化硅和氮化镓技术的可行替代方案。
创新点
•由于存在巨大的 VBO,空穴被有效限制在 NiO 层中,这有助于大幅降低垂直功率整流器的反向漏电流并提高击穿电压,解决了传统肖特基整流器的重大缺陷。
•微弱或负值的 CBO 意味着该结构在抑制横向场效应晶体管(FETs)的栅极漏电流方面可能面临挑战。
•文章系统给出了铝组分对能带参数的影响规律,证明了通过精确控制 Al 组分可以裁制异质结性能,为高压功率器件提供了实验基准数据。
总 结
NiO/(AlxGa1−x)2O3 异质结是高压击穿器件的极具前景的候选材料,尤其适用于垂直整流器。该异质结为 Ga2O3 中缺乏便捷的 p 型掺杂问题提供了解决方案。通过采用具有良好带隙(约 3.6-4.0 eV)且易于掺杂的 p 型 NiO,可形成有效的 p-n 异质结。从能带偏移数据可见,该结具有显着的负价带偏移,从而形成强烈的空穴势垒。在反向偏压整流器中,该势垒有效阻断空穴流动,从而实现极低的反向漏电流。这种低漏电流特性对实现高击穿电压至关重要,因为过高的反向电流常导致过早击穿。
此外,引入铝元素形成 (AlxGa1−x)2O3 合金可进一步优化器件性能。合金增大的带隙可提升载流子的有效势垒,并有助于调控器件内部电场分布,从而进一步提高击穿电压。最新研究取得显着进展:垂直 NiO/Ga2O3 整流器展现出超过 8 kV 的击穿电压,而横向整流器亦突破 7 kV 大关。该性能使其跻身新一代电力电子器件前沿,往往超越竞争对手 SiC 和 GaN 器件的性能。巨大的带隙偏移结合精密器件设计(如结点延伸),使这种异质结成为高压应用的高效结构。

图1. 用于确定 (a) Ga2O3、(b) (Al0.1Ga0.9)2O3、(c) (Al0.2Ga0.8)2O3及(d) (Al0.3Ga0.7)2O3中体积基准(VBM)的 XPS 数据

图2. 通过 O 1s 光电子能谱中等离子体损耗特征的起始点测定的 (a) Ga2O3、(b) (Al0.1Ga0.9)2O3、(c) (Al0.2Ga0.8)2O3 及 (d) (Al0.3Ga0.7)2O3 的带隙。强度以任意单位(a.u)表示。

图3. NiO/(AlxGa1−x)2O3 异质结的核能级 XPS 光谱,其中 (a) x = 0,(b) x = 0.1,(c) x = 0.2,(d) x = 0.3。
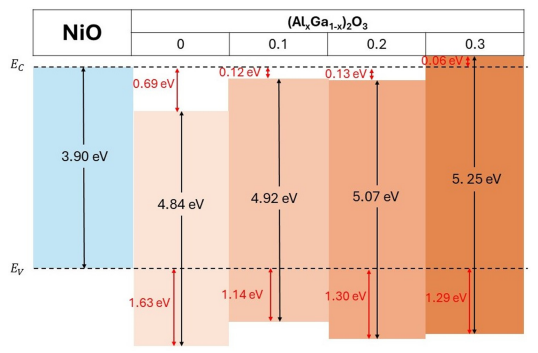
图4. 通过溅射法沉积 NiO 层的 NiO/(AlxGa1−x)2O3 异质结能带图。
DOI:
doi.org/10.1116/6.0005029