

【国内论文】APL丨福州大学张海忠教授联合上海光机所齐红基研究员:通过优化MOCVD掺杂工艺实现高质量β-Ga₂O₃同质外延薄膜
日期:2026-01-20阅读:347
福州大学张海忠教授联合上海光机所齐红基研究员、陈端阳高级工程师等人组成的研究团队,在学术期刊 Applied Physics Letters 发表了题为《Achieving high carrier concentration β-Ga2O3 epilayers via MOCVD using SiCl4 as dopant》的论文。该研究得到了杭州富加镓业科技有限公司在外延薄膜生长方面提供的支持。
背 景
β-氧化镓(β-Ga2O3)因其超宽带隙(4.9 eV)和高Baliga性能指标(BFOM = 3444)被认为是下一代高性能光探测器和功率器件的理想候选材料。其大尺寸单晶衬底的制备能力进一步提升了工业化应用潜力。近年来,通过优化外延生长模式和精确掺杂控制,β-Ga2O3外延层的晶体质量和电学性能已得到显著提升,为各类高性能Ga2O3基器件的实现奠定了基础。然而,在(100)晶面上实现兼具高载流子浓度和高迁移率的外延层仍是一大挑战,这对于制备透明电极和实现功率器件的欧姆接触都至关重要。在高载流子浓度下,晶格畸变、自补偿效应及掺杂相关缺陷,都会严重限制外延层的迁移率。
尽管离子注入技术可以获得高载流子浓度的外延层,但该过程会引入晶格损伤,影响高压或高辐射下器件稳定性。相比之下,原位掺杂被认为是更可行的方法。通过非故意斜切的(100)面β-Ga2O3衬底和精确热动力学调控实现台阶流模式外延,能够有效抑制孪晶和堆垛缺陷,从而改善晶体质量。Si因其较高的掺入效率,成为n型掺杂的首选元素。其中,四氯化硅(SiCl4)作为一种高效的Si前驱体,在高掺杂浓度下的表现优于硅烷(SiH4),可实现载流子浓度大于1019 cm-3 且迁移率高于50 cm2·V-1·s-1的高质量外延层。该方法为低成本制备透明导电电极和高性能功率器件的欧姆接触提供了有效途径。
主要内容
鉴于(100)晶面是目前大尺寸氧化镓衬底的主流选择,为提升该晶面外延层在高载流子浓度下的电学性能,本研究采用了非故意斜切的(100)衬底,并通过协同优化热力学、动力学条件,实现了具有理想表面形貌的台阶流模式同质外延生长;并在去除表面硅污染后,使用SiCl4进行原位掺杂。结果显示,SiCl4可有效制备高载流子浓度外延层,所得薄膜兼具高结晶质量与低表面粗糙度,且在260–800 nm宽光谱范围内实现>80%的高光学透过率。在SiCl4掺杂通量为10.4 nmol/min时,该同质外延层表现出卓越电学性能,其载流子浓度为1.32×1019 cm-3,迁移率可达55.5 cm2·V-1·s-1。这一结果不仅优于此前在(100)面衬底上生长的外延结果,亦可媲美在(010)晶面上实现的最优指标。
研究亮点
● 引入新型高效掺杂源:在MOCVD同质外延生长β-Ga2O3的过程中,采用SiCl4作为n型掺杂源,并验证了其在重掺条件下优异的电学调控能力与工艺稳定性。
● 构建洁净外延体系:在非故意斜切的(100)β-Ga2O3衬底上,先引入一层氮掺杂同质外延缓冲层,有效抑制了衬底表面残留Si污染,为后续精确可控的Si掺杂提供了洁净的外延生长界面。
● 实现高质量(100)面台阶流生长:通过系统优化热力学与动力学生长条件,在最具产业化前景的(100)面衬底上实现原子级平整的台阶流生长模式,获得晶体质量优异、缺陷显著抑制的同质外延氧化镓薄膜。
● 刷新 (100) 面导电性能纪录:在载流子浓度为1.32×1019 cm-3条件下,实现了高达55.5 cm2·V-1·s-1的电子迁移率,对应导电率达到117 S/cm,该数值较此前在同类(100)面衬底上报道的最高值提升了约160%。
● 验证简并掺杂下的金属化传导机制:通过变温霍尔效应测试证实,SiCl4掺杂使β-Ga2O3进入简并半导体状态,载流子浓度超过Mott金属–绝缘体转变的临界值,表现出稳定的类金属导电特性。
总 结
本研究首先在非故意斜切的半绝缘Fe掺杂β-Ga2O3衬底上生长了高质量、具有台阶流形貌的氮掺杂同质外延层,建立了无表面硅污染的外延体系。随后,在MOCVD生长过程中引入SiCl4作为高效原位硅掺杂源,实现了高光学透过率、表面光滑且结晶质量优异的β-Ga2O3同质外延层。结果分析表明,当SiCl4通量低于20.4 nmol/min时,外延层的质量能够得以保持。生长的一系列载流子浓度超过1×1019 cm-3的硅掺杂同质外延层,即使在20 K下也表现出理想的欧姆接触。以上结果表明,SiCl4是β-Ga2O3的高效n型掺杂源,为低成本制备透明导电电极和高性能功率器件的欧姆接触提供了有效指导。
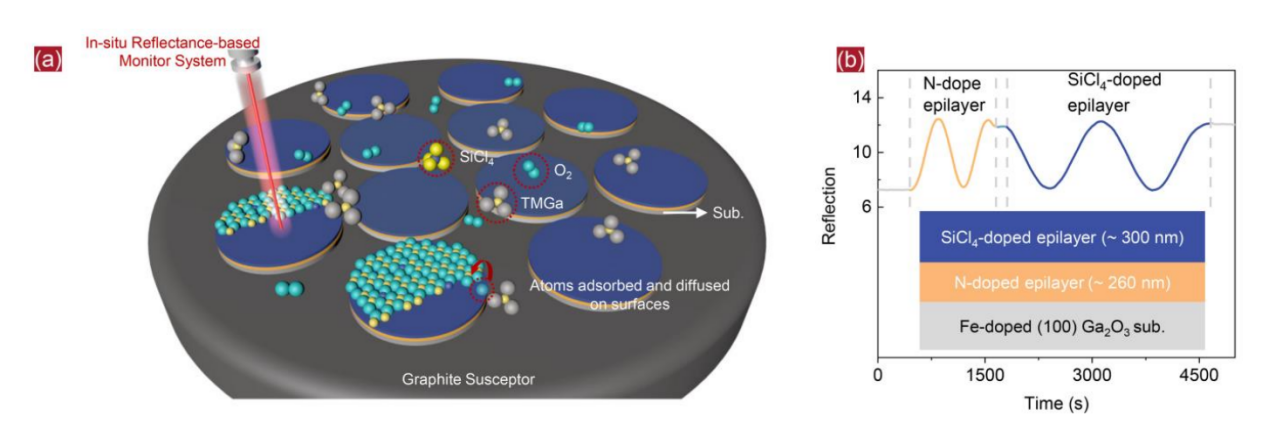
图 1 (a) 配备原位监测系统的MOCVD系统示意图。 (b) 原位监测系统记录的反射率曲线。黄色曲线表示N掺杂层的生长曲线,蓝色曲线表示SiCl4掺杂外延层的生长曲线。插图显示了薄膜结构的示意图。

图 2 (a) 生长在非故意斜切(100)面β-Ga2O3衬底上的N掺杂同质外延层的表面形貌。(b) (100)面N掺杂同质外延层的XRD 2θ–ω图。(c) N掺杂外延层及Fe掺杂衬底的XRC图。(400)衍射峰的FWHM:Fe掺杂衬底57.6 arcsec,N掺杂外延层54 arcsec。(d) SiCl4掺杂通量为20.4 nmol/min 的Si掺杂同质外延层的AFM图像。 (e) SiCl4掺杂通量为20.4 nmol/min时,同质外延层的XRD 2θ–ω;所有衍射峰均属于β-Ga2O3 <100>。 (f) SiCl4掺杂通量为20.4 nmol/min时,同质外延层的 XRC图,其(400)衍射峰FWHM为54 arcsec。

图 3 (a)–(f) 分别为在 SiCl4 通量为 7.46、10.6、20.4、34.6 和 46.2 nmol/min 条件下生长的 Si 掺杂同质外延层的 AFM 图像。(e) 和 (f) 的插图显示了沿主图中白色线条对应样品的横截面轮廓。

图 4 (a) XRD 2θ–ω扫描结果,样品分别对应SiCl4通量为7.46 nmol/min(样品A)、20.4 nmol/min(样品C)和34.6 nmol/min(样品D)。(b)–(d) 样品A、C和D的同质外延层倒易空间映射图(RSM)。
DOI:
doi.org/10.1063/5.0304883