

【国际论文】APL丨日本京都大学:雾化学气相沉积法生长的高电子迁移率Ge掺杂α-Ga₂O₃薄膜
日期:2026-01-26阅读:265
由日本京都大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为Mist-chemical vapor deposition grown Ge-doped α-Ga2O3 thin films with high electron mobility(雾化学气相沉积法生长的高电子迁移率 Ge 掺杂 α-Ga2O3 薄膜)的文章。
背 景
氧化镓(Ga2O3)因其约 5 eV 的大禁带宽度,在功率电子、高频器件和紫外探测器领域具有巨大潜力。与最稳定的 β 相相比,α-Ga2O3 拥有更宽的带隙(5.3–5.6 eV)和更高的理论击穿场强(9.5 MV/cm)。此外,它与蓝宝石衬底结构相同,便于异质外延生长。雾化学气相沉积(Mist-CVD) 被认为是生长 α 相最合适的方法之一。其环境中的羟基(-OH)有助于稳定 α 相,且该工艺在大气压下进行,使用水溶液作为原料,具有高成本效益和能源效率。由于 α-Ga2O3 与蓝宝石之间存在晶格失配,外延层通常含有极高密度的位错。这些位错会充当受体型陷阱并散射电子,导致材料在低载流子浓度时的迁移率急剧下降甚至趋于零,严重限制了其在功率器件中的应用
主要内容
在衬底温度 600 ℃、生长速率 3.3 μm/h 的条件下,通过雾化学气相沉积法在 m 面蓝宝石衬底上生长出非故意掺杂和锗掺杂的 α-Ga2O3 薄膜。室温下的霍尔效应测量表明,无意掺杂薄膜的载流子浓度较低,为 3×1016 cm-3;而掺锗 α-Ga2O3 薄膜的载流子浓度为 5.8 × 1017 cm−3,其最高电子迁移率达到 99 cm2 V−1 s−1。温度依赖性霍尔效应测量阐明了传输机制:在载流子浓度分别为 1.7 × 1017 和 5.8 × 1017 cm−3 的薄膜中,低温下位错和电离杂质引起的散射占主导地位,而室温附近电子散射的主要来源则是极性声子。本文制备的掺锗薄膜中,穿透螺钉位错和边缘位错的平均密度分别为 6.0 × 108 和 1.1 × 109 cm−2,均低于迄今在蓝宝石衬底上生长的 α-Ga2O3 薄膜。通过降低位错密度实现的低载流子浓度和高电子迁移率,表明 α-Ga2O3 在电力电子和高频器件领域具有广阔的应用前景。
结 论
采用雾化学气相沉积法在 600 ℃ 生长温度和 3.3 μm/h 生长速率下,于 m 面蓝宝石衬底上成功生长出 UID 及掺锗 α-Ga2O3 薄膜。UID α-Ga2O3 薄膜实现了低载流子浓度(3 × 1016 cm-3)。当载流子浓度为 5.8 × 1017 cm-3 时,电子迁移率最高达 99 cm2 V-1 s-1。本研究中载流子浓度高于 1017 cm-3 的 α-Ga2O3 薄膜在室温下的迁移率,可与相同载流子浓度的 β-Ga2O3 薄膜迁移率相媲美。温度依赖性霍尔效应测量结果表明,随着载流子浓度增加,主导散射因子从位错散射转变为电离杂质散射。通过XRD摇摆曲线估算,本 α-Ga2O3 薄膜中的穿透型位错和螺位错密度分别为 6.0 × 108 和 1.1 × 109 cm-2。这些数值与具有缓冲层的 α-Ga2O3 薄膜相当。如上所述,较低的位错密度导致低载流子浓度下更高的迁移率。这些结果证明了 α-Ga2O3 在高压高频电力电子器件应用中具有广阔前景。

图1. (a) 掺锗 a-Ga2O3 薄膜制备后及储存 1.5 年后的 XRD 2θ/x 曲线。 (b) 室温下载流子浓度与源溶液中 [Ge]/[Ga] 摩尔比的关系曲线。(c) Ga2O3 薄膜在室温下迁移率与载流子浓度的关系图。彩色实心符号分别对应本文制备的异质外延 α-Ga2O3 薄膜及先前报道的样品,黑色空心符号表示先前报道的同质外延 β-Ga2O3 薄膜。

图2. (a) 样品#1(nRT = 1.7 × 1017 cm-3 , lRT = 89 cm2 V-1 s-1)和样品#2(nRT = 5.8 × 1017 cm-3 , lRT = 99 cm2 V-1 s-1)的载流子浓度随温度变化曲线。圆点表示实验测得的载流子浓度,虚线表示根据电荷中性方程计算的载流子浓度。(b)和(c)样品#1与#2的迁移率随温度变化曲线。圆点表示实验测得的迁移率。虚线分别表示声学变形势散射(μADP)、极性光学声子散射(μPOP)、电离杂质散射(μII)及位错散射(μdis)条件下计算的迁移率。实线为基于马蒂森规则计算的总迁移率。
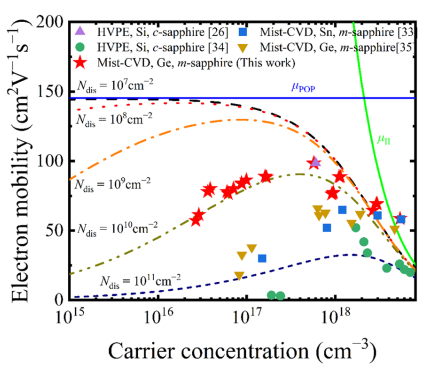
图3. α-Ga2O3 在室温下载流子浓度函数的实验获得的迁移率(符号)与计算的总迁移率(虚线)。图中展示了针对位错密度(Ndis)为 107, 108, 109, 1010 和 1011 cm-2 计算得到的迁移率。实线分别表示极性声子散射(μPOP)和电离杂质散射(μII)条件下的载流子迁移率。

图4. 通过 X 射线摇摆曲线评估的不同 [Ge]/[Ga] 比值下生长的 UID 和掺锗 α-Ga2O3 薄膜的螺钉位错、边缘位错及总螺纹位错密度分布。
DOI:
doi.org/10.1063/5.0308320