

【会员论文】Nano Lett.丨中科院苏州纳米所仲云雷,西北工业大学冯溪渊:CVD生长超薄二维β-Ga₂O₃中的超高介电常数
日期:2026-01-28阅读:392
中科院苏州纳米所仲云雷,西北工业大学冯溪渊等人 发表题为 “Ultrahigh Dielectric Permittivity in Ultrathin 2D β‑Ga2O3 for Advanced Dielectric Applications ”于Nano letters上。
本研究首次报道了二维β-Ga₂O₃(β-氧化镓)在超薄(10 nm)尺度下展现出超高介电常数(k ≈ 150)的特性。通过光电响应与微观结构分析,发现该高介电性能源于氧空位有序结构的形成。基于该材料制备的金属-绝缘体-金属(MIM)电容器表现出优异的电学性能,包括低介电损耗(<0.02@100 kHz)、低漏电流(<10⁻⁷ A/cm²)、高工作频率(>20 MHz)以及超高循环耐久性(>10¹⁰次)。进一步,研究团队构建了以β-Ga₂O₃为栅介质的MoS₂场效应晶体管,展现出高开关比(>10⁶)、低亚阈值摆幅(68.1 mV/dec)、极低回滞(5.8 mV)和超低栅漏电流(~10⁻¹³ A)。该研究为下一代高k介电材料在逻辑与存储器件中的应用提供了新方向。
背景
随着半导体器件尺寸缩减至纳米级,传统SiO₂栅介质的物理厚度已逼近量子隧穿极限,导致漏电流激增与功耗上升。引入高介电常数(high-k)材料成为延续摩尔定律的关键策略。尽管HfO₂等材料已被广泛应用,其介电常数通常仅为~50,难以满足未来更高集成度与更低功耗的需求。因此,开发新型高k材料,尤其在二维尺度下仍能保持高介电性能,是当前研究热点。β-Ga₂O₃作为一种超宽带隙半导体,具备良好的热稳定性与化学稳定性,但其在二维尺度下的介电性能尚未被系统研究。
主要内容
本研究系统探究了二维β-Ga₂O₃在超薄尺度下的介电性能,发现其在10 nm厚度下仍具备高达~150的介电常数,远超现有主流高k材料。通过光电响应测试发现其具有显著持续光电导(PPC)效应,表明材料中存在深能级缺陷,主要为氧空位(VO)。进一步通过高分辨透射电子显微镜(HRTEM)与快速傅里叶变换(FFT)分析,发现材料内部存在有序的氧空位超结构,破坏了局部晶体对称性,诱导出强局域偶极矩,从而显著增强介电极化响应。
基于该材料制备的MIM电容器在1 kHz–1 MHz频率范围内展现出稳定的介电常数(~150)与极低的等效氧化层厚度(EOT ≈ 0.6 nm),介电损耗在100 kHz下低于0.02,漏电流密度低于10⁻⁷ A/cm²。器件在±2V、50 ns脉冲下循环超过10¹⁰次后性能无明显退化,击穿电场高达~7 MV/cm,表现出优异的耐久性与可靠性。
进一步,研究团队构建了MoS₂/β-Ga₂O₃异质结构FET,采用~25 nm厚的β-Ga₂O₃作为顶栅介质。该器件展现出高达10⁶的开关比,亚阈值摆幅为68.1 mV/dec,回滞仅为5.8 mV,栅漏电流低至10⁻¹³ A,表现出接近理想的栅控能力与界面质量。即使在沟道长度缩短至40 nm时,器件仍保持良好的开关特性与低DIBL(~−42.2 mV/V),验证其在高集成度逻辑器件中的应用潜力。
实验细节概括
β-Ga₂O₃纳米片通过常压化学气相沉积(CVD)方法合成,前驱体为金属镓粉,生长温度1000°C,云母衬底置于下游8 cm处,氩气/CO₂混合气体作为载气,生长时间10分钟。所得样品呈规则矩形,厚度均匀,拉曼光谱显示其特征峰与单斜相β-Ga₂O₃一致。
MoS₂ FET器件制备采用机械剥离法将MoS₂转移至预图形化的源漏电极上,再通过PDMS辅助干法转移β-Ga₂O₃片作为栅介质,最后通过电子束光刻与热蒸发制备顶栅电极。所有电学测试在真空(10⁻⁴ Torr)下进行,转移特性测试栅压范围为±3 V,漏压范围为0–3 V。亚阈值摆幅与回滞通过双扫Id-Vg曲线提取,栅漏电流同步监测。
创新点
1.首次发现二维β-Ga₂O₃在超薄尺度下具备超高介电常数(~150),远超现有高k材料。
2.揭示氧空位有序结构为高介电性能的起源,通过HRTEM与FFT确认其诱导局域偶极矩增强极化响应。
3.构建基于β-Ga₂O₃的MIM电容器,实现超低EOT(~0.6 nm)、低损耗(<0.02)、高循环耐久性(>10¹⁰次)。
4.实现MoS₂/β-Ga₂O₃异质结构FET,展现出高开关比(>10⁶)、低SS(68.1 mV/dec)、极低回滞(5.8 mV)与超低栅漏电流(10⁻¹³ A)。
5.验证其在短沟道器件中的适用性,40 nm沟道长度下仍保持良好栅控能力与低DIBL(~−42.2 mV/V)。
结论
本研究首次揭示了二维β-Ga₂O₃在超薄尺度下的超高介电性能,并系统验证其在存储与逻辑器件中的应用潜力。通过氧空位有序结构的形成,材料展现出强极化响应与稳定的高介电常数。基于该材料构建的MIM电容器与MoS₂ FET器件均表现出优异的电学性能,满足未来高集成度、低功耗电子器件的需求。该研究不仅拓展了二维高k介电材料的研究边界,也为下一代逻辑与存储技术提供了新的材料平台。


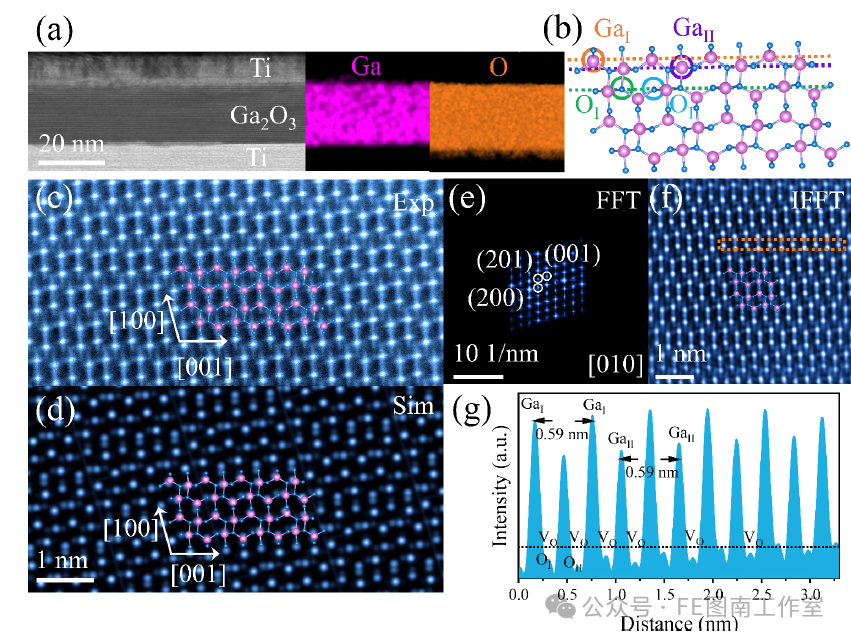

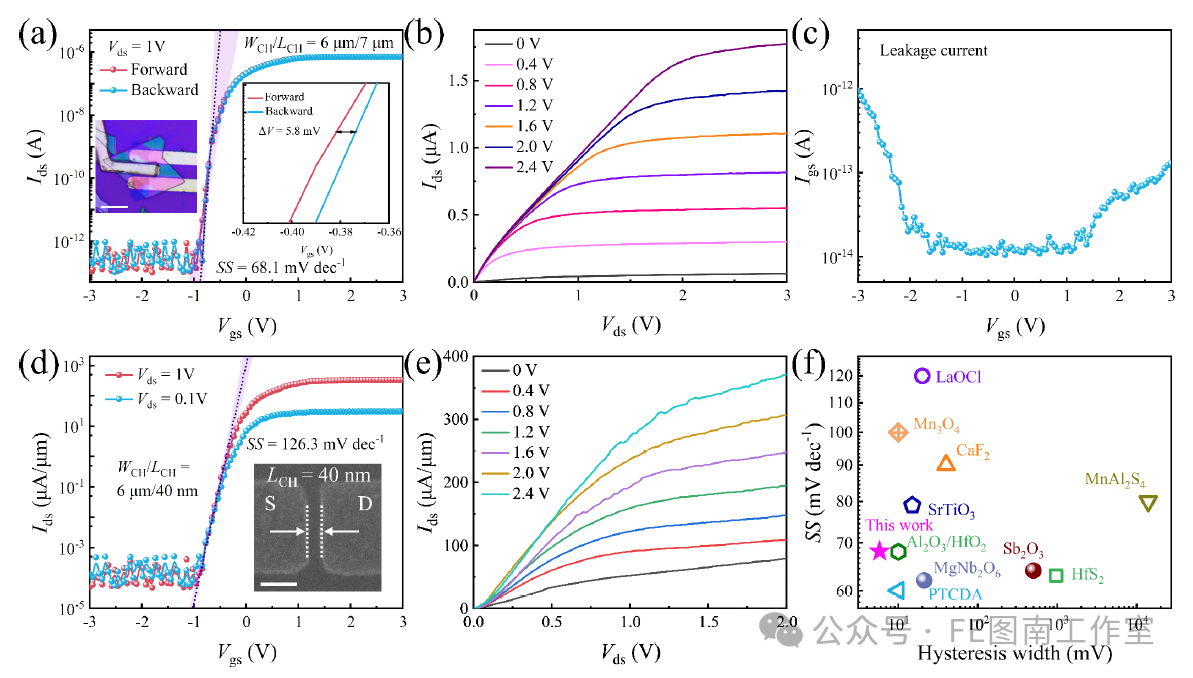
https://doi.org/10.1021/acs.nanolett.5c05733


