

【会员论文】AOM丨厦门大学张洪良教授团队:在GaN(0001)衬底上外延生长掺杂过量的氧化镓薄膜作为深紫外透明电极用于光电子学应用
日期:2026-02-04阅读:290
由厦门大学张洪良教授的研究团队在学术期刊 Advanced Optical Materials 发布了一篇名为Epitaxial Growth of Degenerately Doped Ga2O3 Films on GaN (0001) as a Deep Ultraviolet Transparent Electrode for Opto-Electronics Applications(在 GaN (0001) 衬底上外延生长掺杂过量的 Ga2O3 薄膜作为深紫外透明电极用于光电子学应用)的文章。
背 景
基于氮化镓(GaN)的深紫外(DUV,波长 200–300 nm)光电子器件,如发光二极管(LED)、激光二极管(LD)和日盲光电探测器,在杀菌消毒、水净化、生物检测及非视距光学通信等领域具有巨大的应用价值。目前 GaN 基 DUV LED 的外部量子效率(EQE)非常低,通常仅为 1% 左右 。其中一个主要限制因素是缺乏高性能的深紫外透明导电电极。目前常用的透明导电氧化物(TCO),如铟锡氧化物(ITO)、氟掺杂氧化锡(FTO)和铝掺杂氧化锌(AZO),其禁带宽度通常小于 3.5 eV。在深紫外波段(尤其是小于 280 nm),这些传统材料会发生严重的寄生吸收,变得不再透明,导致器件发出的光无法有效提取。β-Ga2O3 拥有约 4.85 eV 的超宽禁带,天然具有深紫外透明性。Si 原子替代 Ga 位点具有较低的形成能和激活能,且存在“共振掺杂”机制,极易实现简并掺杂和高电导率,是 DUV 透明电极的理想候选。
主要内容
基于氮化镓的深紫外(DUV)光电器件因在杀菌、生物检测及光通信领域的应用前景而备受关注。然而,现有 DUV 光电器件的性能受限于传统电极对深紫外光的透射不足。本研究报道了在氮化镓衬底上外延生长掺杂过量硅的氧化镓膜作为深紫外透明电极的可行性。掺杂 0.5 % 硅的 Ga2O3(n+-Ga2O3)薄膜在 280 至 400 nm 波长范围内展现出超过 85 % 的深紫外透射率。如此高的深紫外透光率归因于退化掺杂引发的 Burstein-Moss 效应,使 n+-Ga2O3 薄膜形成约 5.0 eV 的超宽带隙。此外,该薄膜与 GaN 界面接触电阻极低,仅为 1.96 × 10−4 Ω cm2。高分辨率 X 射线光电子能谱(XPS)研究表明,n+-Ga2O3 与 GaN 形成 II 型交错能带对齐结构,界面势垒仅 0.15 eV,带弯厚度仅数纳米。微小的势垒结合退化掺杂的 Ga2O3 薄膜,使 n+-Ga2O3/GaN 界面实现卓越的电接触性能与低接触电阻。本研究证明 n+-Ga2O3 可作为 GaN 基深紫外器件中深紫外透明电极的理想替代方案。
创新点
●简并掺杂导致的费米能级进入导带,引起了吸收边的蓝移,使禁带宽度从 4.82 eV 拓宽至 5.0 eV,从而进一步提升了深紫外波段的透明度。
●极低的势垒高度加上仅几纳米的窄能带弯曲区域,使得电子极易跨越界面,从而实现了优异的欧姆接触性能。
结 论
报道了在 (0001) 取向 GaN 衬底上外延生长 n+-Ga2O3 薄膜作为新型深紫外透明电极。n+-Ga2O3 薄膜具有卓越的光学性能,在 280-400 nm 波长范围内透光率超过 85%,这归功于 n+-Ga2O3 的超宽带隙(≈5.0 eV),该带隙通过 Burstein-Moss 效应进一步拓宽。此外,这些薄膜与 GaN 的接触电阻低至 1.96 × 10−4 Ω cm2。界面处的高分辨率 XPS 定量分析揭示,n+-Ga2O3/GaN 界面低接触电阻源于其优异的界面能量学特性:界面势垒仅 0.15 eV,带弯厚度仅数纳米。低势垒与窄带弯使载流子能通过隧道效应高效传输,从而建立良好的欧姆接触。优异的欧姆接触性能与高深紫外透射率表明,n+-Ga2O3 可成为 GaN 基深紫外器件的理想透明电极替代方案。但本研究中 n+-Ga2O3 薄膜的电阻率(≈0.17 Ω·cm)仍高于传统透明导电氧化物材料(10−4–10−3 Ω·cm)。为满足实际应用的电极要求,必须牺牲部分光学透明度并适当增厚电极层。这种基于性能折衷的权衡策略难以充分释放该深紫外透明电极的应用潜力。后续工作将聚焦于提升载流子迁移率与掺杂效率,以进一步优化其综合性能。
项目支持
本研究得到深圳市科学技术委员会(JCYJ20240813145501003)、国家自然科学基金委员会(22275154)和上海市科学技术委员会(25JD1404600)的资助。

图1. a) 基于 Al2O3 (0001) 衬底的GaN、n+-Ga2O3及n+-Ga2O3/GaN异质结样品的XRD衍射图谱。b) n+-Ga2O3薄膜、GaN薄膜及Al2O3衬底在(-401)、(10-11)和(11-26)晶面上的φ扫描图。c) n+-Ga2O3 (-201) 与 GaN (0001) 层从顶视角观察的外延关系示意图。d) n+-Ga2O3 薄膜的原子力显微镜图像。
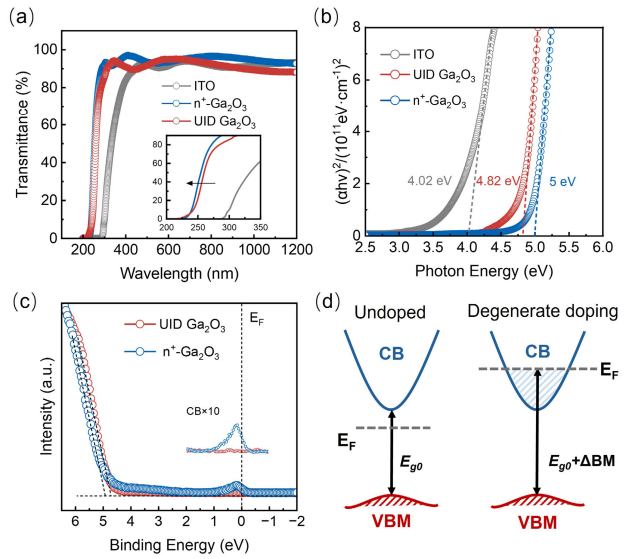
图2. a) n+-Ga2O3、UID Ga2O3 及 ITO在 Al2O3 (0001) 衬底上的光学透射率(插图:放大吸收边)。b) n+-Ga2O3、UID Ga2O3 及 ITO 在 Al2O3 (0001) 衬底上带隙外推的(α_hv)2 与 hv 关系曲线。c) n+-Ga2O3 与 UID Ga2O3 的虚带边(VBM)及 10 倍覆盖带边(CB)示意图。d) 未掺杂 Ga2O3 的示意电子结构,以及基于自由电子模型在简并掺杂后带隙的变化。
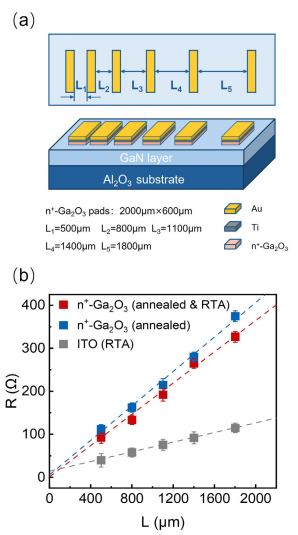
图3. a) 掩模结构与尺寸及 TLM 样品横截面示意图。b) 电阻随 n+-Ga2O3 与 ITO 电极间距变化曲线(误差条表示在相同条件下独立制备并处理的四个样品所得标准偏差)。
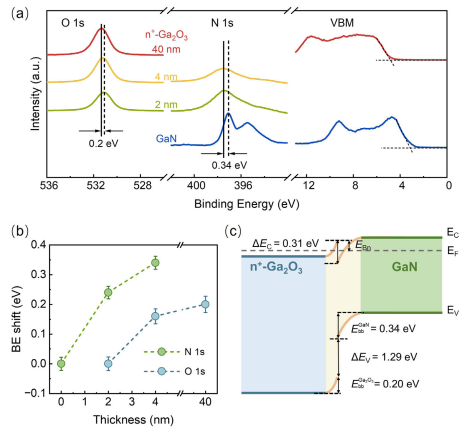
图4. a) 不同 n+-Ga2O3 覆盖层厚度下的核心能级与价带 XPS 光谱。GaN 及 40 nm 厚 n+-Ga2O3 的价带起始点(VBM)通过将价带前沿线性外推至基线确定。b) 核心能级峰的结合能 (BE) 偏移随 n+-Ga2O3 层厚度变化的曲线图(误差条表示多次数据拟合的标准偏差)。c) 通过 XPS 测定的 n+-Ga2O3/GaN 异质结能级图。
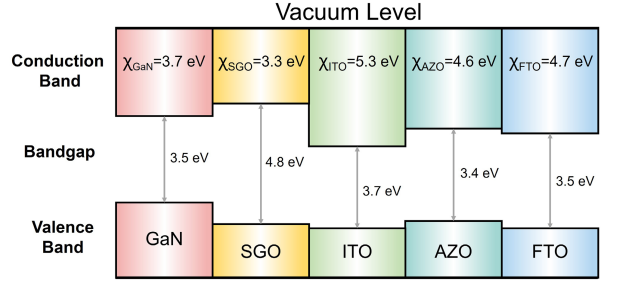
图5. 几种典型宽带隙半导体界面能带排列示意图。能量标度的原点位于真空能级。
DOI:
doi.org/10.1002/adom.202503337