

【会员论文】香港科技大学(广州)陈子强教授团队:p 型 β-Ga₂O₃ 外延薄膜生长及 p–n 二极管器件演示
日期:2026-03-19阅读:32
由香港科技大学(广州)陈子强教授的研究团队在学术期刊 Advanced Electronic Materials 发布了一篇名为 Epitaxial Growth of p-Type β-Ga2O3 Thin Films and Demonstration of a p–n Diode(p 型 β-Ga2O3 外延薄膜生长及 p – n 二极管器件演示)的文章。
背 景
虽然氧化镓(β-Ga2O3)在下一代功率电子器件领域极具潜力,但缺乏有效的 p 型掺杂始终是其发展的阻碍。由于氧化镓的价带顶主要由 O - 2p 轨道构成,导致空穴有效质量极大且具有强烈的局域化倾向,难以实现有效的空穴导电。长期以来,研究者不得不使用 NiO 等外源 p 型氧化物构建异质结,但这会引入晶格失配和界面能级偏移等问题。因此,实现同质 p 型氧化镓的生长是开发高性能单片集成氧化镓功率器件(如同质 p - n 结、JFET)的先决条件。
主要内容
β-Ga2O3 凭借其超宽带隙(约 4.9 eV)和成熟的 n 型导电性,成为下一代功率电子器件的有前景的半导体材料。然而,由于传统掺杂剂的深受主能级,实现稳定的 p 型掺杂仍是一项基本挑战。本文通过金属有机化学气相沉积(MOCVD)开发了一种 Te – Mg 共掺杂策略,以克服这一限制。共掺杂薄膜的室温电阻率为 32.4 Ω·cm,霍尔空穴浓度为 1.78 × 1017 cm−3,在较低载流子浓度(5.72 × 1014 cm−3)下,迁移率高达 5.29 cm2 V−1 s−1。初步的 p – n 二极管成功展示。密度泛函理论(DFT)计算表明,Te 的掺入在价带最大值(VBM)附近引入了一个中间带,有效降低了 Mg 受主的电离能。光谱分析进一步证实了通过 Te – Ga 轨道杂化导致的 VBM 提升以及费米能级向价带的移动,这与 p 型行为一致。这些结果为实现在 β-Ga2O3 上同质外延生长 p 型材料开辟了一条可行途径,并为未来优化电阻率至低于 1 Ω·cm 以及更深入地理解 Te – Mg 掺杂机制奠定了基础,为超宽带隙电子器件中的双极器件应用铺平了道路。
研究亮点
● 研究团队利用金属有机气相外延(MOVPE)技术,通过引入特定的受体杂质,成功在(010)面 β-Ga2O3 衬底上外延生长出具有稳定空穴导电性的 p 型氧化镓薄膜。
● 首次演示了基于全氧化镓材料的 p - n 同质结二极管。相比于传统的异质结,该同质结具有更优异的晶格匹配度和热稳定性,有效降低了界面处的电荷复合。
● 实验测得该 p - n 结表现出明显的整流行为,整流比达到高数量级,且开启电压(Turn-on voltage)与 β-Ga2O3 的理论带隙值高度吻合,证明了 p 型层的高质量。
● 通过霍尔效应测量确认了空穴作为主要载流子的输运特性,并详细研究了受体能级的深度。结果表明,通过精细的生长工艺控制,可以克服空穴局域化,实现室温下的有效导电。
● 该研究为实现氧化镓基的高压、高功率集成电路扫清了最大障碍,特别是对于需要 p 型区域来进行电场调控的垂直型功率器件具有里程碑意义。
总 结
通过金属有机化学气相沉积(MOCVD)技术,采用碲(Te)和镁(Mg)共掺杂的方法实现了 β-Ga2O3 的 p 型导电性,旨在解决这种超宽带隙半导体材料中一直存在的挑战。采用此策略制备的薄膜表现出可调的空穴导电性,测得的室温载流子浓度范围为 5.72 × 1014 至 1.78 × 1017 cm-3,相应的电阻率在 2064 至 32.4 Ω·cm之间。在低载流子浓度条件下,测得的迁移率为 5.29 cm2/V·s。塞贝克(Seebeck)测量证实了该薄膜为 p 型半导体,具有正塞贝克系数。使用这种共掺杂的 p 型薄膜制备的基本 PN 二极管成功展示了整流能力。互补的密度泛函理论(DFT)建模和能带分析提供了一种潜在机制,该机制旨在通过价带顶附近的中间带,同时降低镁受主电离势垒并提升价带顶。光谱数据(X 射线光电子能谱(XPS)、紫外 - 可见光谱(UV - vis))显示,费米能级向价带移动,与 p 型行为一致。虽然这些结果证明了碲 - 镁共掺杂途径的潜力,但仍存在关键挑战,如将电阻率大幅降低至 1 Ω·cm以下,以及提高掺杂效率。因此,未来的工作将集中在优化共掺杂参数、探索后生长处理以及进行稳健的电学验证上。本研究为实现 p 型 β-Ga2O3 提供了一条途径。
项目支持
本工作得到了香港科技大学(广州)陈子强初创基金、广州市科技计划项目(编号:2023A03J0003、2023A03J0013、2023A04J0310和2023A03J0152)、广东省教育厅(编号:2024ZDZX1005)、香港科技大学(广州)表征与制备设施(MCPF)以及绿色材料实验室的支持。
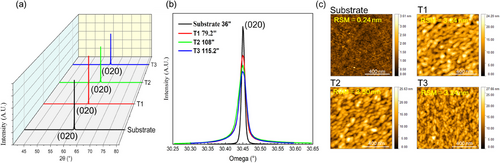
图1. (a) X 射线衍射(XRD)2θ – ω 扫描。(b) XRD 摇摆曲线。(c) Fe - Ga2O3 基底和样品 T 1 至 T 3 的表面形貌(1 µm × 1 µm),通过原子力显微镜(AFM)扫描得到。

图2. (a) 范德堡配置下霍尔测量的示意图。(b) 在磁场从 – 9 T 变化到 9 T 的过程中测得的霍尔电压,(c) 平均霍尔电压,以及(d) 样品 T 3 的计算霍尔系数。
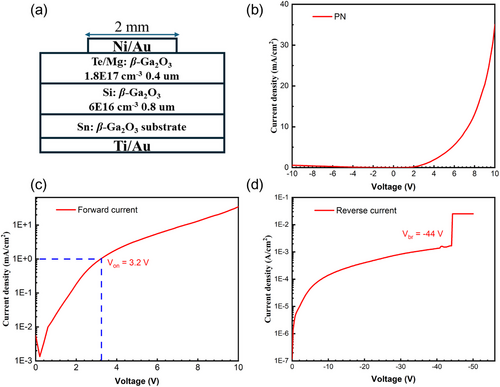
图3. (a) PN 二极管的示意结构。从 - 10 到 10 V 的 I – V 曲线(b),PN 二极管的正向电流(c),以及 PN 二极管的反向电流(d)。

图4. β-Ga2O3超晶胞的模型图,(a)未掺杂,(b)GaI 位点掺杂 Te,(c)GaII 位点掺杂 Te,(d)OI 位点掺杂 Te,(e)OII 位点掺杂 Te,以及(f)OIII 位点掺杂 Te。

图5. 计算得到的β-Ga2O3(a)未掺杂和在不同氧位掺杂 Te 后的有效能带结构和态密度:(b)OI,(c)OII,以及(d)OIII。
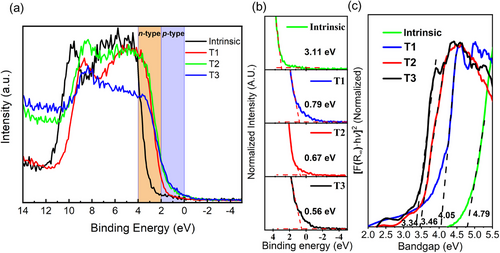
图6. (a)为 VB – XPS 图,(b)为 VB 边缘能量拟合的局部放大图。(c)为通过紫外 - 可见漫反射光谱得到的 Tauc 图。
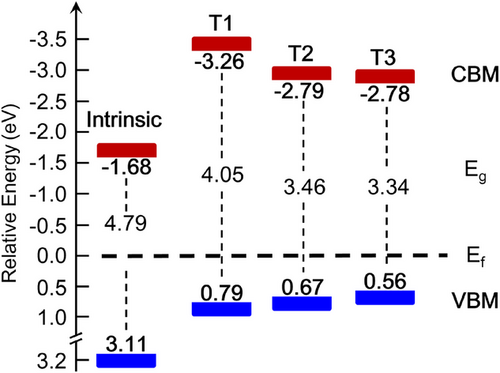
图7. 本征样品和 Te/Mg 共掺杂样品的能带结构示意图。
DOI:
doi.org/10.1002/aelm.202500719