

【会员论文】厦门大学、湖南大学、湖南科技学院团队:通过硅掺杂和双轴应变调控铁电闪锌矿相 Ga₂O₃ 单层的结构、电子及输运性质
日期:2026-04-14阅读:83
由厦门大学、湖南大学、湖南科技学院的研究团队在学术期刊 Materials Science & Engineering: B 发布了一篇名为Tuning the structural, electronic, and transport properties of ferroelectric‑zinc blende phase Ga₂O₃ monolayer by Si dopant and biaxial strain(通过硅掺杂和双轴应变调控铁电闪锌矿相 Ga₂O₃ 单层的结构、电子及输运性质)的文章。
背 景
二维 Ga₂O₃在柔性光电子器件中应用广泛,近期具有铁电闪锌矿相(FZB)的新型二维 Ga₂O₃单层被理论预测,但其电子结构与载流子迁移率的系统研究仍较为缺乏。与传统 β‑Ga₂O₃的强各向异性不同,FZB‑Ga₂O₃具有高对称性与各向同性特征。硅(Si)掺杂是调控 Ga₂O₃电子结构的有效手段,而应变工程可进一步实现能带与输运性能的连续调控。该团队基于第一性原理计算,系统研究了 Si 掺杂 FZB‑Ga₂O₃单层的结构稳定性、应变调控能带结构及载流子输运特性,旨在为新型二维宽禁带半导体的设计与应用提供理论支撑。
主要内容
二维材料在柔性光电子器件中展现出广泛的应用前景。近期,具有铁电闪锌矿相(FZB‑Ga₂O₃)的二维 Ga₂O₃ 晶体结构被理论预测,但其电子性质与载流子迁移率的深入研究仍较为匮乏。该团队采用 PBE 和 HSE 杂化泛函并结合形变势理论,系统研究了 Si 掺杂 FZB‑Ga₂O₃ 单层的结构稳定性、应变调控能带结构及载流子输运特性。Si 掺杂 FZB‑Ga₂O₃单层表现出有效的 n 型掺杂行为,PBE 计算带隙从 1.43 eV 增至 1.60 eV,HSE 计算带隙从 3.58 eV 增至 3.63 eV。施加−6% 压缩应变至 6% 拉伸双轴应变时,带隙显著减小约 1.4 eV;这源于由 O‑2p、Si‑3p、Ga‑3d 轨道 π 成键态主导的价带顶(VBM)相比由 Ga‑4s、Ga‑4p、Si‑3s、O‑2p 轨道杂化 σ* 反键态构成的导带底(CBM)发生更快上移。经应变调控后,x 方向电子迁移率 μₑₓ 从 655.21 cm² V⁻¹ s⁻¹ 变化至 929.43 cm² V⁻¹ s⁻¹,y 方向 μₑᵧ 从 703.48 cm² V⁻¹ s⁻¹ 变化至 1037.29 cm² V⁻¹ s⁻¹。在 0~6% 拉伸应变范围内,4% 拉伸应变下电子迁移率达到最高,这归因于量子限制效应减弱。此外,迁移率各向异性比值在 1.07~1.21 之间,表明 Si 掺杂 FZB‑Ga₂O₃单层因高结构对称性而具有强各向同性电子迁移率,区别于 β‑Ga₂O₃的显著各向异性。因此,Si 掺杂 FZB‑Ga₂O₃单层优异的稳定性、应变可调的电子性质及高各向同性电子迁移率,凸显了其在纳米尺度光电子器件中的巨大应用潜力。
研究亮点
•首次系统研究 Si 掺杂铁电闪锌矿相 FZB‑Ga₂O₃单层的结构、电子与输运性质。
•证实 Si 择优占据六配位 GaII 位点,材料兼具优异动力学与热稳定性。
•揭示双轴应变对带隙的连续调控机制,带隙可调范围高达~1.4 eV。
•实现高各向同性、高电子迁移率(最高达 1037.29 cm² V⁻¹ s⁻¹)。
•阐明量子限制效应与结构对称性对载流子输运的调控规律。
总 结
该团队采用 PBE、HSE 泛函与形变势理论,研究了 Si 掺杂 FZB‑Ga₂O₃单层的结构稳定性、应变调控能带结构及载流子输运性质。Si 掺杂原子择优占据六配位 GaII 位点,而非 Si 掺杂解理二维 β‑Ga₂O₃中的四配位 GaI 位点,这源于局域结构与 Ga 原子位置的差异。电荷密度差表明 Si 杂质向 SiGaⅡ 单层结构中失去 3.09e 电荷,电荷发生显著重新分布。Si 掺杂后的能带结构表现出有效的 n 型掺杂行为,带隙小幅提升至~3.6 eV,使其在柔性紫外探测器中具有应用前景。施加 ±6% 双轴应变调控,带隙从 4.05 eV 降至 2.65 eV,主要源于与成键态变化相关的 VBM 相比 CBM 更快上移。在 Si 掺杂 FZB‑Ga₂O₃单层中,CBM 由 Ga‑4s、Ga‑4p、Si‑3s 与 O‑2p 轨道杂化形成的 σ反键态构成,而 VBM 由 O‑2p、Si‑3p 与 Ga‑3d 轨道形成的 π 成键态主导。增大拉伸或压缩应变可分别抬升 σ反键态与降低 π 成键态,进而导致 CBM 与 VBM 的能量升高或降低。当压缩应变从−6% 变化至 6% 时,μₑₓ从 655.21 cm² V⁻¹ s⁻¹ 变化至 929.43 cm² V⁻¹ s⁻¹,μₑᵧ从 703.48 cm² V⁻¹ s⁻¹ 变化至 1037.29 cm² V⁻¹ s⁻¹。SiGaⅡ 单层在 4% 拉伸应变下 μₑₓ与 μₑᵧ达到最高,这可由导带底空间电荷分布所反映的量子限制效应减弱来解释。此外,电子迁移率各向异性在 1.07~1.21 之间,表明二维 SiGaⅡ 单层具有强各向同性,区别于二维 β‑Ga₂O₃的强各向异性。此外,该团队预测在 SiC、Si (111)、蓝宝石、GaN、AlN、ZnO 等常见六方衬底中,SiC 衬底可实现最高电子迁移率。总体而言,Si 掺杂 FZB‑Ga₂O₃单层优异的稳定性、应变可调的电子性质及高各向同性电子迁移率,凸显了其在柔性电子及其他纳米光电子器件中的强大应用潜力。然而,一个潜在的挑战在于,鉴于平坦的价带顶(VBM),难以实现有效的 p 型 FZB-Ga₂O₃。

图 1. (a) 视角图与 (b) 俯视图展示的 Si 掺杂 FZB‑Ga₂O₃单层结构;(c) SiGaⅡ 单层结构的声子色散谱;(d) 300 K、(e) 500 K、(f) 700 K 下 SiGaⅡ 单层结构的 AIMD 模拟,图1(d-f)中的插图为弛豫结构。

图 2. (a) SiGaⅡ 单层的电荷密度差(等值面 0.005 e/ų,青色与黄色分别代表电荷得失);(b) SiGaⅡ 单层的电子定域函数 ELF;(c) 价带顶 VBM 与 (d) 导带底 CBM 的分波电荷密度(等值面 0.001 e/ų)

图 3. (a) 纯 FZB‑Ga₂O₃ 与 (b) SiGaⅡ 单层在 PBE 与 HSE 方法下的能带结构;(c) SiGaⅡ 单层的 PDOS 与 (d) 归一化 PDOS(Ga,O,Si 轨道)。
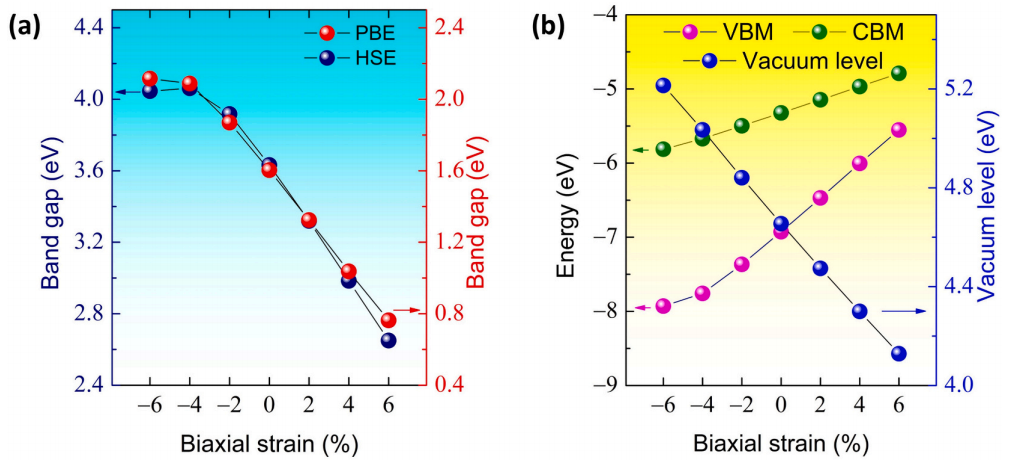
图 4. (a) SiGaⅡ 单层带隙随双轴应变的变化关系;(b) 真空能级及 VBM、CBM 随应变的演化。

图 5. (a) 不同双轴应变下 SiGaⅡ 单层的电子迁移率与 (b) 各向异性;不同应变下 CBM 分波电荷分布:(c) −4%、(d) −2%、(e) 2%、(f) 4%(等值面 0.001 e/ ų)
DOI:
doi.org/10.1016/j.mseb.2026.119405