

【国际论文】美国空军研究实验室、康奈尔大学、KBR 公司:在(010)取向 2英寸衬底上高产率制备高性能 β-Ga₂O₃ MOSFET
日期:2026-04-23阅读:56
由美国空军研究实验室、康奈尔大学、KBR 公司的研究团队在学术期刊 APL Electronic Devices 发布了一篇名为High-yield fabrication of high-performance β-Ga₂O₃ MOSFETs on a (010) 2″ substrate(在(010)取向 2 衬底上高产率制备高性能 β-Ga₂O₃ MOSFET)的文章。
背 景
β-Ga₂O₃是一种超宽禁带半导体,禁带宽度 4.8 eV,临界电场强度高,Baliga 优值显著优于 GaN 与 SiC,具备浅能级 n 型掺杂与大尺寸原生衬底两大优势,熔体生长技术成熟,已实现 6 英寸商用衬底。横向 β-Ga₂O₃ MOSFET 在射频与功率开关领域潜力突出,但此前 2 英寸级制备多聚焦单器件性能,未系统评估大尺寸衬底下的整体性能与良率,且 (−201) 晶向衬底不兼容快速外延生长。本研究在 2 英寸 (010) 晶向衬底上开展器件制备,验证规模化量产可行性。
主要内容
研究团队在 2 英寸 (010) 晶向衬底上制备了横向 β-Ga₂O₃ MOSFET,器件外围宽度 100 μm~2 mm,整体良率 84.5%(剔除边缘芯片后超 95%)。源漏间距设为 1、2、5 μm,采用再生长欧姆接触与缩比 T 型栅。1 μm 器件导通电阻低至 24 Ω・mm,5 μm 器件击穿电压高达 863 V。1、2、5 μm 器件的平均截止频率 fT 分别为 7±2、6±1、3.7±0.7 GHz,最高振荡频率 fmax 分别为 22±4、17±3、9±0.9 GHz。大信号工作下,2 mm 外围、2 μm 器件在 5 GHz 实现输出功率 467 mW(26.7 dB),为已报道氧化镓晶体管最高净射频功率。研究分析了器件整体性能,明确短沟道效应与栅泄漏等失效与性能退化机制,证明大尺寸衬底上高性能 β-Ga₂O₃ MOSFET 制备的可行性,并揭示量产技术壁垒。
创新点
● 首次在 2 英寸 (010) 晶向 β-Ga₂O₃ 衬底上实现高性能 MOSFET 高产率制备,整体良率 84.5%,剔除边缘芯片后超 95%。
● 5 μm 器件击穿电压达 863 V,功率优值比肩商用 SiC 器件;1 μm 器件导通电阻低至 24 Ω・mm。
● 实现氧化镓晶体管全球最高净射频功率:2 mm 外围器件在 5 GHz 输出 467 mW。
● 系统揭示栅泄漏、空气桥电镀失效、衬底 - 外延界面寄生 Si 沟道等量产限制因素。
结 论
研究团队在 2 英寸 (010) 晶向晶圆上成功制备含再生长欧姆接触的 β-Ga₂O₃ MOSFET,实现高良率与优异性能指标。器件性能达到当前国际一流晶体管水平,最优器件的 Baliga 优值与已报道器件相当,且高于硅单极极限。研究从单器件与整体角度分析了器件性能,明确沟道调制不良、栅泄漏、电镀失效、衬底 - 外延界面寄生 Si 等失效机制,并提出可行改进方案。本成果展现了横向 β-Ga₂O₃ MOSFET 当前量产水平,指明了氧化镓体系材料、工艺与器件持续优化的方向。
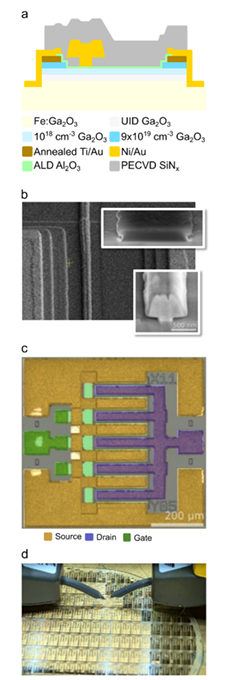
图 1 (a) MOSFET 器件的截面示意图。(b) 器件有源沟道的扫描电镜显微图;顶部插图:β-Ga₂O₃ 再生长之后、剥离之前的再生长掩模;底部插图:T 型栅的截面图。(c) 10×200 μm 空气桥器件的着色扫描电镜图。(d) 放置在射频测试台上的 2 英寸晶圆。
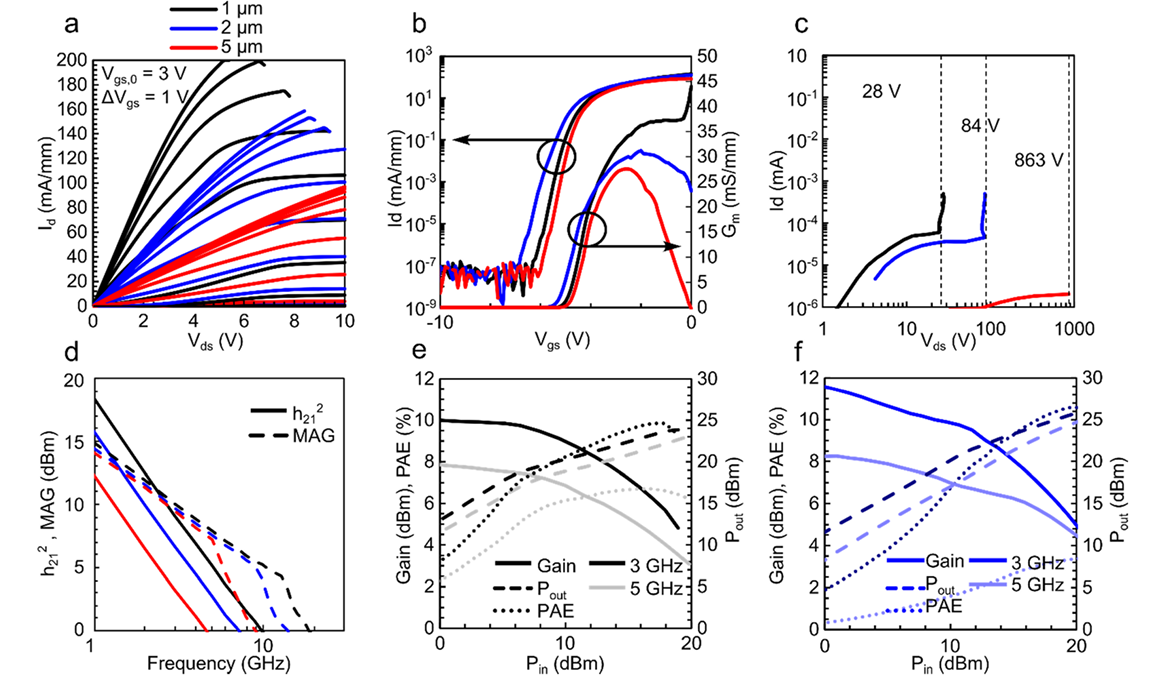
图 2 源漏间距为 1 μm(黑色)、2 μm(蓝色)、5 μm(红色)器件的独立测试结果:(a) 输出特性曲线族,(b) 转移曲线,(c) 关态击穿特性,(d) 正向电流增益 h₂₁,(e) 1 μm 源漏间距器件的负载牵引特性,(f) 2 μm 源漏间距器件的负载牵引特性。

图 3 (a)–(f) 器件性能特征的晶圆映射图,标注出未良品(红色)、电镀失效(黄色)、栅泄漏不良(橙色)及存在寄生 Si 沟道(蓝色)的器件:(a) 2×75 μm 器件的对数坐标转移曲线,(b) 2×75 μm 器件的输出特性曲线族,(c) 2×75 μm 器件的栅泄漏曲线,(d) 10×200 μm 器件的对数坐标转移曲线,(e) 10×200 μm 器件的输出特性曲线族,(f) 10×200 μm 器件的栅泄漏曲线。(g) 所有良品双指器件整体性能特征的箱线图。
DOI:
doi.org/10.1063/5.0323258