

【国际论文】Small丨印度国家物理实验室:基于外延 β-Ga₂O₃/GaN 异质结的 UV-C/UV-A 光电探测器,在垂直和横向模式下均具有优异的灵敏度和稳定性
日期:2026-04-24阅读:50
由印度国家物理实验室(CSIR)、印度科学与创新研究院、印度比尔拉科技学院、印度石油与能源大学的研究团队,在学术期刊 Small 发布了一篇名为 Epitaxial β-Ga₂O₃/GaN Heterojunction Based UV C/UV A Photodetectors with Superior Responsivity and Stability Under Vertical and Lateral Mode Operations(基于外延 β-Ga₂O₃/GaN 异质结的 UV-C/UV-A 光电探测器,在垂直和横向模式下均具有优异的灵敏度和稳定性)的文章。
背 景
传统半导体(Si、GaAs)带隙较窄,深紫外探测需滤光片,系统复杂;超宽禁带半导体中,β-Ga₂O₃ 禁带宽度~4.9 eV,适合日盲紫外探测,但载流子迁移率低、缺陷复合严重;GaN 迁移率高、近紫外响应好,二者构建 n-n 型 I 类异质结可实现双波段紫外探测,抑制暗电流、提升响应度与响应速度,在火焰探测、空间监测、环境安全、保密通信等领域具有重要应用价值。
主要内容
本文报道了一种基于 I 类 β-Ga₂O₃/GaN 异质结的高性能、偏压可调双波段紫外光电探测器,通过脉冲激光沉积(PLD)制备。该器件可通过偏压控制实现 255 nm 和 347 nm 的探测,表现出高响应度与稳定性能。高能电子衍射、同步辐射 X 射线衍射和 X 射线光电子能谱证实形成了高质量外延 β-Ga₂O₃/GaN 界面,具有良好的导带与价带偏移,增强载流子产生并抑制复合。分别在垂直光电探测器(VPD)和横向光电探测器(LPD)结构中评估了紫外探测性能。VPD 在 5 V 低偏压下,255 nm 处响应度为 19.8 A/W,347 nm 处为 923.6 A/W;LPD 在 40 V 偏压下,255 nm 处响应度为 365.7 A/W,347 nm 处为 455.1 A/W。近紫外响应增强源于 β Ga₂O₃ 的光电导增益与 GaN 的带边吸收协同机制,由能带对齐工程实现。本工作为下一代双波段紫外光电探测器提供了通用设计策略,可用于火焰探测、空间监测、环境安全和保密通信。
创新点
● 采用 PLD 制备高质量外延 I 类 β‑Ga₂O₃/GaN n‑n 异质结,界面缺陷少、能带偏移优异;
● 实现偏压可调双波段紫外探测,覆盖 UV‑C(255 nm)与 UV‑A(347 nm);
● 垂直器件 5 V 偏压下 347 nm 响应度达 923.6 A/W,横向器件 40 V 偏压下 255 nm 响应度达 365.7 A/W;
● 暗电流低、开关响应快、循环稳定性优异,经过 100 次开关无明显衰减;
● 揭示 I 类异质结载流子分离与输运机制,GaN 高迁移率大幅提升光电增益。
结 论
本工作开发并系统表征了基于 I 类 β-Ga₂O₃/GaN 异质结的高性能双波段紫外光电探测器,通过脉冲激光沉积制备。该器件结构结合了 β-Ga₂O₃ 的超宽禁带与高击穿场强,以及 GaN 的优异载流子迁移率,实现协同增强的光电响应。通过全面的结构与界面分析,证实形成高质量外延氧化物 氮化物界面,具有理想的 I 类能带对齐,促进载流子高效产生、分离与收集。所制备的 β-Ga₂O₃/GaN 异质结光电探测器在 UV-C(255 nm)和 UV A(347 nm)波段均表现出优异性能。在 5 V 偏压下,255 nm 处响应度达 19.8 A/W,347 nm 处达到 923.6 A/W,表明 GaN 带边吸收附近的光响应显著增强。结果证实,深紫外响应主要由 β-Ga₂O₃ 的光电导产生主导,近紫外响应得益于 GaN 层的带边吸收,通过能带偏移与界面电荷动力学实现高增益与低暗电流。此外,器件在长时间紫外照射下保持稳定的工作性能,进一步验证其实际应用可行性。总体而言,该器件具有强双波段紫外探测能力、偏压可调光响应与高响应度,是日盲与近紫外探测应用的理想候选。本工作不仅确立了 β-Ga₂O₃/GaN 平台作为下一代紫外探测的可扩展方案,还提供了超越传统宽禁带半导体限制的通用异质结设计策略。所展示的性能与稳定性使其成为火焰传感、空间紫外监测、生物灭菌及其他需要快速、灵敏、可靠紫外探测领域的有力候选。
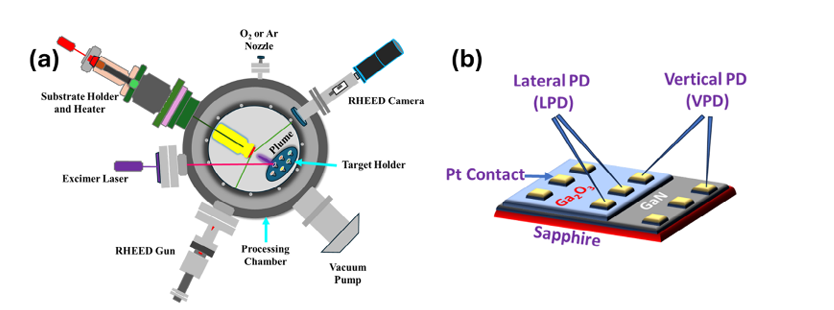
图 1 用于 β-Ga₂O₃ 薄膜生长的 (a) 脉冲激光沉积(PLD)系统示意图,以及 (b) 用于电学测试的 Ga₂O₃/GaN 异质结与电极结构示意图。

图 2 分别沿两个夹角为 30° 的面内方位角获取的 (a,c) 裸蓝宝石、(b,d) 蓝宝石上的 β-Ga₂O₃(GO)、(e,g) GaN 模板(GN)以及 (f,h) GaN 上的 β-Ga₂O₃(GON)的反射高能电子衍射(RHEED)图案,展示了在蓝宝石与 GaN 模板上沉积 Ga₂O₃ 后表面结晶度与对称性的演变。条纹状特征表明 β-Ga₂O₃ 在 GaN 与蓝宝石上呈二维外延生长模式。(i) 在 1° 固定入射角下记录的 GON 与 GO 样品的同步辐射掠入射 X 射线衍射(GIXRD)图谱。所得衍射峰证实,在 GaN 模板上成功外延生长出单斜晶相 β-Ga₂O₃。

图 3 X 射线光电子能谱(XPS)分析:(a) 全谱扫描;全谱显示所有样品均存在 Ga、N、O 的核心能级信号,无杂质相关峰。(b) GN、GON、GO 样品的 Ga 2p 高分辨谱;GN 中的 Ga 2p 峰对应 Ga─N 键,向高结合能方向偏移,表明存在 Ga₂O₃中的 Ga³⁺。(c) GON 的 O 1s 谱;(d) GO 的 O 1s 谱。分峰后的 O 1s 谱主峰对应 β-Ga₂O₃中的晶格氧(O²⁻),另有峰对应氧空位(Oᵥ)。

图 4 GN、GON、GO 样品分别对应的 (a–c) Ga 3d 与 (d–f) 价带顶(VBM)的 X 射线光电子能谱(XPS),展示了样品间化学态与电子结构的差异。(g) GN 样品与 (h) GO 样品的 Tauc 图,分别给出 3.39 eV 与 4.83 eV 的直接带隙,插图为对应的紫外–可见吸收光谱。

图 5 Ga₂O₃/GaN 垂直光电探测器(VPD)的光响应:(a) 暗态与不同强度 347 nm 光照下的 I–V 特性。左插图为 I–V 曲线在 0 µA 附近的放大图,右插图为测试所用器件的偏置结构。(b) 5 V 恒定偏压下不同光强的瞬态开关行为,(c) 恒定光照(1610 µW/cm²)下不同偏压的开关响应。(d) 用于提取上升与衰减时间的拟合曲线。
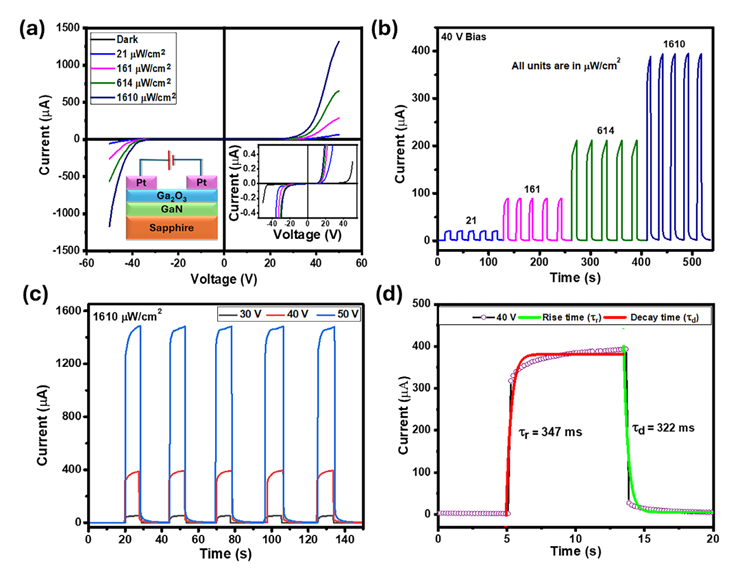
图 6 Ga₂O₃/GaN 横向光电探测器(LPD)的光响应:(a) 暗态与不同强度 347 nm 光照下的 I–V 特性。右插图为 I–V 曲线放大图,另一右插图为测试所用器件的偏置结构。(b) 40 V 恒定偏压下不同光强的瞬态开关行为。(c) 恒定光照(1610 µW/cm²)下不同偏压的开关响应。(d) 用于提取上升与衰减时间的拟合曲线。
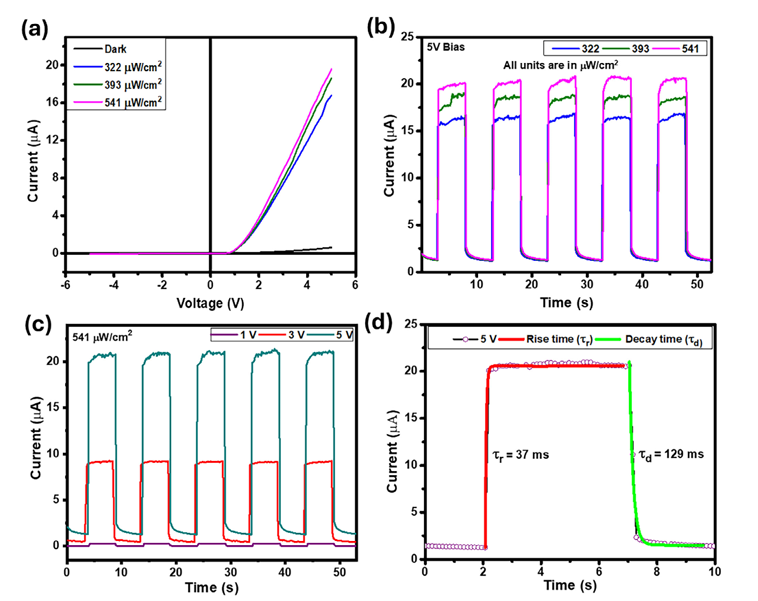
图 7 Ga₂O₃/GaN 垂直光电探测器(VPD)的光响应:(a) 暗态与不同强度 255 nm 光照下的 I–V 特性。(b) 5 V 恒定偏压下不同光强的瞬态开关行为。(c) 恒定光照(541 µW/cm²)下不同偏压的开关响应。(d) 用于提取上升与衰减时间的拟合曲线。
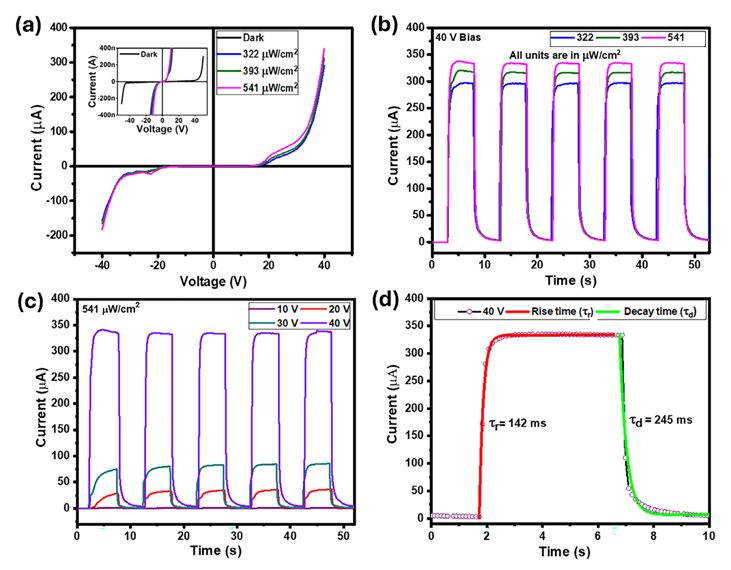
图 8 Ga₂O₃/GaN 横向光电探测器(LPD)的光响应:(a) 暗态与不同强度 255 nm 光照下的 I–V 特性,插图为 I–V 曲线放大图。(b) 40 V 恒定偏压下不同光强的瞬态开关行为。(c) 恒定光照(541 µW/cm²)下不同偏压的开关响应。(d) 用于提取上升与衰减时间的拟合曲线。
DOI:
doi.org/10.1002/smll.202511610