

【国内论文】ASS丨合肥工业大学吴春艳教授团队:氟基等离子体处理与湿化学处理协同作用制备具有优异击穿特性的β-Ga₂O₃肖特基势垒二极管
日期:2026-04-27阅读:37
由合肥工业大学吴春艳教授的研究团队在学术期刊 Applied Surface Science 发布了一篇名为 Synergy of fluorine-based plasma treatment and wet chemical treatment for β-Ga₂O₃ Schottky barrier diode (SBD) with superior breakdown characteristics(氟基等离子体处理与湿化学处理协同作用制备具有优异击穿特性的 β-Ga₂O₃ 肖特基势垒二极管)的文章。
背 景
β-Ga₂O₃ 作为超宽禁带半导体,凭借高临界电场与优异的 Baliga 优值,成为下一代功率器件的理想候选材料。在器件制备中,ICP 刻蚀等干法工艺易引入晶格损伤与氧空位缺陷,导致漏电流增大、击穿电压降低,而传统刻蚀后修复策略难以同时实现表面平整化与缺陷高效钝化。氟基等离子体可实现表面掺杂与钝化,但易残留损伤层,与热磷酸、TMAH 等湿法处理的协同调控机制尚不明确,缺乏兼顾低导通电阻与高击穿电压的一体化工艺方案。
主要内容
该团队提出了一种通过氟基电感耦合等离子体(ICP)处理与后退火湿化学处理协同作用提升 β‑Ga₂O₃ 肖特基势垒二极管(SBD)性能的有效策略。在电极沉积前,采用 SF₆/Ar 混合气体(18/2 sccm)对阳极进行等离子体处理,获得了 root mean square(RMS)粗糙度为 0.179 nm 的光滑表面形貌。氟基等离子体处理在近表面引入浅施主型掺杂并钝化悬挂键,将比导通电阻(Rₒₙ,ₛₚ)从 4.25 降至 2.61 mΩ・cm²,反向击穿电压(BV)从 530 V 提升至 560 V。采用热 H₃PO₄ 进行湿化学后处理可进一步钝化等离子体诱导缺陷,将 BV 提升至 770 V。尽管 H₃PO₄ 处理会导致 Rₒₙ,ₛₚ 略有上升,但功率优值(PFOM)从 62.98 显著提升至 154.4 MW・cm⁻²。该工作为制备具有优异击穿特性的 β‑Ga₂O₃ SBD 提供了可行方案。
创新点
•氟基 ICP 处理与热 H₃PO₄ 湿化学处理协同制备高性能 β-Ga₂O₃ SBD。
•SF₆/Ar 等离子体处理获得 0.179 nm 光滑表面,将 Rₒₙ,ₛₚ 降至 2.61 mΩ・cm²。
•热 H₃PO₄ 处理钝化等离子体损伤,将击穿电压提升至 770 V。
•功率优值(PFOM)从 62.98 显著提升至 154.4 MW・cm⁻²。
•实现 β-Ga₂O₃ 功率器件导通电阻与击穿特性平衡的有效策略。
结 论
该团队在 β-Ga₂O₃ SBD 电极沉积前,采用 SF₆/Ar 混合气体对阳极进行等离子体处理。在 SF₆/Ar 流量比为 18/2 时,刻蚀过程表现出适中的刻蚀速率并获得光滑表面形貌,为高质量 SBD 制备提供了有利条件。氟基等离子体处理后,器件 Rₒₙ,ₛₚ 从 4.25 降至 2.61 mΩ・cm²,BV 从 530 V 提升至 560 V,这归因于近表面浅施主型氟掺杂与氟的钝化作用。热 H₃PO₄ 湿化学后处理可进一步钝化等离子体损伤层,将 BV 提升至 770 V。尽管 Rₒₙ,ₛₚ 有所上升,器件 PFOM 仍从 62.98 MW・cm⁻² 提升至 154.4 MW・cm⁻²。氟基等离子体处理与湿化学处理协同作用是制备低刻蚀损伤、高击穿电压 β-Ga₂O₃ SBD 的有效策略。
项目支持
本研究得到国家自然科学基金(NSFC,No. 62074048)、安徽省重点研发计划(No. 2022f04020007)与安徽省自然科学基金(No. 2208085MF177)资助。
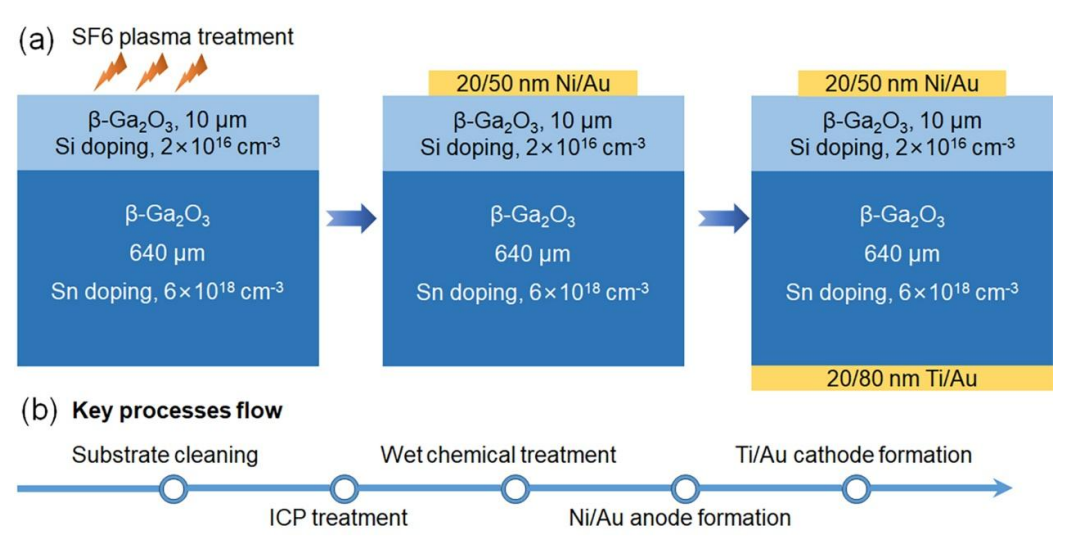
图 1. 垂直型 β‑Ga₂O₃ SBD 的(a)截面结构示意图与(b)制备工艺流程。
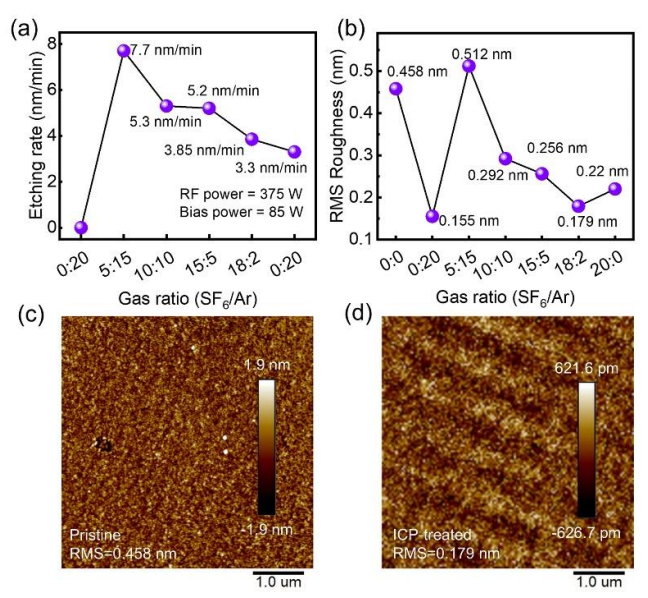
图 2. (a)β‑Ga₂O₃ 的 ICP 刻蚀速率随 SF₆/Ar 流量比的变化;(b)不同 SF₆/Ar 流量比刻蚀的 β‑Ga₂O₃ 表面 RMS 粗糙度;(c)原始 β‑Ga₂O₃ 表面与(d)流量比 18/2 sccm 的 SF₆/Ar 刻蚀后的 β‑Ga₂O₃ 表面 AFM 图。
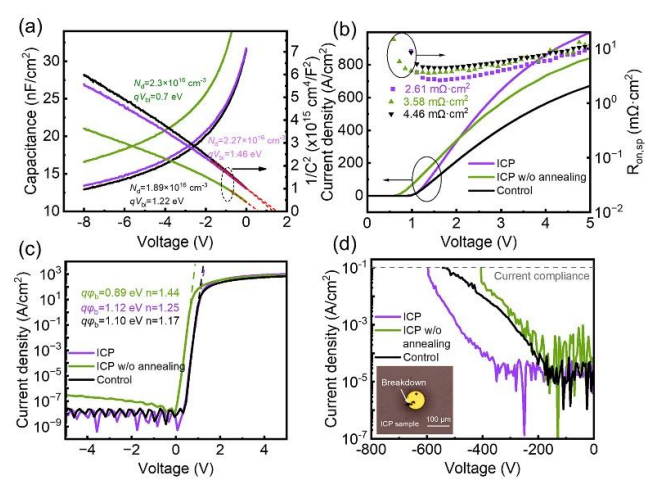
图 3. (a)对照组、ICP 刻蚀退火与未退火器件在 500 kHz 下的 C–V 及对应 1/C²–V 特性;(b)器件正向线性坐标 J–V 曲线及对应 Rₒₙ,ₛₚ;(c)半对数坐标 J–V 曲线;(d)反向 J–V 特性。
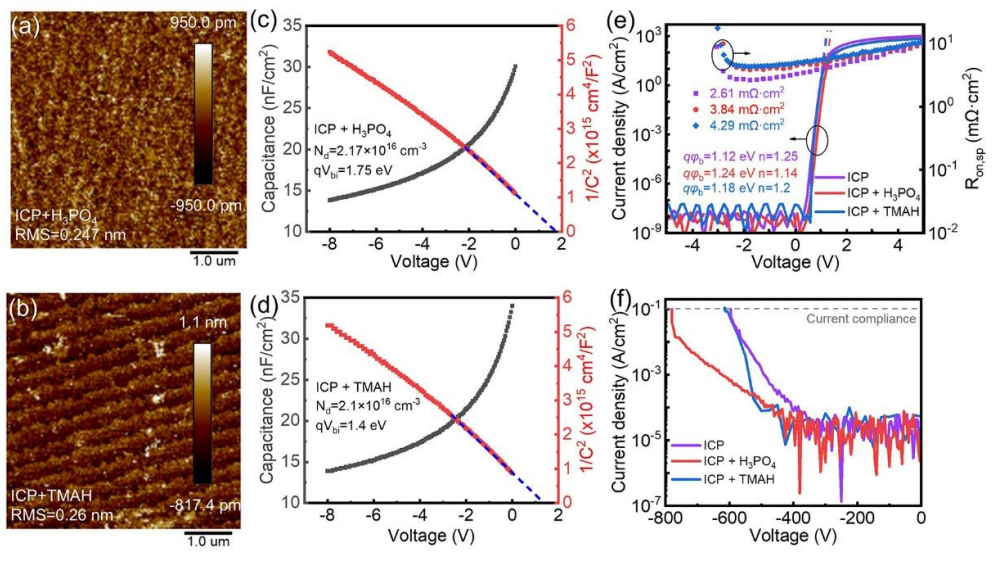
图 4. ICP 处理后再经(a)热 H₃PO₄ 与(b)TMAH 处理的 β‑Ga₂O₃ AFM 图;(c)H₃PO₄ 与(d)TMAH 处理的 β‑Ga₂O₃ SBD 在 500 kHz 下的 C–V 及 1/C²–V 特性;(e)器件半对数坐标 J–V 曲线及对应 Rₒₙ,ₛₚ;(f)器件反向 J–V 特性。
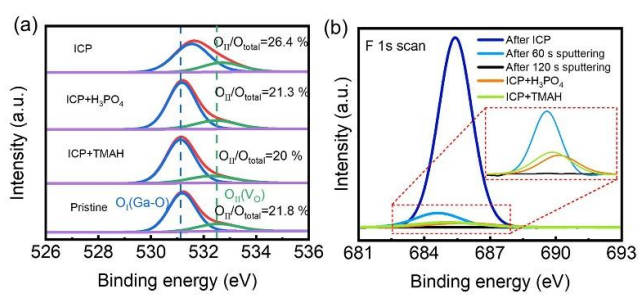
图 5. β‑Ga₂O₃ 衬底的(a)O 1s 高分辨 XPS 谱与(b)F 1s 高分辨 XPS 谱。
DOI:
doi.org/10.1016/j.apsusc.2026.166972