

【外延论文】聚焦镓离子束在微纳尺度制造中的β-氧化镓溅射刻蚀特性
日期:2024-12-30阅读:763
近期,由东南大学的研究团队在学术期刊 Sensors and Actuators A: Physical 发布了一篇名为 Characteristics of β-Gallium Oxide Sputtering Etching by Focused Gallium Ion Beam in the Micro-Nano Scale Fabrication(聚焦镓离子束在微纳尺度制造中的β-氧化镓溅射刻蚀特性)的文章。
摘要
β-氧化镓(β-Ga2O3)是一种超宽带隙(UWBG)半导体材料,被广泛认为是制造光电器件和高压器件的理想材料。作为一种先进的溅射刻蚀技术,聚焦离子束(FIB)越来越多地用于半导体材料的微纳米加工。本文从溅射产率的校准、工艺参数对刻蚀轮廓的影响以及再沉积效应三个方面系统地研究了 Ga FIB 对 β-Ga2O3 溅射刻蚀的影响。首先,在典型工艺条件下,以不同入射角对 β-Ga2O3 衬底进行溅射刻蚀,精确校准了溅射产率的关键参数。此外,应用 Yamamura 模型拟合了溅射产率与入射角的关系曲线。此外,比较了 β-Ga2O3、GaN 和 Si 在相同条件下的溅射产率,揭示了它们之间的差异。其次,通过线扫描刻蚀和沟槽结构刻蚀实验,分析了最大刻蚀深度、宽度和刻蚀体积随离子剂量的变化。描述了 β-Ga2O3 沟槽结构的演变,并与 GaN 和 GaAs 进行了比较,从再沉积效应的角度分析了三种材料在溅射刻蚀过程中的差异原因。最后,研究了 FIB 工艺参数对 β-Ga2O3 再沉积效应的影响。实验结果表明,在大单次驻留时间刻蚀 β-Ga2O3 时,会产生明显的再沉积效应。进一步分析确定了在不同束流条件下,一定范围的单次驻留时间可以减少再沉积,防止侧壁角度的形成。这些研究结果为基于 FIB 技术的 β-Ga2O3 微纳器件的高分辨率刻蚀工艺提供了重要的数据支持,也为相关仿真研究建立了可靠的数据基础。
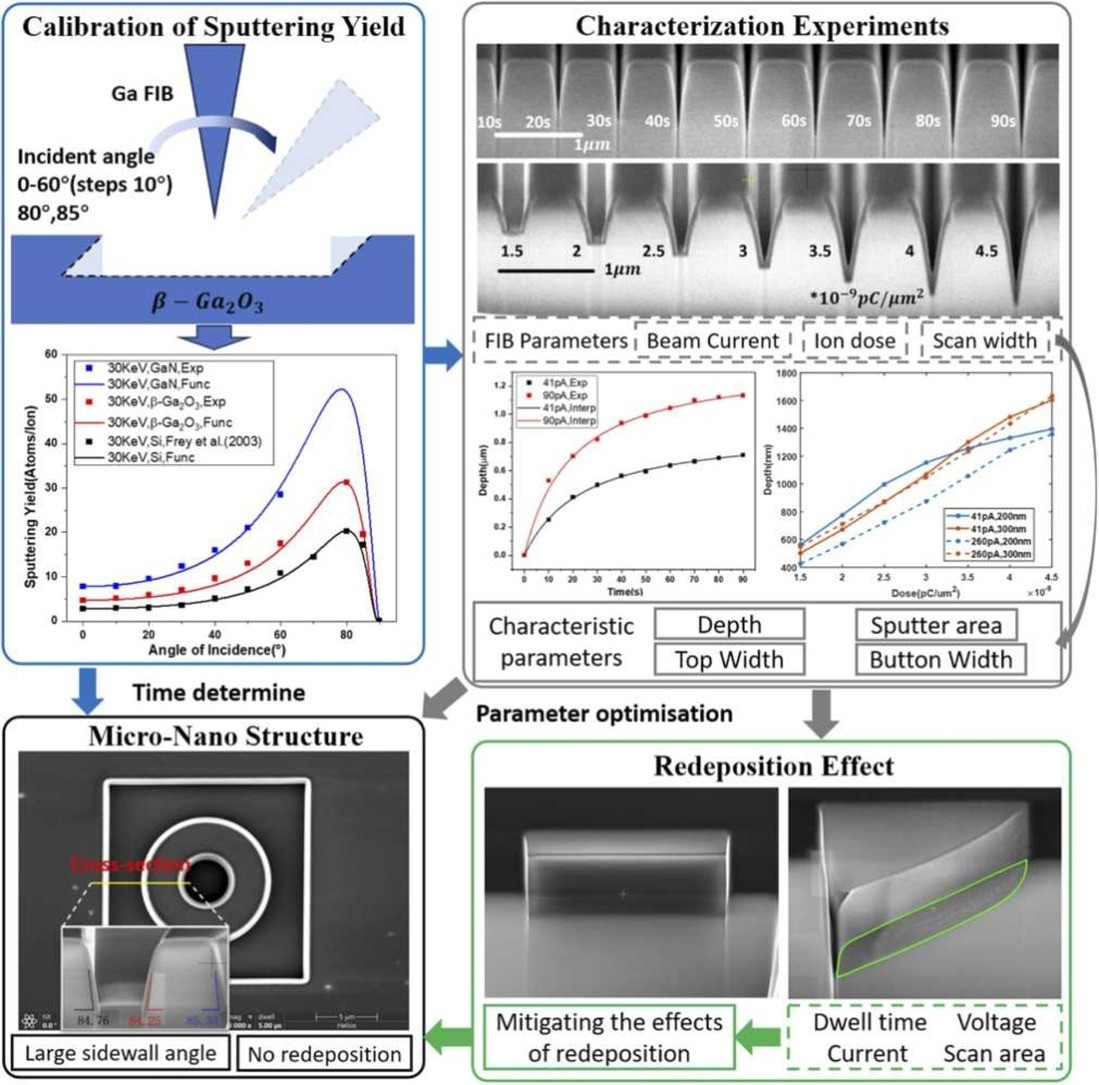
原文链接:
https://doi.org/10.1016/j.sna.2024.116071


