

【国际时事】Ga₂O₃ 异质结二极管展现出雪崩和浪涌鲁棒性
日期:2024-12-31阅读:1385
在超宽带隙 (UWBG) 半导体材料中,氧化镓 (β-Ga2O3) 或许是最有前景的材料。高压 MOSFET 和 MESFET 器件已取得了重大进展。利用氧化镍 (NiO) p 型层使异质结二极管 (HJD) 得以诞生。在本文中,总结了对 β-Ga2O3-NiO HJD 的研究,这些器件展示了出色的雪崩和浪涌性能,使其成为未来高压电力系统潜在的候选者。
HJD 制造
2 英寸锡掺杂 (001) β-Ga2O3 衬底是器件制造的起点。漂移区由厚度 10 μm 的硅掺杂 n-Ga2O3 层组成,载流子浓度为 ~1.7 × 1016/cm3。外延晶圆可从日本 Novel Crystal Technology 购买。通过锡/金(Ti/Au)金属化和退火,在减薄晶片背面形成阴极。在漂移层上方使用 RF 磁控溅射沉积双层 NiO。这形成了阳极层并与 n-Ga2O3 形成了异质结。基底层 NiO 为 p 型,空穴浓度为 5.8 × 1017/cm3,而上层 p+ NiO 的空穴浓度为 2.9 × 1019/cm3。通过调节溅射过程中 Ar/O2 的通量比来改变掺杂。在 NiO 中创建了一个小角度 (11°) 斜角边缘,以创建结终止扩展边缘终止。该斜面是通过在距离晶片一定距离的阴影掩膜和氧化镍靶与晶片的偏角(这两个参数都可以调节)组合而成。从而实现表面电场逐渐远离器件的有源区。还在 NiO 薄膜顶部通过 RF 溅射沉积了钛酸钡(BaTiO3)。它具有超高介电常数,并在阳极金属 (Ni/Au) 下形成场板,该场板延伸到 NiO 层之外。通过使用该场板,Ga2O3 和 NiO 中的峰值电场分别从 6.61 MV/cm 和 7.91 MV/cm 降低到 4.57 MV/cm 和 2.62 MV/cm。
3 × 3 mm 的器件阴极键合在 0.5 mm 厚的铜-钼-铜基板上,具有高导热性,而阳极通过五条 1 mm 厚的金键合线连接到引线框架。封装和安装到 TO-220 封装完成了制造过程。图 1 显示了器件的简化层示意图。

图 1:HJD 的图层示意图
雪崩性能
雪崩行为可能是功率半导体中的一个重要鲁棒性因素,尤其是在需要耗散来自感应负载的关断反向电动势的电机驱动应用中。一旦器件两端的反向电压达到雪崩击穿 (BAVA),p-n 结会产生碰撞电离和倍增。允许高反向电流流动 (IAVA),从而允许耗散雪崩能量 (EAVA = BAVA × IAVA × 事件持续时间),而不会导致灾难性的器件故障。通常通过非嵌位感性负载开关过程 (UIS) 来测试器件的雪崩鲁棒性。在 UIS 测试中,电感器通过开关充电,当开关关闭时,将储存在电感器中的能量强制通过待测器件 (DUT) 的关断状态,使其进入雪崩击穿。DUT 能够承受重复的 UIS 测试而其正向或反向特性没有显着变化,这进一步增强了对其雪崩鲁棒性的信心。
HJD 器件的 UIS 性能如图 2 所示。BAVA 范围从 1,545 V 到 1,683 V,温度范围从 25°C 到 175°C,温度系数为 1 V/°C。图 2a 中的反向特性显示,在 1,200 V 时的泄漏电流比类似额定 SiC 融合 PiN 肖特基二极管低 100 倍至 1000 倍,证明了 UWBG 技术的优势。测试设置如图 2b 所示,UIS 波形如图 2c 所示。HJD 通过了 100 万次重复 UIS 测试,IAVA 为 30 A,BAVA 为 1,740 V,持续时间为 20 μs。与新零件相比,正向和反向特性在此测试后没有显着变化。稳定的雪崩性能归因于碰撞电离从 n-Ga2O3 区域开始并均匀地通过整个器件进行。异质结的交错能带结构不会在高反向偏压下产生空穴屏障,从而允许有效去除空穴。

图 2:(a) HJD 的静态反向特性与温度的关系,显示了用于雪崩测试的 UIS 区域;(b) UIS 测试电路;(c) 30 A、20 µs 时的 UIS 波形,以及 HJD 通过 100 万次重复 UIS 测试的情况
浪涌性能和反向恢复
这测试了器件在高正向导通状态下的鲁棒性。使用具有可调幅度的 10 毫秒半正弦电流脉冲。如图 3 所示,HJD 可以承受 50 A 的浪涌。
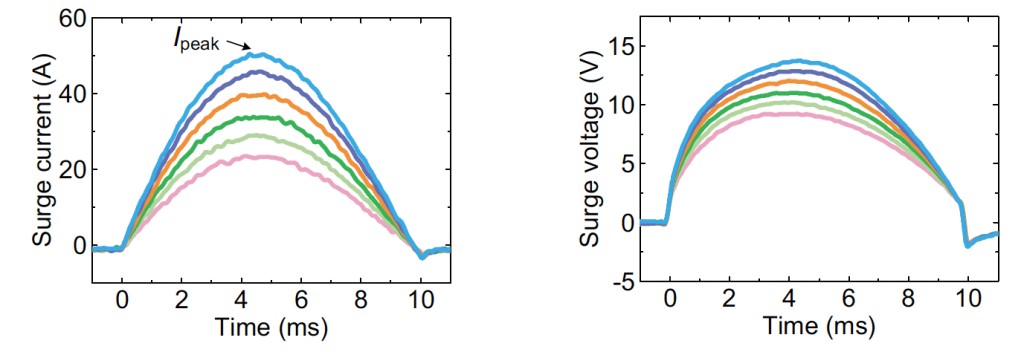
图 3:HJD 的浪涌电流和电压特性
导通电阻 (RON) 表现出正温度系数,表明存在双极导电调制。在同质结 pn 二极管中,轻掺杂漂移区积累少数载流子,导致器件关断时出现相当大的反向恢复。这导致开关损耗增加并限制了开关速度。因此,同质结 pn 器件在浪涌鲁棒性和开关速度之间存在固有的权衡。
HJD 器件的反向恢复特性如图 4 所示。与此处所示的快速硅 pn 二极管的曲线不同,HJD 的反向恢复波形独立于正向电流,并且表现出非常快速的恢复。该 HJD 的反向恢复时间被提取为 12.79 ns。高浪涌能力归因于在高正向偏压下通过隧穿或热电子发射注入到 NiO 中的电子。在反向偏压下,耗尽主要发生在轻掺杂的 n-Ga2O3 区域,NiO 中的少数载流子复合最小。从电子束诱导电流研究中提取出 Ga2O3 中的低空穴少数载流子寿命为 6.2 ns。基于测量的理论结论表明,在浪涌条件下,整个 NiO 区域存在高电子浓度,导致导电调制,而 Ga2O3 中的空穴浓度低得多,并迅速远离结。
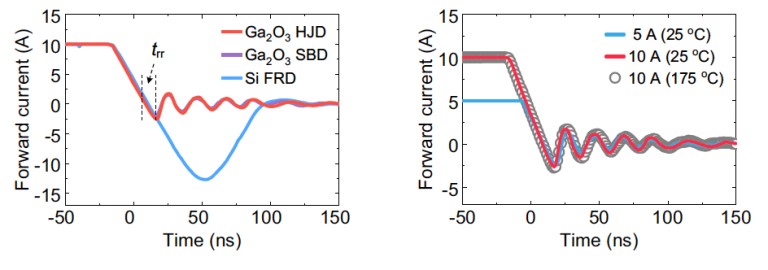
图 4:HJD 的反向恢复特征
NiO/Ga2O3 异质结可以成为创建稳健功率器件的有前景的材料系统。此处总结的 HJD 器件显示出良好的浪涌和雪崩性能,并在 RON 和击穿电压特性之间具有有利的权衡。该异质结还被其他小组用于制造超结 MOSFET 器件。该技术的进一步发展可以推动这些器件达到其理论极限,并使其在高压电力系统中具有吸引力。


