

【国内论文】福州大学&上海光机所——氧化镓同质外延及二维“台阶流”生长研究
日期:2025-02-21阅读:1335
摘要
如何同质外延生长出具有原子级平整的氧化镓 (Ga₂O₃) 单晶薄膜,是制备高性能 Ga₂O₃ 基功率电子器件或紫外光电器件的基础。本文通过金属有机气相外延(MOVPE)技术综合调控外延生长的热力学条件与动力学参数,在 Ga₂O₃ 衬底上制备了厚度为 1.0 μm 的器件级 Ga₂O₃ 单晶薄膜(非故意掺杂),对薄膜样品进行了物相、表面形貌、晶体质量和电学性能的研究。该薄膜具有单一 β 相,呈现出与衬底相同的 (100) 面择优取向。对 Ga₂O₃ 薄膜表面形貌进行 AFM 表征,呈现出典型的台阶流形貌,表面粗糙度 0.166 nm,且台阶高度 0.6 nm (a/2),表明具有原子级平整。进一步通过 HRXRD 双晶摇摆曲线评估 Ga₂O₃ 薄膜结晶质量,外延膜的 FWHM 低于单晶衬底,表明外延在晶格匹配衬底上的 Ga₂O₃ 薄膜质量优于衬底。通过霍尔效应测试分析 Ga₂O₃ 薄膜的电学性能,迁移率 92.1 cm2 /(V·s),载流子浓度 2.65×1016 cm-3。本文的研究结果阐明了只要通过精细化调控温度、压力、Ⅵ/Ⅲ 比等关键热力学条件,使核心动力学参数中的横向扩散速率充分大于纵向沉积速率,就有可能在通用的非刻意斜切衬底上实现高长速二维“台阶流”生长。本研究所制备的具有优异晶体质量与电学特性的 (100) 面同质外延单晶薄膜,在制造高性能 Ga₂O₃ 功率电子 器件具有重要的应用潜力。
引言
近年来,随着高温、高电压、强辐照等众多极端应用场景需求的推动,超宽禁带半导体材料得到了迅速发展。特别是当前备受关注的 Ga₂O₃ 材料,凭借其 4.9 eV 的超宽带隙、8 MV/cm 的高临界击穿场强、超过 3000 的 Baliga 优值及可商业化的大尺寸单晶衬底,在高耐压、低损耗功率器件领域展现出了巨大的应用潜力。然而,Ga₂O₃ 外延技术尚不成熟,制约了其在氧化镓功率器件中的进一步发展。尽管目前已采用能够精细化控制外延进程的金属有机气相外延 (metal organic vapor phase epitaxy, MOVPE) 技术,并且使用了高质量的单晶衬底,但器件级的 Ga₂O₃ 外延薄膜仍未能成功实现。通常,器件级 Ga₂O₃ 外延膜要求形成具有原子级平整度和低缺陷密度的单晶薄膜。由于通用衬底 (非刻意斜切,通常小于 0.5°) 存在非理想整数指数表面,二维“台阶流” (step flow) 生长被广泛认为是实现上述高质量单晶薄膜的理想方法,并适用于大功率电子器件的制造。
然而,Ga₂O₃ 材料的发展仍处于初期阶段,受到可靠外延设备匮乏、适宜外延理论缺乏,以及外延工艺窗口狭窄等多重因素的制约,二维“台阶流”生长仍面临很大挑战。作为目前商业化半导体电子器件的主流外延技术,MOVPE 因其能够精确调控载流子浓度、原位生长出原子级平整的单晶薄膜,并轻松实现超过 1 μm/h 的高生长速率,成为制备 Ga₂O₃ 垂直型高耐压功率器件中核心厚漂移层的理想选择。尽管德国莱布尼兹晶体生长研究所 (IKZ) 研究团队已经通过 MOVPE 成功外延出具有良好台阶流表面形貌的 Ga₂O₃ 薄膜, 但由于受到苛刻斜切衬底加工技术和低于 300 nm/h 的外延生长速率的限制,二维“台阶流”生长尚未得到广泛应用。此外,目前尚无成熟的市售 MOVPE 外延设备能够有效解决 Ga₂O₃ 外延过程中强烈的预反应问题,以及高温生长条件下的严重氧化腐蚀问题,这使得二维“台阶流”生长所需的高温热力学条件难以实现——即无法促使沉积原子具备足够的横向扩散系数。尽管射频加热在一定程度上缓解了这一问题, 但随着 Ga₂O₃ 外延片尺寸的增大,依然面临大面积均匀性差的问题。因此,只有通过改造现有 MOVPE 设备或自主研发 Ga₂O₃ 专用外延设备,才能严格满足实现二维“台阶流”生长所需的条件。
在外延生长的热力学理论中,二维生长通常发生在衬底和外延层之间界面能和应力较小的情况下,这使得外延层能够轻松覆盖整个衬底表面。然而,该理论并未完全解释在某些界面能可以忽略的同质外延体系中,依然可能出现三维生长的现象。外延动力学理论的发展弥补了这一不足,它强调实现二维“台阶流”生长的关键在于确保沉积原子能够在平台-台阶-节点 (TSK) 模型的表面平台上实现足够快的横向热扩散, 直至原子到达台阶或节点,从而避免在底层完全覆盖之前发生新的成核。对于 β-Ga₂O₃ 这一非对称半导体材料,其单斜晶体结构使得 c 轴和 a 轴方向上表面能具有显著的各向异性,这一现象促使外延生长在初期阶段从三维转向二维,成为热力学驱动力;此外,外延层中的应变能是诱发缺陷和界面粗糙化(两种主要的晶格应力释放方式)的主要热力学因素。与此同时,原子在表面的热扩散率和扩散长度则是决定薄膜是否能够顺利愈合并形成平整表面的动力学因素。因此,只有通过综合并精细调控外延生长过程中的众多工艺参数,才能实现严格的二维“台阶流”生长,从而有效降低 β-Ga₂O₃ 外延膜中的缺陷密度,以及实现原子级平整的表面。
在本研究中,外延热力学和动力学理论,本团队提出了一种协同考虑外延热力学条件与生长动力学因素的策略。通过综合调控温度、压力、Ⅵ/Ⅲ 比等关键热力学参数,能够精确控制动力学过程中沉积原子在平台上的横向热扩散率,使其充分大于外延膜的纵向沉积速率,从而实现热-动力学的微妙平衡,最终实现理想的二维“台阶流”生长。为此,本团队在氧化镓材料中创新性地引入了外延生长因子 K (热扩散率 /外延速率),该因子有效表征了外延系统的特性及其生长模式的演化。具体而言,通过自主研制的氧化物专用 MOVPE 设备,本团队在非刻意斜切的 a 面 β-Ga₂O₃ 单晶衬底上成功实现了 Ga₂O₃ 薄膜的二维“台阶流” 生长。在以常规 TMGa 和 O₂ 为反应物,并精细调控外延长速至 1.0 μm/h 的条件下,所制备的 β-Ga₂O₃ 单晶薄膜呈现出方均根粗糙度仅为 0.166 nm 的典型台阶流形貌,较现有经过抛光处理的商用氢化物气相外延 (hydride vapor phase epitaxy, HVPE)片更为光滑。通过霍尔测试,获得了非故意掺杂 (unintentional doping, UID) 外延层高迁移率、低背景载流子浓度的优异电学性能。本研究为开发厚度可达 10 μm 的器件级 Ga₂O₃ 外延片提供了可能,这对实现高耐压、低损耗功率器件的开发具有重要意义。
实验
1.1 实验原料和制备方法
本研究采用了一台定制的 3 片 × 2 英寸 (1 英寸=2.54 cm) MOVPE 设备,加热系统采用电阻丝加热,匀气模式是垂直耦合间隔喷淋式,以形成温场、流场的均匀性。MOVPE 系统配置了一套用于在线监测沉积在 c 面蓝宝石 (Al₂O₃) 衬底上的 Ga₂O₃ 薄膜反射率的激光反射探头,从而实时观察外延薄膜的生长速度和表面粗糙度。以三甲基镓 (TMGa) 和氧气 (O₂) 作为反应物,高纯氩 (Ar) 作为载气。同质外延衬底使用杭州富加镓业科技有限公司提供的导模法 (edge-defined film-fed growth, EFG) 生长的 (100) 面 Sn 掺和 Fe 掺非刻意斜切单面抛光衬底,尺寸均为 10 mm×10.5 mm×0.5 mm。同质衬底首先放入 1000 ℃ 氧气气氛中进行退火 30 min,修复表面损伤,以形成具有原子级平整的台阶流表面形貌。随后将 Ga₂O₃ 衬底和蓝宝石衬底一同放入 MOVPE 反应室的石墨托盘上进行外延生长。生长温度为 1000 ℃,生长压力是 25 mbar (1mbar=100 Pa),Ⅵ/Ⅲ 比为 1100。生长速率控制在 1~2 μm/h。
1.2 性能测试与表征
使用 Filmetrics F20 膜厚仪测量异质外延膜的厚度,以近似表征同质外延膜厚。
外延生长过程中的反射率曲线由 MOVPE 系统所集成的波长为 633 nm 的激光反射探头采集。
同质外延层的晶体质量通过双晶摇摆曲线 (rocking curve) 的半峰全宽 (full width at half maximum, FWHM) 来评估。β-Ga₂O₃ 衬底及同质外延层的物相分析以及 rocking curve 使用的是 Bruker 公司生产的型号为 D8 Advance 的 X 射线衍射仪 (XRD),通过 Cu Kα 辐射,波长 λ=0.15406 nm 进行测量。
同质外延层表面方均根粗糙度 (RMS) 是通过 Bruker 的型号为 Dimension Edge 的原子力显微镜 (atomic force microscope, AFM) 进行测量。
外延样品的光带隙是通过蓝宝石衬底上的异质外延片来近似测定,吸收系数则是使用品牌 Perkin Elmer、 型号 Lambda 1050+ 的紫外/可见分光光度计评估。
电学性能测试首先是在外延样品的表面通过电子束蒸镀 Ti/Al 电极,然后在 Lake Shore 8404 霍尔测试系 统上通过范登堡法 (Van der Pauw) 完成。
结果与讨论
2.1 β-Ga₂O₃ 同质外延物相分析
基于 β-Ga₂O₃ (100) 面单晶衬底进行同质外延的 MOVPE 生长速率为 1.0 μm/h,生长时间为 1 h。图 1(a)、 (b)分别展示了基于 Sn-掺和 Fe-掺 β-Ga₂O₃ 同质外延片的照片,均显示出光滑且明亮的表面形貌,与未生长前的衬底表面无显著差异,这一宏观特征表明外延过程中体现典型预反应情况的粉末颗粒被控制很好。Ga₂O₃ 外延生长中,预反应问题尤为关键。若控制不当,预反应生成的微小颗粒会在衬底表面形成新的成核点,从而诱发外延过程中缺陷的形成,进而破坏晶格的周期性结构。此外,强烈的预反应还可能导致外延速率过慢甚至出现无法生长现象。若外延片表面出现“雾化”或“发毛”等现象,通常表明晶体内部存在纳米颗粒或较大缺陷,这种情况也可能是由预反应过强引起的。
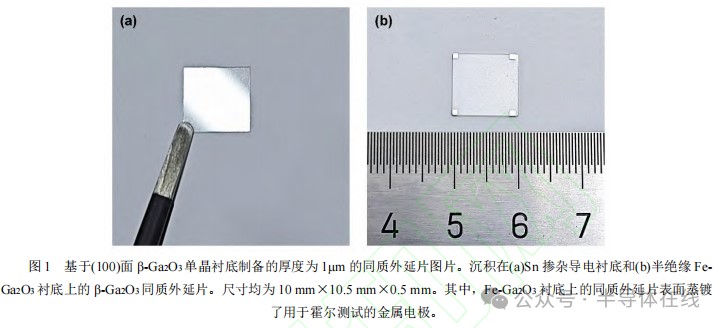
图 2(a) 为同质外延膜的 XRD 2θ 扫描图。从图中可以看出,同质外延层的衍射峰仅出现在(400)、(600) 和 (800) 三个面(均属于 β-Ga₂O₃ 的 100 平面族),且未出现其他额外衍射峰,表明所生长的外延膜为纯相且具有单一结晶取向的 β-Ga₂O₃。为了更全面地分析外延层的晶体质量,进行了生长前后衬底和外延层的双晶摇摆曲线 ω 扫描测试,结果如图 2(b) 所示。通过对比衬底和外延层在 (400) 面上的摇摆曲线 FWHM, 分别为 104.4″ 和 79.2″,结果表明同质外延层的晶体质量优于单晶衬底。这进一步表明,在外延生长初期,衬底的缺陷未显著扩展至外延层,且在外延过程中未引入过多额外的晶体缺陷,从而有效改善了外延层的晶体质量。
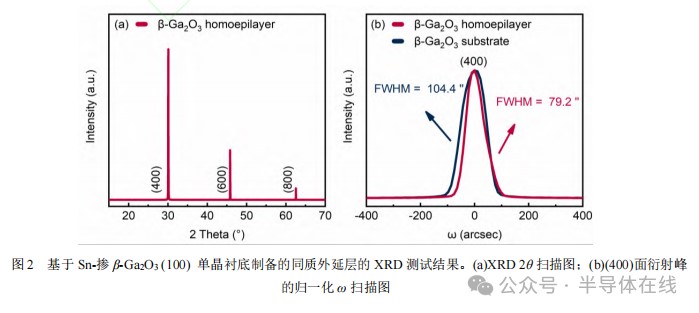
2.2 光学性能
在 β-Ga₂O₃ 的外延生长过程中,异质外延层的生长曲线在一定程度上能够反映同质外延层的生长行为。图 3 展示了优化后外延工艺对应的反射率曲线。在整个外延生长过程中,反射率曲线的振幅保持相对稳定, 表明外延层的粗糙度未发生显著变化,进而可以推测外延层的晶体质量未出现明显下降。

2.3 表面形貌表征与外延生长模式分析
在 β-Ga₂O₃ 的外延生长过程中,理想的同质外延过程旨在精确复制衬底晶格的对称性,具体表现为通过高温驱动,使沉积原子在 T-S-K 表面上快速扩散至台阶或节点,从而实现二维“台阶流”生长。然而,达到理想的二维“台阶流”生长状态需要大量工艺探索和总结,以识别导致生长模式偏离理想状态的各种因素, 进而指导后续的工艺调整。在薄膜外延生长过程中,受残余应力、生长速率、衬底斜切角等因素的影响, 二维生长模式可以进一步细分为二维“台阶流”生长模式、层-层 (layer-by-layer) 生长模式(也称二维岛状生 长模式),以及台阶聚并 (step bunching) 生长模式。从外延生长动力学理论的角度来看,当原子从到达平台表面到被吸附到台阶边缘的时间远小于成核时间,即原子在平台上扩散速度极快时,绝大多数原子会被吸附到台阶上,外延过程呈现二维“台阶流”生长模式。而当两者时间尺度相近时,平台上容易形成二维小岛。如果小岛横向生长速率足够快,并且在横向生长过程中遇到相邻的台阶时,新小岛尚未在其上方成核, 则外延过程依然保持二维岛状生长模式,尽管其表面粗糙度相较于二维“台阶流”生长模式较高。如果这些条件不满足,且底层尚未完全覆盖时,新小岛可能会在旧小岛上方成核,导致生长模式转变为三维岛状生长模式。

具体而言,决定二维生长模式类型的关键参数与生长因子 K (K=D/F) 密切相关,其中 D 为表面沉积原子的热扩散系数,与生长温度直接相关;F 为外延层的沉积速率。K 因子越小,越容易进入层-层生长模式, 且薄膜表面粗糙度较高;而在残余应力较大的情况下,K 因子过大会导致台阶聚并生长模式的形成。图 4 展示了基于上述理论调控 Ga₂O₃ 二维“台阶流”生长的研究初期所遇到的一些典型失败案例,通过 AFM 扫描图像和 RMS 值表征外延层的表面平整度,具体说明了不同生长条件下薄膜形貌的变化。
图 4(a) 中的典型岛状形貌图显示,由于外延生长温度过低,导致热扩散系数 D 较小,沉积原子缺乏足够能量完成横向迁移,从而在底层尚未完全覆盖时,新的小岛便在已有小岛上方形成,进入三维岛状生长模式。插图中的白色虚线标示了表面高度的剧烈起伏,反映了该生长模式的特点。图 4(b) 中的片层结构表明,过高的温度导致台阶聚并生长。温度过高使 K 因子增大,促使台阶发生堆聚现象,形成若干个原子层 的高度起伏。然而,该外延膜的双晶摇摆曲线 FWHM 相较于衬底并未出现明显展宽(未展示),表明该生长模式并未显著影响外延层的晶体质量。尽管这种生长模式有助于缓解残余应力,但不利于实现原子级平整的表面。图 4(c) 反映了沉积速率过快导致的三维岛状生长,XRD 半峰全宽显著增加(未展示)。此现象主要是由于反应物摩尔流量过高,导致反应原料未能及时消耗,底层尚未覆盖时,新的小岛在旧小岛上方生成。在这种情况下,为了实现二维“台阶流”生长,需通过减少反应物摩尔流量或适当提高生长温度来改善生长模式。图 4(d) 展示了具有显著片层结构的二维岛状形貌,这种形貌可能是由于外延过程中 Ⅵ/Ⅲ 比过低(即氧含量相对不足)导致 K 因子偏小,从而形成二维岛状生长。
上述各种生长模式均导致 Ga₂O₃ 外延层表面起伏增大,粗糙度显著提高,这些均不利于 Ga₂O₃ 高耐压功率器件对平整表面的苛刻需求。为实现理想的二维“台阶流”生长,需要协同优化热力学条件,包括温度、 压力、Ⅵ/Ⅲ 比,以及沉积速率等动力学参数,以确保沉积原子的横向热扩散速率显著高于纵向沉积速率, 从而实现外延过程的热、动力学平衡。
通过分析并总结上述外延生长过程中遇到的失败经验,本研究对影响外延生长的关键参数进行了系统优化,包括热力学条件(温度、压力、Ⅵ/Ⅲ 比)和动力学参数(扩散系数、沉积速率)。这种优化确保生长因子 K 位于适宜范围内,实现了沉积原子的横向热扩散率 D 充分大于外延层纵向沉积速率 F 的精确平衡,从而成功制备了以二维“台阶流”模式生长的高质量同质外延膜,其结果如图 5 所示。图 5(a) 展示了同质外延样品表面一个 5 μm × 5 μm 区域的 AFM 图像,外延层表面呈现出高度有序的台阶流形貌,且 RMS 值为 0.471 nm。图 5(b)为同一外延层的另一个 1 μm × 1 μm 区域的 AFM 图像,显示出更精细的表面结构,其 RMS 值仅 0.166 nm。外延层表面呈现出更为规则的台阶形貌。图 5(b) 中 A、B、C 三个区域的台阶宽度分别为 29、 31 和 47 nm,这可能是由于这些区域的衬底台阶宽度不同。外延层上更小区域的扫描结果如图 5(c) 所示, RMS 降低至 0.110 nm。从图 5(c) 插图的剖面线可以看出,外延层上台阶的高度约为 6 Å,接近 β-Ga₂O₃ a 轴晶格常数的 1/2,表明外延层具有原子级的平整度。
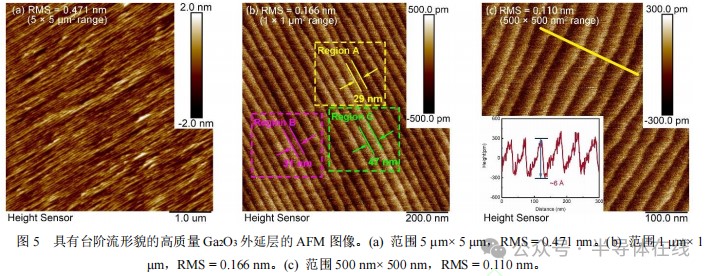
2.4 电学性能表征
在相同工艺条件下,本研究还制备了 Fe 掺杂半绝缘 β-Ga₂O₃ 衬底上的 UID 外延层(厚度为 1 μm),并 采用 Van der Pauw 法在室温下测试了其电学性能。结果表明,外延层的载流子浓度为 2.65×1016 cm3,电子迁移率为 92.1 cm2 /(V·s)。值得注意的是,尽管该同质外延层具有高晶体质量和完美的台阶流形貌,但其 迁移率并未达到预期的高水平。显然,仅凭 AFM 图像和 FWHM 值尚不足以全面评估外延层的电学性能。电子迁移率受晶体质量和非故意掺杂等因素的共同影响。通过热力学和动力学调控,外延层的晶体质量已显著提高,但目前尚未对外延过程中衬底表面因加工而残留的杂质 Si,以及外延环境中的 Si、C 和 H 等非故意掺杂元素进行严格控制,导致杂质散射中心较多,从而影响了载流子迁移率。此外,这些非故意掺杂的杂质(特别是 Si)可能会形成施主型缺陷,进而导致较高的背景载流子浓度。在后续工作中,本团队计 划进一步严格控制外延过程中杂质的来源(如前驱体),或通过引入微量的受主补偿元素来有效降低背景载 流子浓度。此外,考虑到三乙基镓 (TEGa) 在高温下形成的甲基自由基含量相对较少,研究还将考虑通过混 合适量的 TEGa 来减少非故意掺杂的 C 含量,从而进一步优化外延层的电学性能。
结论
综上所述,由于 MOCVD 外延过程中的变量众多且体系复杂,现有的 Ga₂O₃ 外延研究仍较为零散,尚未形成系统化的框架。本文首次尝试将 Ga₂O₃ 外延生长的复杂性归纳为热力学条件(温度、压力、Ⅵ/Ⅲ 比)与 核心动力学调参(扩散速率、沉积速率)之间的关联问题。针对这一问题,本团队创新性地提出,通过精确调控温度、压力及 Ⅵ/Ⅲ 比等关键热力学条件,可以实现核心动力学参数中的横向热扩散率充分大于纵向沉积速率,从而实现高生长速率的理想二维“台阶流”生长模式。此外,本文结合具体案例分析了热力学或动力学参数调控不当而导致外延生长偏离理想模式的情形,并深入探讨了各种非理想生长模式的可能成因。基于此,成功制备了具有典型台阶流表面形貌且粗糙度仅为 0.166 nm 的器件级高质量 β-Ga₂O₃ 单晶薄膜。XRD 结果表明,薄膜的晶体质量优于同质衬底。进一步的霍尔效应测量显示,薄膜具有 92.1 cm2 /(V·s)的高 迁移率和 2.65×1018 cm-3 的低背景载流子浓度,表明其具有优异的电学性能,预计可应用于垂直型高耐压 功率器件。后续工作将进一步优化外延工艺,以降低背景载流子浓度并提升迁移率等关键电学性能。


