

【国际论文】美国加利福尼亚大学丨在 β-Ga₂O₃ 上利用 MOCVD原位生长 Al₂O₃ 的介电可靠性和界面陷阱表征
日期:2025-03-17阅读:540
近期,由美国加利福尼亚大学圣巴巴拉分校的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Dielectric reliability and interface trap characterization in MOCVD grown in situ Al2O3 on β-Ga2O3 (在 β-Ga2O3 上利用 MOCVD原位生长 Al2O3 的介电可靠性和界面陷阱表征)的文章。该篇文章被评为编辑精选文章。

通讯作者介绍

本文通讯作者 Sriram Krishnamoorthy
Sriram Krishnamoorthy 副教授曾取得了俄亥俄州立大学电气工程博士、印度皮拉尼比尔拉理工学院(BITS)物理学硕士(荣誉学位)、印度皮拉尼比尔拉理工学院(BITS)电气与电子工程学士(荣誉学位)。
Krishnamoorthy 教授的研究小组在材料、电子工程和物理学的交叉领域开展工作,研究和设计下一代(超)宽禁带半导体,如氧化镓。团队对外延生长、电子传输、设计/建模、微/纳米制造以及用于电力电子、高频电子和紫外光电子等广泛应用的电子/光电器件的表征等领域进行广泛的研究。
背景
β-Ga2O3 因其超宽带隙(4.8 eV)、高击穿电场(8 MV/cm)和优异的电子性能,在高功率电子器件领域备受关注。然而,为了实现稳定的器件性能,需要高质量的栅极介电层,而传统的介电层沉积方法通常需要额外的工艺步骤,会引入界面污染和缺陷。因此,采用原位(in situ)金属有机化学气相沉积(MOCVD)生长 Al2O3 成为提升 β-Ga2O3 器件性能的主要策略。
文章摘要
该团队研究了使用金属有机化学气相沉积 (MOCVD) 在 800 °C 的高温下于 β-Ga2O3 上原位生长 Al2O3。Al2O3 与 β-Ga2O3 在同一反应器中生长,使用三甲基铝和 O2 作为前驱体,无需破坏真空。通过应力电容-电压 (C-V) 和光辅助 C-V 方法表征了浅层和深层陷阱。高温沉积的介质表现出令人印象深刻的约 10 MV/cm 的灾难性击穿场强。此外,团队使用随时间变化的介质击穿测量评估了介质的可靠性和寿命。通过改进介质沉积工艺,包括高温 (800 °C) 薄界面层和低温 (600 °C) 主体层,报告了在 3.5 MV/cm 的应力场和 7.8 MV/cm 的灾难性击穿场下的 10 年使用寿命。
实验细节
介电层生长:
(1)在 Sn 掺杂 β-Ga2O3(010)衬底上外延生长 500 nm 厚的 β-Ga2O3 层。
(2)采用 MOCVD 方法,以三乙基镓(TEGa)和 O2 为前驱体,生长温度 600°C,腔体压力 60 Torr,Ga2O3 生长速率 6.3 nm/min。
(3)在 800°C 下生长 Al2O3 介电层,生长速率 4.7 nm/min,总厚度 23.6 nm。
(4)先在 800°C 下生长 5 nm 界面层,然后温度降低至 600°C,继续沉积主体介电层,总厚度 21.8 nm。
结构与电学表征:
测量 Al2O3 层厚度,并验证其均匀性;分析 Al2O3 介电层的晶相;采用 DC 扫描(-10V 至 5V)和 AC 频率 1 MHz 测量 MOS 电容(MOSCAPs)。通过电压滞后(hysteresis)分析界面陷阱密度(Dit)。进一步测定深能级陷阱的密度和能级分布。评估击穿电场,确定 MOSCAPs 的介电可靠性。
创新点
该团队采用 MOCVD 实现 β-Ga2O3 和 Al2O3 介电层的原位生长,避免了空气暴露带来的界面污染,减少了工艺复杂性。
提出了先高温生长界面层(800°C),再低温生长主体层(600°C)的方案,兼顾了界面质量和介电层均匀性。
样品 A 在正偏下的击穿电场达 10 MV/cm,显著高于 600°C 介电层(5.6 MV/cm)。
样品 B 介电层击穿电场为 7.8 MV/cm,同时具有更好的均匀性。
结论
该团队通过 MOCVD 方法成功在 β-Ga2O3(010)上原位生长 Al2O3 介电层,并提出了高温界面层+低温主体层的双温度沉积策略(样品 B)。
研究表明,样品 A(800°C) 具有更低的界面陷阱密度、更高的击穿电场(10 MV/cm),但可能存在局部晶界泄漏问题。样品 B(800/600°C) 在界面质量、均匀性和可靠性方面表现更佳,预计在 3.5 MV/cm 应力场下寿命可达 10 年,是 β-Ga2O3 高功率 MOSFET 栅极介电层的更优选择。
研究证明了MOCVD 原位生长 Al2O3 在提升 β-Ga2O3 器件性能方面的巨大潜力,为未来高功率电子器件的发展提供了新的工艺方案。
图文内容
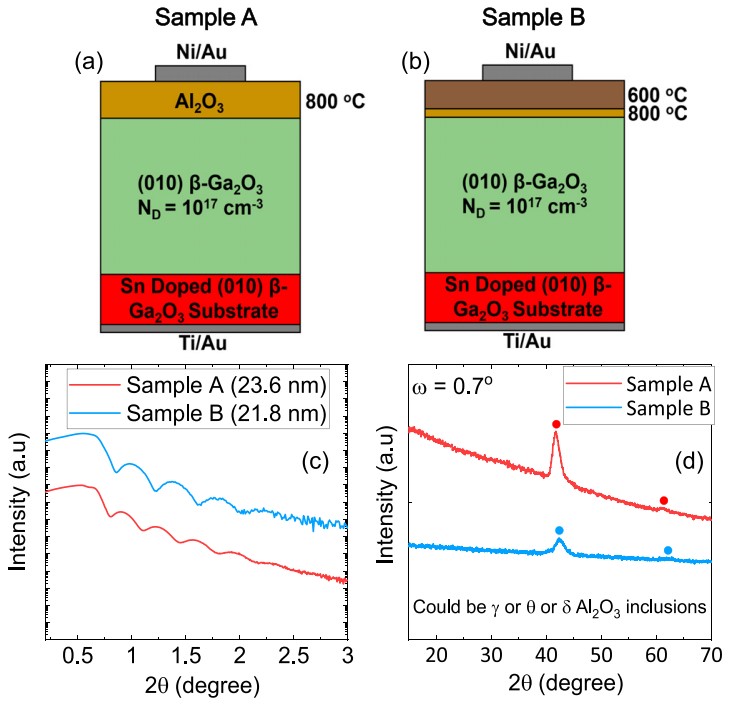
图 1. (a) 样品 A(800°C)和 (b) 样品 B(800/600°C)的 MOSCAP 结构示意图;(c) 样品 A 和样品 B 的 X 射线反射率图和 (d) GIXRD 光谱。
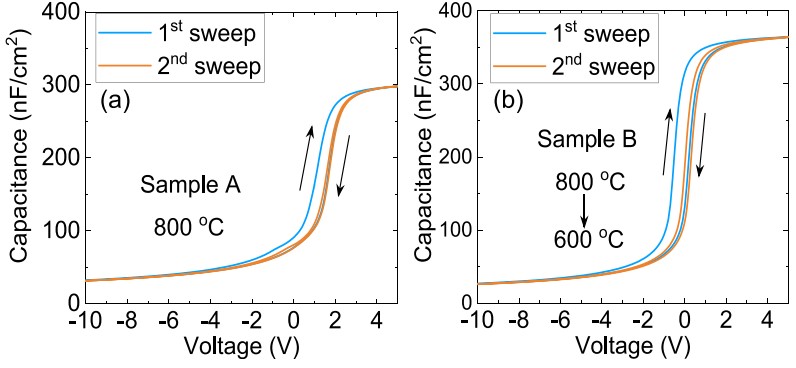
图 2. (a) 样品 A 和 (b) 样品 B 的电容-电压特性曲线的第一次和第二次扫描。在每种情况下,在第一次 D-A 扫描期间,MOSCAP 都经受了 10 分钟的累积应力。
DOI:
doi.org/10.1063/5.0234267