

【国际论文】日本国立材料研究所与FLOSFIA团队利用HVPE法实现高质量氧化镓薄膜生长
日期:2025-04-13阅读:683
由日本国立材料研究所与 FLOSFIA 的研究团队在学术期刊 Science and Technology of Advanced Materials 发布了一篇名为 Epitaxial lateral overgrowth of m-plane α-Ga2O3 by halide vapor phase epitaxy(通过 HVPE 法实现 m 面 α-Ga2O3 的外延横向生长)的文章。
背景
α-Ga2O3 作为一种具有超宽带隙(~5.3 eV) 的材料,尤其适用于高压功率电子器件。与广泛研究的 β-Ga2O3 相比,α 相拥有更高带隙、更小晶格常数不匹配的异质结构可选项和更高的理论击穿电压。但 α-Ga2O3 属于亚稳相,并且在生长过程中容易形成大量位错,影响器件性能。为了解决高密度位错的问题,研究中采用了横向外延生长(ELO) 技术,通过在模板上图案化掩膜,实现侧向扩展并降低缺陷。此前 m 晶面方向的 α-Ga2O3 此前尚未有成功的 ELO 成膜报道。
摘要
研究人员利用卤化物气相外延(HVPE)方法,在 m 面 α-Ga2O3 上实现了外延横向生长(ELO)。实验中,采用带有图案化 SiO2 掩膜的 m 面 α-Ga2O3/蓝宝石样品作为生长衬底。对于辐射状辐条图案掩膜,当辐条垂直于 (11-23) 方向时,获得了最高的横向生长速率。在该条件下,横向与纵向生长速率之比(L/V 比,L 为 α-Ga2O3 岛宽度增加的速率)高达 5.8。
该比值比先前在 a 面 α-Ga2O3 上使用 m 方向条纹掩膜所报告的高出约 3.3 倍,比在 c 面与 m 面 α-Ga2O3 上使用 a 方向条纹掩膜所报告的高出约 13 倍。当在与 (11-23) 方向垂直的条纹掩膜上(窗口/掩膜宽度分别为 2.5 μm/7.5 μm)进行 ELO 时,观察到 α-Ga2O3 在窗口区域选择性成核,形成具有平坦三角形截面的条状岛,并最终并合为致密薄膜。
透射电子显微镜(TEM)观察结果显示,横向生长区域的位错密度显著降低,这是由于掩膜有效阻断了种子层中位错的传播。研究人员认为这些成果将为基于 m 面 α-Ga2O3 的未来功率器件的实现提供重要支撑。
创新点
首次在 m-plane α-Ga2O3 上实现有效的 ELO 成膜,打破过往仅限于 c-、a-、r-plane 的限制。
发现沿 (11-23) 方向的横向生长率最高(34 μm/h),是最慢方向的 11 倍;
实现了高达 5.8 的 L/V 比值,为目前文献中最高。
使用简单结构即可实现显著降低的位错密度(约 107cm-2),对未来器件制备意义重大。
结合 SEM 与 TEM 揭示:横向生长区缺陷显著减少,而窗口与岛合并处仍有残留位错,提出进一步优化如厚膜斜面控制等建议。
总结
在本研究中,研究人员采用 HVPE 法在 m 面上实现了 α-Ga2O3 的外延横向生长。通过使用辐射状辐条图案掩膜,研究了横向生长速率的各向异性,发现沿 (11-23) 方向具有最高的横向生长速率。
具体而言,沿 (11-23) 方向的横向生长速率为 34 μm/h,约为沿 (11-23) 方向(该方向生长最慢)的11倍。在 (11-23) 方向上,L/V比达到 5.8,分别为先前报道的在 a 面 α-Ga2O3 使用 m 方向条纹掩膜以及在 m 面或 c 面 α-Ga2O3 使用 a 方向条纹掩膜时的 3.3 倍和 13 倍。
当采用窗口/掩膜宽度为 2.5/7.5 μm,且对准以实现最高横向生长速率的条纹掩膜图案进行 ELO 时,在不到 30 分钟内便形成了致密薄膜。
从该致密薄膜的俯视图与截面 TEM 图像中可见,横向生长区域的位错密度明显降低,虽然位错在窗口区域仍有传播,并在并合边界处形成新的位错。此外,除位错之外,还观察到了平面缺陷。因此,作者认为尽管生长条件仍需进一步优化,但此项技术将在高性能 α-Ga2O3 器件的发展中发挥重要作用。
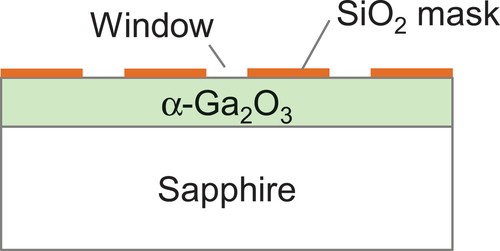
图 1. 带有图案掩膜的 m 平面 α-Ga2O3/蓝宝石横截面示意图。

图 2. (a) 在径向辐轮图案上生长的样品的平面扫描电子显微镜图像。(b) 横向生长率与辐条方向的坐标图。
DOI:
doi.org/10.1080/14686996.2025.2485869