

【国内论文】中电科集团公司第五十研究所---快速热退火对采用混合原子层沉积法制备的微米级 Zn 掺杂Ga₂O₃薄膜特性的影响
日期:2025-05-12阅读:755
由中国电子科技集团公司第五十研究所的研究团队在学术期刊 Nanomaterials 发布了一篇名为 Effect of Rapid Thermal Annealing on the Characteristics of Micro Zn-Doped Ga2O3 Films by Using Mixed Atomic Layer Deposition(快速热退火对采用混合原子层沉积法制备的微米级 Zn 掺杂 Ga2O3 薄膜特性的影响)的文章。
项目支持
该研究得到了上海市青年科技英才扬帆计划(Nos. 22YF1446200,23YF1444300)、上海市超级博士后激励计划(No. 2023078)、安徽省高校自然科学研究项目(KJ2021A1089)以及滁州学院科研启动基金资助项目(2023qd94)的资助。
主要内容
该研究采用一步混合原子层沉积(ALD)方法沉积了微量 Zn 掺杂 Ga2O3(GZO)薄膜,并通过后续热处理工程对其进行调控。系统研究了 Zn 掺杂与退火温度对薄膜结构特性及电学性能的影响。将 Ga2O3 的等离子体增强 ALD 与 ZnO 的热 ALD 相结合,能够实现 Zn 掺杂 Ga2O3 薄膜的快速沉积速率(0.62 nm/超循环)、高密度(4.9 g/cm3)以及平滑界面(平均表面粗糙度 Rq = 0.51 nm)。
GZO 薄膜通过分别设置 400、600、800 和 1000 °C 的退火温度完成热处理工程。在 800 °C 退火后,GZO 薄膜展现出典型的晶体结构(Ga2O3 为 β 相,ZnO 为六方纤锌矿结构)、较低的表面粗糙度(平均 Rq = 2.7 nm),以及更高的平均击穿电场强度(16.47 MV/cm)。特别值得注意的是,与未退火的纯 GZO 薄膜相比,800 °C退火后的击穿电场提高了约 180 %。该薄膜在退火后氧空位(OV)含量仅为 34.8 %,显著提升了其电学性能。
这些研究成果为高质量 ALD 掺杂材料的发展提供了新思路,并推动 GZO 在高功率电子器件及高灵敏度器件中的应用。
总结
该研究成功通过原子层沉积(ALD)结合快速热退火工艺制备了 Zn 掺杂的 Ga2O3 薄膜,并对其优化后的热处理工程进行了研究。通过精确控制逐层沉积过程,制备出的 GZO 薄膜具有优良的形貌和结构特性。随后在 400–1000 °C 范围内进行热处理,诱导 GZO 薄膜的可控结晶化。
其中,在 800 °C 退火条件下的 GZO 薄膜相比于未退火样品及其他温度退火样品表现出更优异的击穿电场性能。研究表明薄膜电学性能与内部氧空位行为密切相关。800 °C 退火后薄膜氧空位浓度显著降低,且具有优异的结构特性,从而显著改善了金属氧化物半导体器件(MOS)的击穿特性。
此外,文中还对 GZO 薄膜的击穿机制进行了详细讨论。所开发的 GZO 材料体系在先进光电子器件领域展现出巨大潜力,特别适用于 UV-C/UV-B 波段的柔性光探测器,以及通过在 n-n 结和异质结晶体管中的应用推动其在高功率电子器件领域的发展。
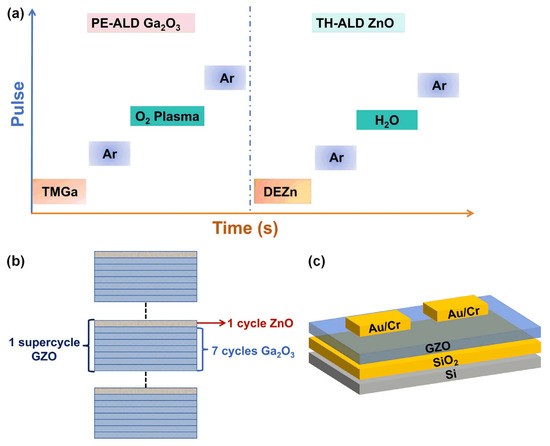
图 1. (a)GZO 薄膜沉积工艺,包括 Ga2O3 和 ZnO 单层沉积工艺;(b)由七层 Ga2O3 和一层 ZnO 组成的 GZO 层叠薄膜结构示意图;以及(c)基于 GZO 结构的 MOS 器件结构。

图 2:(a)偏振角和相位角的 SE 测试和拟合曲线;(b)原始 GZO 薄膜的折射率 n 和消光系数 k 随波长的变化;(c)GZO、Ga2O3 和 ZnO 薄膜的超循环理论叠加和实测沉积率;(d)不同快速退火温度下 GZO 薄膜的 XRD 图。
DOI:
doi.org/10.3390/nano15070499