

【会员论文】西电郝跃院士、张进成教授团队:通过O₂等离子体处理实现界面改性--诱导高性能垂直NiOₓ/β-Ga₂O₃异质结二极管
日期:2025-05-23阅读:648
由西安电子科技大学郝跃院士、张进成教授研究团队的张春福教授和陈大正副教授在学术期刊 Applied Surface Science 发布了一篇名为Interface modification-induced high-performance vertical NiOx/β-Ga2O3 heterojunction diodes via O2 plasma treatment(通过 O2 等离子体处理实现界面改性--诱导高性能垂直 NiOx/β-Ga2O3 异质结二极管)的文章。
项目支持
该研究得到国家重点研发计划(2022YFB3605402)、国家自然科学基金(62274132、62004151、62274126)的资助。
背 景
超宽禁带半导体β相氧化镓(β-Ga2O3),拥有带隙约 4.8 eV,击穿场强约 8 MV/cm的优秀特性,在下一代电力电子器件领域展现出巨大潜力。然而,β-Ga2O3 缺乏有效的 p 型掺杂,这阻碍了其双极型器件的发展。双极型器件相比单极型器件通常具有更低的导通电阻和更高的击穿电压。氧化镍(NiOx)是一种有前景的 p 型半导体材料(带隙 3.6-4.0 eV,空穴浓度可调范围宽),可用于与 n 型 β-Ga2O3 构建异质结,且 NiOx 可在较低温度下沉积。垂直结构的 NiOx/β-Ga2O3 异质结二极管(HJDs)在高功率应用方面已显示出潜力。但目前仍面临挑战,主要包括:金属/NiOx 界面处欧姆接触电阻较高;NiOx/β-Ga2O3 异质结界面的界面态和能带对准调控不足。这些问题限制了器件的电流传导能力,增大了导通电阻,并可能降低击穿电压。等离子体处理是一种常见的表面改性技术,可以改变材料的表面态、化学计量比和功函数,从而改善接触和界面特性。特别是氧等离子体处理,能够有效调控材料中的氧空位和间隙氧。
摘 要
NiOx/β-Ga2O3 异质结的发展是克服双极 Ga2O3 功率器件技术限制的关键途径。然而,界面工程的发展以及金属-NiOx 界面欧姆特性的研究在很大程度上仍未得到探索。在本研究中,研究团队证明了在特定时间进行 O2 等离子体处理可以实现 Ni/NiOx/β-Ga2O3 异质结二极管的低欧姆接触电阻(5.8×10-4 Ω·cm2)和高击穿电压(1340 V),其性能优于大多数最先进的 Ga2O3 异质结二极管和无任何终端结构的肖特基势垒二极管。对比分析表明,界面处 NiOOH 含量的变化在很大程度上影响着界面特性和器件的正向特性。经过特定时长的 O2 等离子体处理后,NiOOH 的增加改变了 NiOx 的功函数和价带最大值(VBM),进一步影响了界面能带结构,导致 NiOx 表面空穴浓度显著增加,界面载流子传输能力增强,欧姆接触电阻大幅降低。这项研究填补了 β-Ga2O3 异质结中金属 - 半导体界面特性与欧姆传输机制之间的知识空白,为 β-Ga2O3 异质结器件的设计和优化提供了重要见解。
研究亮点
• O2 等离子体处理使 NiOx/β-Ga2O3 异质结二极管实现了低欧姆电阻和高击穿电压。
• 界面处 NiOOH 含量的变化会影响界面特性以及器件的正向特性。
• 特定的氧气等离子体处理时长可改变镍/氧化镍界面,从而改善欧姆接触性能。
总 结
研究团队开发了一种用于高性能 NiOx/β-Ga2O3 异质结二极管(HJD)的可控界面处理技术,采用 O2 等离子体处理。该方法通过调节能带结构和降低 Ni/NiOx 界面的欧姆接触电阻显著提升了器件性能。进行 1 分钟的 O2 等离子体处理使表面形貌更平滑,如原子力显微镜(AFM)图像所示,减少了界面缺陷并改善了金属-半导体接触质量。XPS 分析表明 NiOOH 和 Ni2O3 的含量增加,导致表面空穴浓度提高,载流子传输性能改善。NiOOH 含量的增加在提升器件性能方面起着关键作用。NiOOH 的强偶极子导致表面态能级发生位移,从而增加了表面态密度。这反过来又通过降低接触势垒和增加载流子跨越势垒的概率,增强了界面处载流子的传输能力。这些化学和结构上的变化共同调节了能带结构,从而形成了更有利的能带对准,并降低了特定导通电阻。因此,经过处理的 HJDs 展现出显著更高的巴利加优值(BFOM)为 0.675 GW/cm2,比未处理的器件提高了 209.63%。这项研究为优化金属-半导体界面提供了一种新策略,为高性能 β-Ga2O3 器件的商业化和规模化制造铺平了道路。
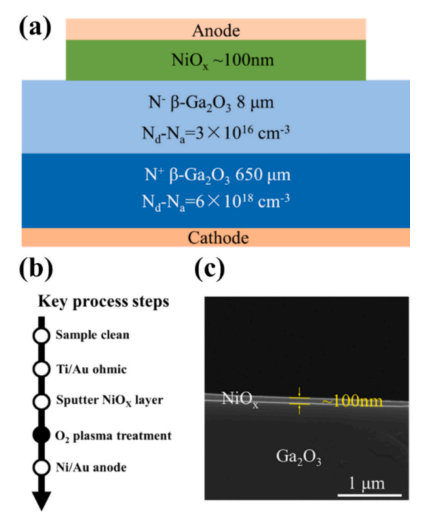
图 1:(a)垂直 NiOx/β-Ga2O3 HJD 的截面示意图和关键制造步骤(b)样品的关键工艺信息(c)溅射沉积 NiOx 后样品的截面 SEM 图像。
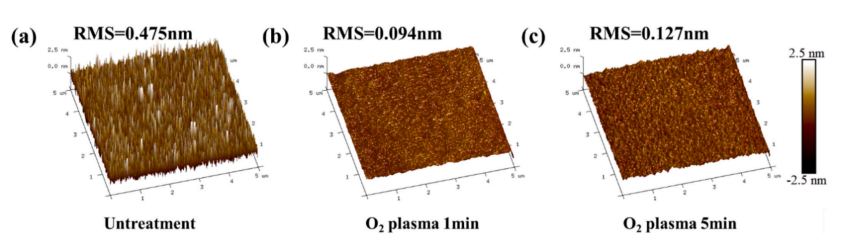
图 2. 不同 O2 等离子处理条件下 NiOx 薄膜的原子力显微镜图像和表面粗糙度:(a)未处理;(b)O2 等离子处理 1 分钟;(c)O2 等离子处理 5 分钟。
DOI:
doi.org/10.1016/j.apsusc.2025.163147