

【国际论文】原位MOCVD Al₂O₃/β-Ga₂O₃和Al₂O₃/β-(AlₓGa₁₋ₓ)₂O₃ MOSCAP的电学和结构表征
日期:2025-05-29阅读:752
由美国俄亥俄州立大学的研究团队在学术期刊 Journal of Applied Physics 发布了一篇名为 Electrical and structural characterization of in situ MOCVD Al2O3/β-Ga2O3 and Al2O3/β-(AlxGa1−x)2O3 MOSCAPs(原位 MOCVD Al2O3/β-Ga2O3 和 Al2O3/β-(AlxGa1−x)2O3 MOSCAP 的电学和结构表征)的文章。
摘要
本研究探讨了通过原位金属有机化学气相沉积(MOCVD)在不同温度下生长的 Al2O3 介电层沉积于 (010) β-Ga2O3 和具有不同铝组分的 β-(AlxGa1−x)2O3 薄膜上的金属-氧化物-半导体电容器(MOSCAPs)的电学与结构特性。在 Al2O3/β-Ga2O3 MOSCAPs 中,器件的电学性能表现出对 Al2O3 沉积温度的强烈依赖性。当沉积温度为 900 °C 时,观察到电压迟滞显著减小(约 0.3 V),反向击穿电压提高至 74.5 V,对应于 Al2O3 中的击穿电场为 5.01 MV/cm,β-Ga2O3 中为 4.11 MV/cm(在反向偏压下)。相比之下,在 650 °C 沉积下,电压迟滞增大(约 3.44 V),反向击穿电压下降至 38.8 V,Al2O3 和 β-Ga2O3 中的击穿电场分别为 3.69 和 2.87 MV/cm。但该条件下器件在正向偏压下的击穿电场表现出优异性能,从 900 °C 时的 5.62 MV/cm 提高至 650 °C 时的 7.25 MV/cm。高分辨扫描透射电子显微镜(STEM)显示,900 °C 下沉积所得薄膜结晶性更优,界面更加清晰,从而增强了器件的反向击穿性能。在 Al2O3/β-(AlxGa1−x)2O3 MOSCAPs 中,随着 Al 含量(x)从 5.5% 增加至 9.2%,载流子浓度明显降低,β-(AlxGa1−x)2O3 中的反向击穿电场从 2.55 提高到 2.90 MV/cm,Al2O3 中则从 2.41 提升至 3.13 MV/cm。同时,在正向偏压下,Al2O3 中的击穿电场也随铝含量由 5.5% 增加至 9.2%,从 5.0 提高至 5.4 MV/cm。STEM 成像结果确认了 Al2O3 和 β-(AlxGa1−x)2O3 层具有良好的组分均匀性与化学计量比一致性。上述研究结果表明,Al2O3/β-Ga2O3 以及 Al2O3/β-(AlxGa1−x)2O3 MOSCAPs 具备优异的电学性能、高击穿电场与出色的结构质量,凸显其在高功率电子器件应用中的潜力。
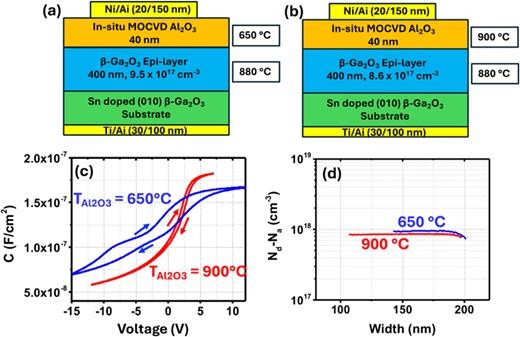
图 1. 在 (a) 650 和 (b) 900 °C 下沉积 Al2O3 的 Al2O3/β-Ga2O3 MOSCAP 的示意图。(c) 不同温度下沉积 Al2O3 的 MOSCAP 的 C-V 特性(频率为 100 kHz)。(d) 从 C-V 曲线中提取的净载流子浓度随深度变化的曲线。

图 2. (a) Al2O3/β-Ga2O3 MOSCAP 的反向和 (b) 正向 J-V 特性,其中 Al2O3 沉积温度分别为 650 ℃ 和 900 ℃。
DOI:
doi.org/10.1063/5.0256525