

【会员论文】复旦大学---与质子辐照诱导缺陷相关的β-Ga₂O₃肖特基二极管的退化机制
日期:2025-07-04阅读:582
由复旦大学的研究团队在本次 ISPSD 2025 学术会议上发表了一篇名为 Degradation Mechanisms of β-Ga2O3 SBD Associated with Proton Irradiation-Induced Defects(与质子辐照诱导缺陷相关的 β-Ga2O3 肖特基二极管的退化机制)的文章。
项目申报
本研究部分由国家自然科学基金委员会(U24A20298)和安徽省智能微系统工程技术研究中心开放基金项目(ETRCIM202404)资助。
背 景
β-氧化镓(β-Ga2O3)作为一种超宽禁带半导体,因其高击穿场强和优异的材料特性,在电力电子领域备受关注,特别是在航空航天等需要承受严苛辐射环境的应用中。在功率器件中肖特基势垒二极管是作为最基本和重要的器件之一。空间环境中的高能粒子会对半导体器件造成损伤,引入晶格缺陷,导致器件性能退化,影响其长期可靠性。因此,研究质子辐照对 β-Ga2O3 SBDs 性能的影响,并深入理解其背后的物理退化机制,对于评估和提升 Ga2O3 器件在空间等辐射环境下的可靠性至关重要。目前,关于辐照如何在微观层面(通过引入何种缺陷、激活何种泄漏机制)导致 Ga2O3 器件宏观性能退化的研究尚不充分。
主要内容
本文重点研究了 5 MeV 质子辐照对 β-Ga2O3 肖特基势垒二极管(SBD)电气性能的影响,旨在阐明与缺陷和能带相关的退化机制及行为。当 β-Ga2O3 SBDs 受到 1×1013 n/cm2 的辐照剂量时,会发生若干变化。β-Ga2O3 SBDs 的正向电流密度下降,势垒高度增加 0.2 eV,理想因子从 1.056 恶化至 1.092。根据循环伏安(CV)特性,外延层中的载流子浓度显著下降,从 1.05×1016 cm-3 降至 0.32×1016 cm-3。这种减少归因于漂移层中的陷阱态,导致势垒高度增加。此外,温度依赖性 IV 测量表明,β-Ga2O3 SBDs 在质子辐照后反向漏电流由 Poole-Frenkel 发射(PFE)机制引起。DLTS 测量进一步揭示,质子辐照后,陷阱态 Ec-0.82 eV 分裂为 Ec-0.72 eV、Ec-0.81 eV 和 Ec-1.04 eV。相对较浅的陷阱态 Ec-0.72 eV,其捕获截面为 2.25×10-12 cm-2,对 PFE 机制有贡献并主导了陷阱辅助漏电流。最终,陷阱激活能的降低(从 0.82 eV 到 0.72 eV)与肖特基势垒高度的增大(从 0.90 eV 到 1.18 eV)共同导致 β-Ga2O3 SBDs 中正向导通和反向漏电流的退化。
总 结
本文研究了质子辐照对 β-Ga2O3 SBD 器件电气性能的影响,并提出了反向漏电流辐照退化模型。质子辐照诱导的体陷阱是电气性能退化的主要原因。此外,通过温度依赖性 I-V 测量,分析了反向漏电流变化的机制。研究表明,辐照后反向漏电流的变化归因于 Poole-Frenkel 发射(PFE)。此外,通过 DLTS 测量在辐照后检测到激活能分别为 Ec-0.72 eV、Ec-0.81 eV 和 Ec-1.04 eV 的体陷阱。PFE 可归因于相对较浅的深能级陷阱(Ec-Et=0.72 eV)。较低的陷阱激活能(从 0.82 eV 降至 0.72 eV)和较高的势垒高度(从 0.90 eV 升至1.18 eV)导致陷阱辅助漏电流增强和热电效应(TE)抑制,从而导致反向漏电流性能显著退化。本研究为提升 β-Ga2O3 SBD 的可靠性和性能提供了关键见解,并为未来器件设计提供了宝贵指导。
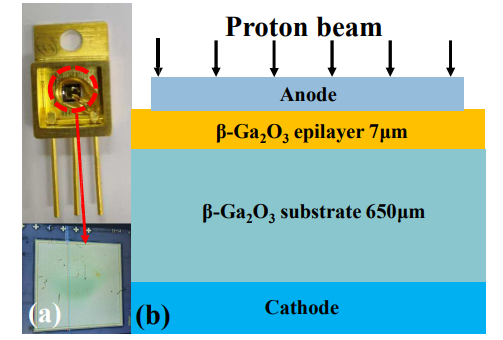
图1. (a) 封装和芯片 (b) β-Ga2O3 反向偏置二极管(SBD)的示意性横截面图。
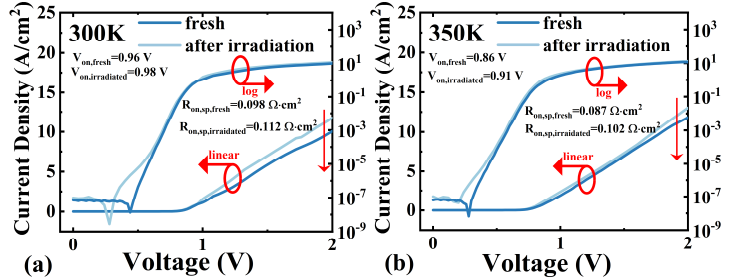
图2. (a) 300 K时和 (b) 350 K时,正向I-V特性曲线(线性坐标和半对数坐标)。