

【国际论文】KAUST成功研制低成本氧化镓pseudo JBS功率器件
日期:2025-09-15阅读:437
由阿卜杜拉国王科技大学(KAUST)李晓航团队在学术期刊 APL Materials 发布了一篇名为 Unipolar β-Ga2O3 Pseudo-junction barrier Schottky diodes via Low-Cost magnesium diffusion process(基于低成本镁扩散工艺的单极性 β-Ga2O3 伪结势垒肖特基二极管)的文章。
背 景
超宽禁带半导体(UWBG)因其在未来功率电子电路中的潜力受到广泛关注。其中,β-氧化镓(β-Ga2O3)以其约 4.8 eV 的超宽带隙、高击穿场强(约 8 MV/cm)及低成本块体衬底生长工艺,成为下一代高压功率器件的理想材料。二极管作为功率电子电路的重要组成部分, JBS 二极管通过在肖特基接口附近引入 p 型网格,实现低正向压降同时增强击穿电压。然而,由于缺乏可靠的 p 型 β-Ga2O3,人们探索了包括 p 型 NiOx 在内的替代材料,但存在带隙较低、晶格匹配问题以及界面复合等挑战。近年来,镁(Mg)扩散被用于形成高阻挡电子层,在 GaN 和 β-Ga2O3 器件中展现出改善接触电阻和阻挡电流的潜力。然而,现有方法如 Mg 掺杂旋涂玻璃(SOG) 或高温 (>1000 °C) 扩散复杂且成本高。本文工作提出了一种低成本、室温兼容的 Mg 扩散方法,直接在 β-Ga2O3 衬底上形成高阻挡区域,实现 SBD 器件的高击穿电压,同时降低工艺复杂度和成本,为 β-Ga2O3 JBS 器件设计提供了一条可行路径。
主要内容
β-氧化镓 (Ga2O3) 结势垒肖特基二极管具有优异的击穿特性和高效率,但由于缺乏 p 型 Ga2O3,人们通常采用诸如 NiOx 等替代材料,这会带来晶格匹配和温度稳定性方面的挑战。本研究报道了一种通过镁 (Mg) 扩散工艺实现的单极 Ga2O3 二极管,用以形成高电阻电子阻挡区。本工作开发的 Mg 扩散工艺采用室温兼容的化学处理,随后进行 800°C 的退火,相较于文献中已有方法温度更低。因此,该方法可降低器件加工温度需求,从而降低成本。最终器件实现了约 109 的开关比 (Ion/Ioff),约 0.9 V 的拐点电压,以及 596 V 的击穿电压。此外,该器件在 100 至 500 K 范围内均能稳定工作,凸显了其在宽温区电子器件中的应用潜力。
结 论
本工作展示了一种通过将镁(Mg)扩散到β-Ga2O3 衬底选定区域以形成高阻挡区的 β-Ga2O3 肖特基二极管(SBD)。所提出的方法提供了一种低成本、无硅的 Mg 扩散优化方案。实验制备的 SBD 在 Mg 扩散区域的性能优于普通 SBD;该二极管在显著提升击穿电压的同时,没有对导通态特性造成严重影响。最后,该二极管在宽温度范围内表现出良好的性能,显示出其在极端环境电子器件中的应用潜力。
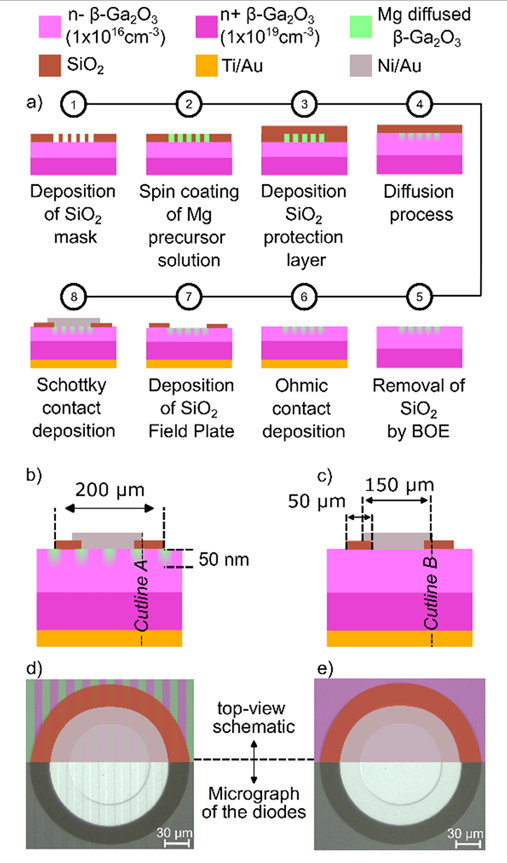
图1 (a) 含有 Mg 扩散区域的所提 β-Ga2O3 SBD 制备工艺的图示说明;(b)(c) 分别为 SBD-1 与 SBD-2 的截面示意图;(d)(e) 分别为所制备 SBD-1 与 SBD-2 的俯视示意图及显微照片。
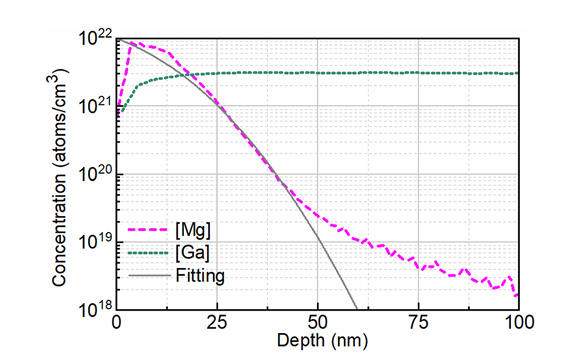
图2 SIMS 测得的 β-Ga2O3 薄膜中 Mg 浓度分布。
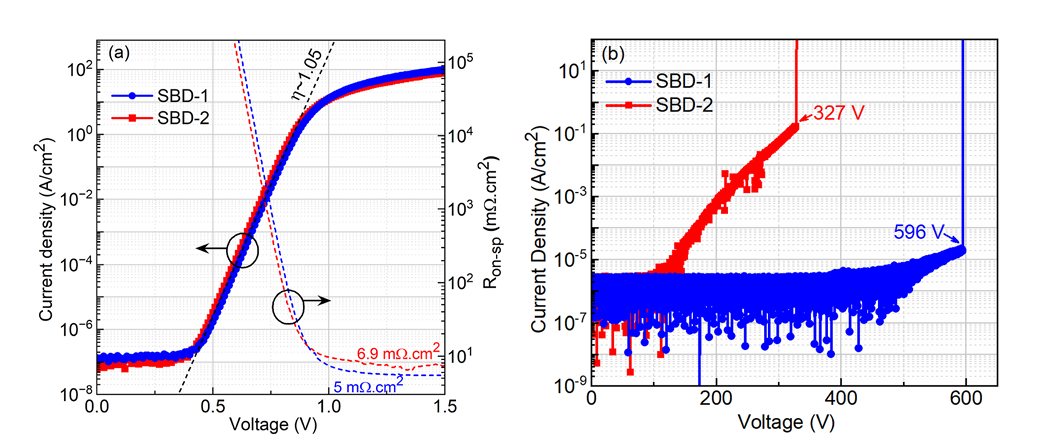
图3 (a) SBD-1 与 SBD-2 的正向偏压特性;(b) SBD-1 与 SBD-2 的反向击穿特性。
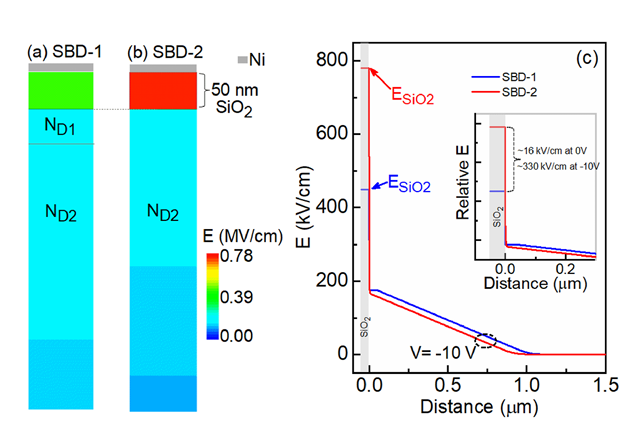
图4 (a)(b) 在 −10 V 反向偏压下,SBD-1 与 SBD-2 终端结构区域的 TCAD 模拟电场分布;(c) 沿垂直切线提取的一维电场分布。假设 ND1 与 ND2 的 n 型掺杂浓度分别为 1014 和1016 cm−3,且在 SBD-1 中 ND1 区厚度保持为 50 nm。
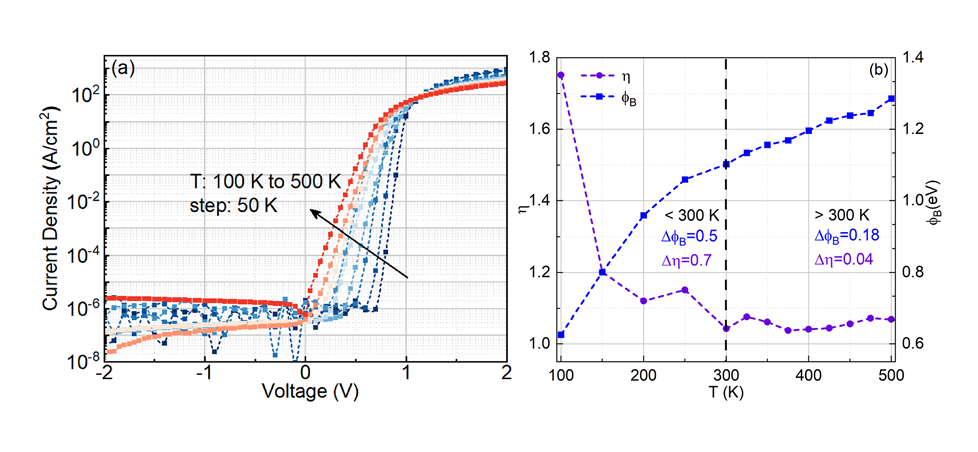
图5 (a) 所提 SBD-1 在不同温度下的 I–V 特性;(b) 基于传统 TE 模型从 I–V 特性中提取的 ΦB 与 η 的数值。
DOI:
doi.org/10.1063/5.0272582