

【国际论文】在(001)β-Ga₂O₃ 上利用 HCl 气体蚀刻制备 β-Ga₂O₃/气隙结构
日期:2025-09-17阅读:430
由日本国立物质材料研究所的研究团队在学术期刊 Science and Technology of Advanced Materials: Methods 发布了一篇名为 Fabrication of β-Ga2O3/air-gap structures on (001) β-Ga2O3 using HCl gas etching(在(001)β-Ga2O3 上利用 HCl 气体蚀刻制备β-Ga2O3/气隙结构)的文章。
背 景
β-Ga2O3 是一种新兴的宽禁带半导体材料,具有广阔的应用潜力。其临界击穿场强高达约 8 MV/cm,同时兼容熔融生长工艺,可实现高质量且具规模化潜力的晶圆制备。得益于相较传统宽禁带半导体(如 SiC、GaN 和金刚石)的这两大优势,β-Ga2O3 越来越被视为下一代低损耗、高电压功率器件的有前景候选材料。此外,β-Ga2O3 还具有本征的日盲光响应与气敏特性,分别有助于开发无需滤波器的日盲光探测器和气体传感器。其机械性能同样突出,杨氏模量约 261 GPa,声速约 6623 m/s,与硅相当,使其非常适合微机电系统(MEMS)的应用。这些特性表明,β-Ga2O3 有望作为一个多功能平台,支撑未来电子、光电子及先进传感领域中机电耦合与可调谐器件的发展。其潜在应用包括:高功率、高频系统中的射频 MEMS 器件(如国防、无线基础设施、卫星),以及共振增强型日盲紫外探测器和气体传感器等。
主要内容
本研究在 (001) 衬底上通过 HCl 气体晶向蚀刻成功制备了 β-Ga2O3/气隙结构。实验表明,在 650 °C、250 Pa 的 HCl 分压条件下,(001) 晶面上的垂直蚀刻速率为 0.10 μm/min,而沿 <010> 方向的横向蚀刻速率则高达 0.70 μm/min。这种显著的正交各向异性蚀刻特性,使得无需晶圆键合或转移工艺,即可直接形成 β-Ga2O3/气隙结构,例如悬臂梁与空气桥。该简便方法兼容常用的 (001) 衬底,为 β-Ga2O3 基微机电系统 (MEMS) 及功率电子器件的集成提供了有前景的技术路径。
总 结
本研究揭示了 (001) β-Ga2O3 在 HCl 气体蚀刻下表现出显著的各向异性,其中沿 <010> 方向的横向蚀刻速率可达 0.70 µm/min,约为垂直蚀刻速率 0.10 µm/min 的七倍。利用这一高横向/垂直蚀刻速率比,成功直接制备了悬臂梁和空气桥等基本机械悬挂结构,这些结构是 MEMS 器件的核心单元。鉴于大多数垂直功率器件均基于 (001) 取向衬底制造,本研究所示的 HCl 气体蚀刻方法在 MEMS 与功率器件的单片集成中展现出较大应用前景。值得注意的是,针对 β-Ga2O3 的各向异性晶体蚀刻方法已有多种报道,包括热磷酸蚀刻、光电化学蚀刻、金属辅助化学蚀刻、氢环境各向异性热蚀刻、形成气体蚀刻、Ga 熔剂蚀刻、三乙基镓气体蚀刻以及叔丁基氯气体蚀刻。虽然本研究集中于 HCl 气体蚀刻,但所示的气隙结构形成也可能通过这些替代蚀刻法实现。然而,需要进一步研究以确定在何种条件下横向蚀刻速率能显著高于垂直速率。
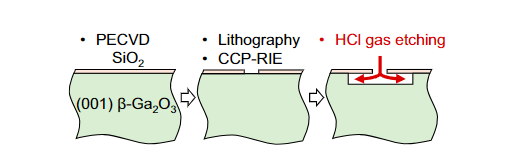
图 1. (001) β-Ga2O3 衬底上选择性区域 HCl 气体蚀刻的工艺流程示意图。
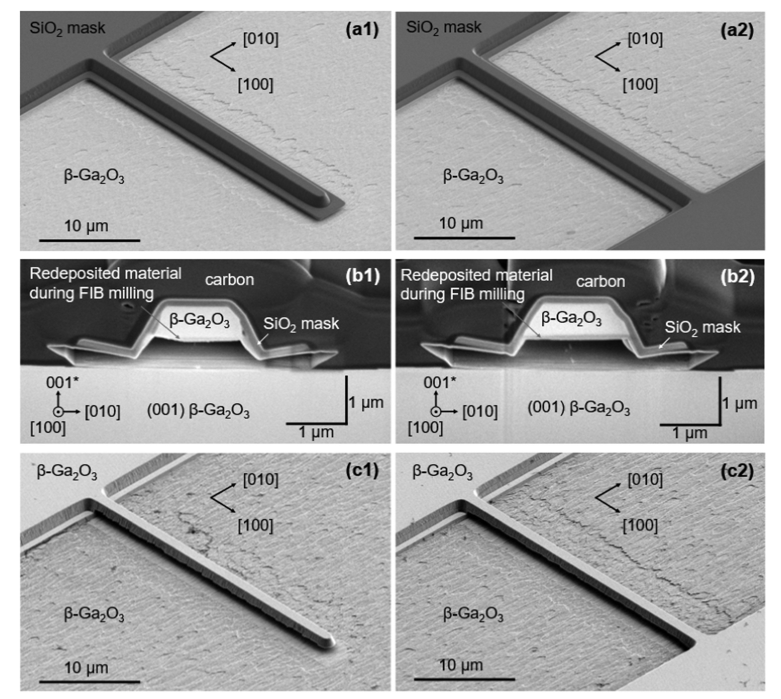
图 2. 倾斜 54° 的 SEM 图像总结,展示了在 (001) β-Ga2O3 衬底上制备的 (a1)–(c1) 悬臂梁与 (a2)–(c2) 空气桥结构。图像 (a1) 与 (a2) 为 HCl 气体蚀刻后的结果;图像 (b1) 与 (b2) 为 (a1) 与 (a2) 对应的截面视图;图像 (c1) 与 (c2) 为去除 SiO2 掩膜后的结构。
DOI:
doi.org/10.1080/27660400.2025.2554046









