

【国际论文】美国麻省大学洛厄尔分校:基于all-LPCVD生长与无等离子体Ga辅助刻蚀的蓝宝石衬底准垂直β-Ga₂O₃ SBD
日期:2025-10-27阅读:377
由美国马萨诸塞大学洛厄尔分校的研究团队在学术期刊 APL Electronic Devices 发布了一篇名为 Quasi-vertical β-Ga2O3 Schottky diodes on sapphire using all-LPCVD growth and plasma-free Ga-assisted etching(基于 all-LPCVD 生长与无等离子体 Ga辅助刻蚀的蓝宝石衬底准垂直 β-Ga2O3 肖特基二极管)的文章。
背 景
β-氧化镓(β-Ga2O3)因其超宽禁带、高击穿场强以及可低成本制备大尺寸单晶等优点,是下一代功率电子器件的理想材料。垂直结构器件能够承受更高的电压和电流,但其制造依赖于高质量的同质外延衬底,而这类衬底目前成本高昂且热导率低。在蓝宝石等异质衬底上生长 Ga2O3 是一种成本效益更高的替代方案,但面临晶格失配的挑战。 采用有一定偏切角的蓝宝石衬底有助于促进台阶流生长,提高薄膜质量。垂直器件的另一个关键工艺是台面刻蚀,用于器件隔离。 传统的等离子体干法刻蚀会引入表面损伤,降低器件性能,因此开发一种无损伤的刻蚀技术至关重要。
主要内容
本研究展示了在 c 面蓝宝石衬底上制备的准垂直 β-Ga2O3 肖特基势垒二极管(SBD)。该器件采用了一种完全基于低压化学气相沉积(LPCVD)、无等离子体的工艺流程,该工艺集成了高质量 β-Ga2O3 异质外延薄膜的外延生长和原位镓(Ga)辅助的 β-Ga2O3 蚀刻。在 6° 偏角的 c 面蓝宝石上生长了 6.3 μm 厚的(-201)取向 β-Ga2O3 外延层结构。该结构包括一个中等 Si 掺杂(浓度为 2.1 × 1017 cm−3)、3.15 μm 厚的漂移层和一个重掺杂(浓度为 1 × 1019 cm−3)的接触层,生长在一个非故意掺杂的缓冲层上。通过 Ga 辅助的无等离子体 LPCVD 蚀刻实现了台面隔离,形成了倾角约 60°、蚀刻深度为 3.6 μm 的台面侧壁。制备的 SBD 表现出优异的正向电流-电压特性,包括 1.22 V 的开启电压、1.29 的理想因子和 0.83 eV 的肖特基势垒高度。测得的最小微分比导通电阻为 8.6 mΩ cm2,器件展示了高电流密度能力(在 5 V 时达到 252 A/cm2)。电容-电压分析揭示了净载流子浓度为 2.1 × 1017 cm−3,且在 β-Ga2O3 漂移层中均匀分布。在 25°C 至 250°C 的温度范围内进行的温度依赖性 J-V-T 测量表明,其传输机制以热电子发射为主,并具有强大的热稳定性。在此温度范围内,肖特基势垒高度从 0.80 eV 增加至 1.16 eV,理想因子从 1.31 适度上升至 1.42。反向漏电流保持在较低水平,从 25°C 时的 ~5 × 10−6 A/cm2 增加到 250°C 时的 ~1 × 10−4 A/cm2,开关电流比(Ion/Ioff)从 ~1 × 107 降至 5 × 105。器件实现的击穿电压范围在 73 至 100 V 之间,对应的平行板电场强度为 1.66–1.94 MV/cm。这些结果凸显了基于 LPCVD 生长和蚀刻的 β-Ga2O3 器件在高性能、高热稳定性的功率电子应用中的潜力。
创新点
●首次将高质量外延生长与无损伤原位刻蚀完全集成在同一个LPCVD系统中,为 Ga2O3 器件的制造提供了一条全新的、简化的、低损伤的工艺路线。
●成功应用并验证了镓辅助的 LPCVD 刻蚀技术在实际器件制造中的可行性,该技术避免了传统等离子体刻蚀带来的晶格损伤。
●在低成本的蓝宝石衬底上成功制备出高性能的准垂直 SBD,为推动 Ga2O3 功率器件的商业化提供了有价值的参考。
总 结
本研究首次实现了在绝缘蓝宝石衬底上,通过完全基于等离子体自由 LPCVD 工艺(从外延生长到原位蚀刻实现台面隔离)制备的准垂直 β-Ga2O3 肖特基势垒二极管。通过采用原位镓辅助 LPCVD 蚀刻技术,实现了等离子体损伤为零的台面隔离,蚀刻深度达 3.6 μm,侧壁倾角约 60°。所得肖特基势垒二极管展现出优异的正向特性:理想因子达 1.29,肖特基势垒高 0.83 eV,且具有 8.6 mΩ cm2 的低导通电阻。温度依赖性 I-V-T 分析表明,该器件具有以热电子发射为主导的传输特性,具有很强的热稳定性,肖特基势垒高度和理想因子略有增加,这可能是由于界面不均匀性和势垒不均匀性所致。器件展现出低且稳定的反向漏电流特性,击穿电场高达 1.94 MV/cm。尽管击穿电压受限于相对较高的漂移层掺杂浓度,但其反向阻断能力、强劲的正向导通性能及优异的热性能,彰显了 LPCVD 生长并蚀刻的 β-Ga2O3 器件的广阔前景。将外延与蚀刻集成于单一 LPCVD 平台,为新一代超宽带阻挡层功率电子器件提供了可扩展且低损伤的制备路径。这些成果也为在异质衬底上实现经济高效、耐高温的高压 β-Ga2O3 器件架构迈出了关键一步。

图1. (a) 采用 LPCVD 法在 6° 错位 c 面蓝宝石衬底上生长(-201) β-Ga2O3 薄膜制备的准垂直肖特基势垒二极管(SBD)示意截面图。该器件具有三层外延堆叠结构:1.05 μm 无意掺杂缓冲层、2.10 μm 厚 n+ 型 β-Ga2O3 接触层(掺杂浓度 Nd = 1 × 1019 cm−3)及 3.15 μm β-Ga2O3 漂移层(掺杂浓度 Nd = 2.1 × 1017 cm−3)。采用无等离子体 LPCVD 刻蚀技术,在 β-Ga2O3 漂移层进行 3.6 μm 深度刻蚀以实现台面隔离,并暴露 n+ 层用于阳极接触形成。(b) 倾斜(60° 倾角)截面场发射扫描电子显微镜图像,显示刻蚀侧壁轮廓及 3.6 μm 刻蚀深度。(c) 刻蚀台面区域沿AA′剖面线进行的原子力显微镜线扫描,证实侧壁倾角约 60° 且刻蚀深度为 3.6 μm。(d) 刻蚀台面区域沿 AA′ 剖面线进行的原子力显微镜线扫描,证实侧壁倾角约 60° 且刻蚀深度为 3.6 μm。(c) 沿蚀刻台面区域 AA′ 剖面线进行的原子力显微镜线扫描,验证了约 60° 侧壁倾角及 3.6 μm 蚀刻深度。(d) 分步制备流程示意图,包含 LPCVD 生长、原位蚀刻及金属化步骤以实现器件制造。

图2. 器件制备中使用的 LPCVD 生长异质外延 (-201) β-Ga2O3 外延堆叠结构的结构与表面形貌表征。(a) 顶视场发射扫描电子显微镜图像显示清晰的阶梯流表面形貌,表明具有高结晶质量和外延层层生长特性。(b) 表面力显微镜扫描显示薄膜表面平整,均方根粗糙度为 4.7nm。(c) X 射线衍射 ω-2θ 扫描呈现出与 (-201) β-Ga2O3 (-h0l) 晶面家族对应的强衍射峰,同时可见蓝宝石衬底峰,证实了相纯度与优选取向。(d) (-402) 反射面的 XRDω 摇摆曲线呈现 287 角秒的窄半高全宽 (FWHM),表明 β-Ga2O3 外延堆叠具有高晶体质量。

图3. 室温下 LPCVD 生长异质外延 (-201) β-Ga2O3 表面的拉曼光谱,分别显示锗辅助原位 LPCVD 刻蚀前(红色)与刻蚀后(蓝色)状态。两组光谱均呈现出单斜 β-Ga2O3 特有的尖锐且清晰的 Ag 和 Bg 声子模,证实了结构完整性与相纯度。C 面蓝宝石衬底的峰值在两组光谱中亦清晰可见。

图4. 经镓辅助原位蚀刻前后 LPCVD 生长 β-Ga2O3 表面的 X 射线光电子能谱分析。(a) 显示镓和氧信号的宽扫描 XPS 概览谱图,未检测到外来元素污染。(b) 和 (c) 未蚀刻表面的高分辨率 Ga 3s 和 O 1s 谱图。[(d) 和 (e)] 蚀刻后表面的对应谱图。O 1s 峰经分解为晶格氧(Ga–O)和表面羟基(O–H)组分。谱图证实两表面均具有化学纯度和近化学计量比组成,蚀刻后键合态无显著变化,表明 LPCVD 蚀刻工艺能保持表面化学性质与结构完整性。
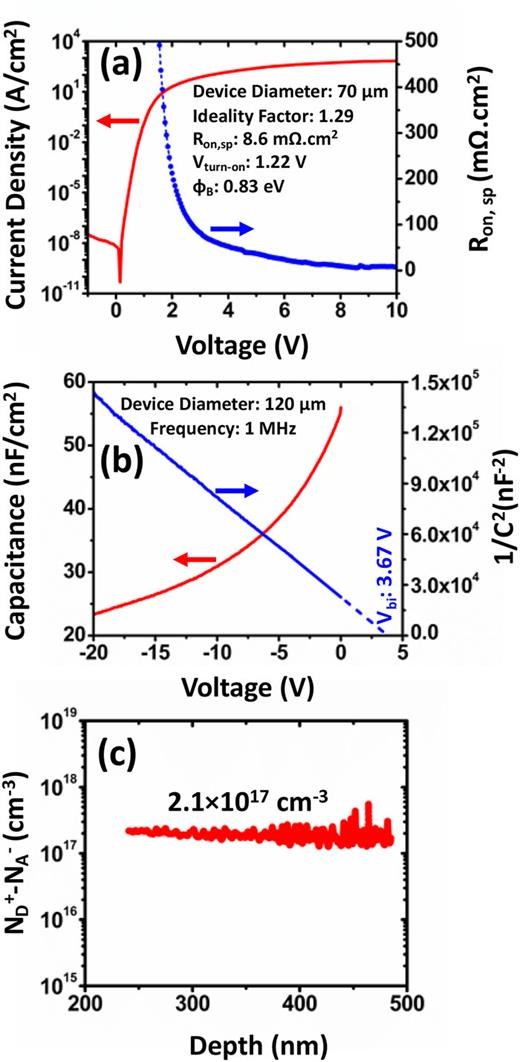
图5. (a) 直径 70 μm 的准垂直 β-Ga2O3 肖特基二极管的正向电流-电压(J-V)特性及其提取的特定导通电阻(Ron,sp)。该器件表现出 1.29 的理想系数、1.22 V 的导通电压(Vturn-on)、0.83 eV 的肖特基势垒高度 (ΦB),以及 8.6 mΩ cm2 的最小差分导通电阻 Ron,sp。(b) 直径 120μm 器件在 1MHz 频率下测得的 C–V 与 1/C2–V 特性曲线。(c) 净载流子浓度分布(Nd+-Na−)显示 β-Ga2O3 漂移层中均匀掺杂浓度为 2.1 × 1017 cm−3,该数据由 C–V 曲线提取获得。
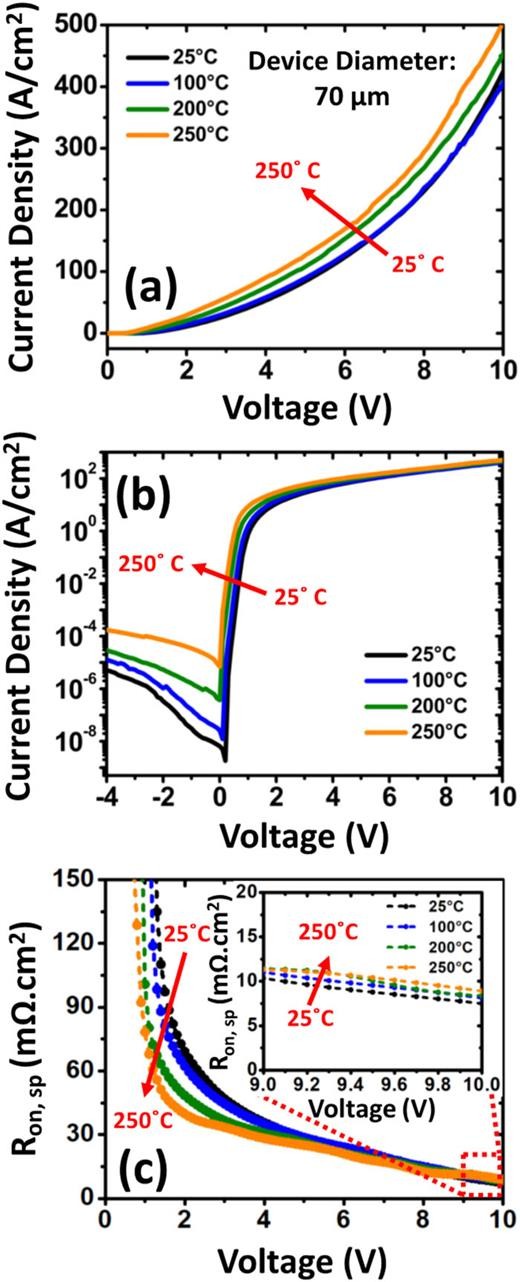
图6. 直径 70 μm 准垂直 β-Ga2O3 反向偏置二极管在 25、100、200 和 250℃ 下测得的温度依赖性电流-电压(J-V-T)特性曲线。(a) 正向 J–V 特性曲线显示导通电流密度随温度单调增加。(b) 半对数 J–V 图显示高温下漏电流增大。(c) 不同温度下提取的导通电阻 (Ron,sp) 与正向偏压电压关系曲线。
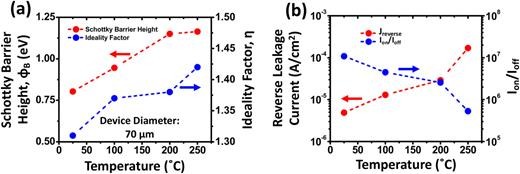
图7. 肖特基二极管的温度依赖性性能指标。(a) 提取的肖特基势垒高度 (ΦB) 与理想度因子(η)随温度变化曲线,显示 ΦB 和 η 随温度升高而增加。(b) 反向漏电流 (Jreverse) 与导通/关断电流比 (Ion/Ioff) 随温度变化曲线,表明高温下漏电流因热激活效应增加,对应的整流比随之降低。
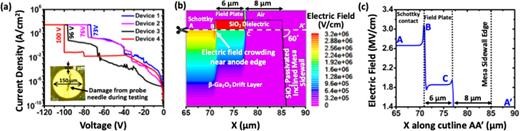
图8. (a) 四个准垂直 β-Ga2O3 反向偏置二极管的反向 J-V 特性曲线,显示击穿电压范围为 73 至 100 V,对应平行板电场强度为 1.66 至 1.94 MV/cm。插图为典型器件的光学显微照片,其直径为 150 μm,阳极至台面边缘间距为 8 μm。(b) 反向偏压条件下(100 V)的 TCAD 模拟二维电场分布(等值线图),显示阳极周边存在电场聚集现象。模拟中的器件截面包含倾斜台面侧壁(约 60°),与实测器件几何结构一致。(c) 沿 AA′ 剖面线提取的一维电场分布,进一步证实阳极边缘附近存在电场峰值增强现象。
DOI:
doi.org/10.1063/5.0280191