

【会员论文】厦门大学杨伟锋教授团队:采用O₂等离子体处理薄层HfAlO栅介质显著提升β-Ga₂O₃ MOSFET性能与稳定性
日期:2025-10-29阅读:392
由厦门大学杨伟锋教授的研究团队在学术期刊 IEEE Transactions on Electron Devices 发表了一篇名为Performance and Stability Improvements in β-Ga₂O₃ MOSFET With Thin HfAlO Gate Dielectric by O₂ Plasma Treatment(O₂ 等离子体处理提高薄 HfAlO 栅极电介质 β-Ga₂O₃ MOSFET的性能和稳定性)的文章。
项目支持
本工作得到国家自然科学基金项目(62171396)和深圳市基础研究专项(JCYJ20240813145617023)的资助。
背景
β-相氧化镓(β-Ga₂O₃)以其超宽禁带(~4.9 eV)、极高的临界击穿场强(8 MV/cm)及低成本衬底潜力,被誉为下一代高功率电子器件的关键材料。然而,该材料体系仍面临两大核心挑战:其一,栅介质界面缺陷引起的阈值电压不稳定性,严重制约器件可靠性;其二,主流(010)面衬底在大尺寸、低成本制备方面存在瓶颈。为解决上述问题,本研究选择在更易于实现大面积制备但外延质量更具挑战的(100)面衬底上开展研究。本文旨在报道在(100)面 Fe 掺杂半绝缘 β-Ga₂O₃ 衬底上通过分子束外延(MBE)材料生长、器件工艺制备到系统性能测试的全流程技术链,并通过对 HfAlO 栅介质的 O₂ 等离子体处理,成功实现高性能与高可靠性的 MOSFET,为 β-Ga₂O₃ 的产业化路线提供了新的技术选项和实验支撑。
主要内容
研究团队通过分子束外延(MBE)技术在(100)面 β-Ga₂O₃ 衬底上成功生长出高质量的外延层。随后,通过优化的 ICP 刻蚀工艺,获得了表面粗糙度低至 0.457 nm 的原子级沟道表面,为高性能器件奠定了坚实基础。器件采用 15 nm 的 HfAlO 高 k 材料作为栅介质,实现优异的栅控能力和低栅泄漏电流(<10-10 A)。通过 O₂ 等离子体处理 HfAlO 栅介质,有效修复界面和体缺陷,从源头上减少了电子的陷阱中心。经 O₂ 等离子体处理后,器件最大漏极电流(IDS,max)提升 23%,亚阈值摆幅(SS)降低 22%,开关比(Ion/off)高达 108。通过正/负偏压应力(PBS/NBS)测试,系统研究了 O₂ 等离子体处理对器件稳定性的影响:经处理后,在 NBS 条件下阈值电压变化量(|ΔVth|)从0.25 V 降至 0.08 V,亚阈值摆幅变化量(|ΔSS|)从 0.02 V/dec 降至 0.004 V/dec,降幅分别达 68% 与 79%,充分验证了稳定性提升效应。结合器件在不同状态(平衡态、PBS、NBS)下的能带结构图进一步阐释了相关的物理机制。研究表明:O₂ 等离子体处理通过有效抑制边界陷阱与界面态密度,减少电子陷获/脱陷数量,具体表现为边界陷阱与界面态电荷变化量的显著衰减,从而增强器件稳定性。
总结
研究团队通过 MBE 外延生长、器件工艺制备、性能及稳定性测试分析实现了 β-Ga₂O₃ MOSFET 器件的全流程技术链。通过系统的偏压应力测试与陷阱密度定量分析,从物理机制层面揭示了性能提升的本质。研究表明,O₂ 等离子体处理通过有效抑制栅介质中的边界陷阱密度与界面态电荷俘获,显著降低了电子的陷获/脱陷概率,从而从根本上改善了器件的阈值电压稳定性。该工作不仅验证了 HfAlO 栅介质在高功率 β-Ga₂O₃ MOSFET 中的应用潜力,更为在大尺寸、低成本(100)面衬底上实现高性能氧化镓器件提供了可行的技术路径与理论依据。

图1(a)HfAlO栅介质β-Ga₂O₃ MOSFET器件截面图,(b)HfAlO栅介质处理关键工艺引入步骤,(c)欧姆帽层刻蚀深度形貌截面图以及刻蚀后沟道表面AFM形貌图,(d)β-Ga₂O₃ MOSFET器件光学显微镜图像,(e)生长在蓝宝石衬底上的HfAlO经(未经)O₂等离子体处理的XRD图谱,(插图为AFM形貌图),(f)HfAlO经(未经)O₂等离子体处理的Al2p和O1s 芯能级的XPS图谱。

图2 β-Ga₂O₃ MOSFET经(未经)O₂等离子体处理的HfAlO栅极电介质的(a)输出特性曲线和(b)线性和对数坐标下的转移特性曲线。

图3 经(未经)O₂等离子体处理的HfAlO栅介质β-Ga₂O₃ MOSFET在不同应力时间(tstr)下测试的对数坐标下的转移特性回滞曲线:(a)和(b)为正偏压应力;(c)和(d)为负偏压应力。其中点线为正向扫描,实线为反向扫描,插图为局部放大图。
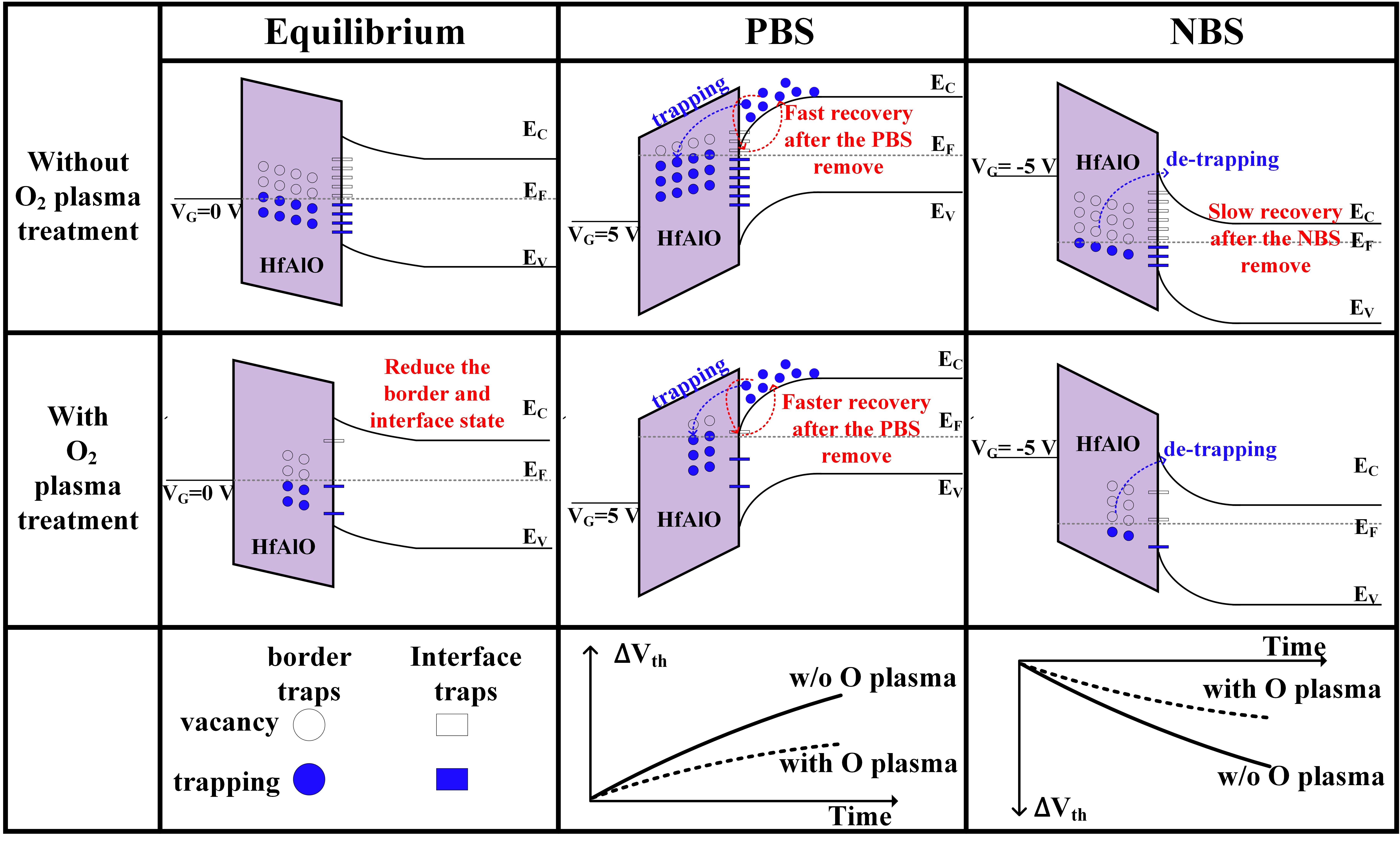
图4. 在平衡态、PBS和NBS条件下,经和未经O₂等离子体处理的HfAlO栅介质层β-Ga₂O₃ MOSFET的能带图。
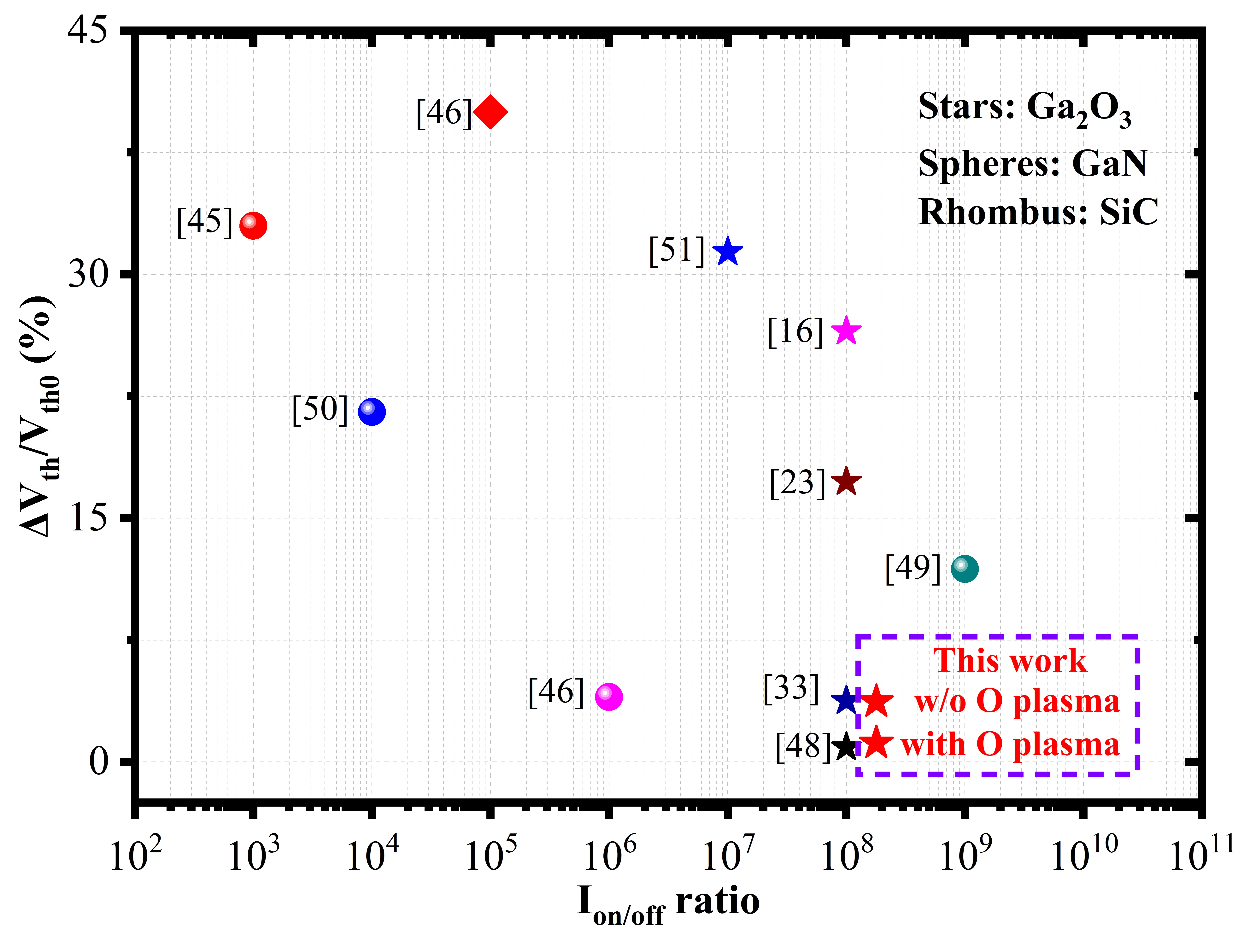
图5 宽禁带FET的阈值电压偏移∆Vth与电流开关比Ion/off的关系图, Ga₂O₃ MOSFET(星号)、GaN FET(圆球)和 SiC FET(菱形)以及本工作(红星)。
DOI:
10.1109/TED.2025.3621417










